Навигация
1. Образование пар ионов.
Диффузия фосфора является эффективным методом геттерирования. Профиль распределения таких примесей, как медь, которая в основном находится в междоузлиях в решетке нелегированного кремния и диффундирует по межузельному механизму, принимает форму диффузионного профиля распределения фосфора. Атомы меди занимают положения в узлах кристаллической решетки кремния в области, легированной фосфором, а затем захватываются вакансиями, расположенными около атомов фосфора, образуя пары Р+Сu3- . Энергия связи и коэффициент диффузии ионных пар определяются обоими ионами.
2. Геттерирование с использованием нарушенных слоев.
Геттерируюшее действие дефектов было исследовано с использованием пескоструйной обработки, механического абразивного воздействия ультразвуком или шлифованием. Особенности дефектов зависят от концентрации и вида имплантированных частиц.
Оптимальная температура геттерирования определяется для каждого конкретного случая. Время жизни неосновных носителей в слое, имплантированном аргоном, существенно увеличивается после отжига при температуре 850 С.
3. Внутреннее геттерирование
Геттером может служить преципитаты SiOx и комплексы дислокаций, присутствующие в объеме кремниевой подложки после предварительной имплантации в нее кислорода. Воздействие этих преципитатов на дислокации приводит к тому, что последние действуют в качестве стока для примесей тяжелых металлов, тогда как поверхностные области становятся свободными от дефектов.
Эффекты, используемые в технологии СБИСПри высокой дозе имплантированного азота скорость окисления кремния уменьшается из-за образования нитрида кремния, тогда как появление дефектов, вводимых при имплантации B, Ar, As, Sb может привести к увеличению скорости окисления. С помощью этих эффектов можно изменять толщину окисла в различных областях приборов СБИС.
В другом случае окислы с поврежденной поверхностью используются для уменьшения толщины маски по краям вытравленных в маске окон, при этом поверхностная область стравливается быстрее, чем бездефектные участки.
2. Постановка задачи.
Постановка задачи заключается в разработке программного обеспечения, которое необходимо, чтобы наглядно представить и понять, а также самому принять неотъемлемое участие в процессе расчета основных явлений при ионной имплантации.
1. По числу компонентов, заданной массе атомов, собственной концентрации атомов в кристалле, зарядам ядер ионов и атомов мишени, необходимо сделать расчет, конечным результатом которого послужит графическое представление расчета (зависимость концентрации примеси от глубины проникновения иона).

Рис. 1.1. Окно заставки
Далее следует окно, в котором пользователь должен будет выбрать тип решаемой задачи (Рис. 1.2.).

Рис. 1.2. Выбор требуемой задачи (в данном случае выбрана задача №1)
Затем появляется окно, в котором пользователю необходимо ввести все необходимые данные, для ее реализации (Рис. 1.3.).

Затем выводится окно, в котором представлены результаты расчета (Рис. 1.4.).
представлены результаты расчета (Рис. 1.4.).
Конечным результатом данной задачи является форма с отчетом, показанная в приложении.
2. Расчет профилей распределения концентрации внедренных примесей в структурах с двойной имплантацией. Расчет производится путем использования данных из предыдущей задачи, а также имеется набор новых данных: энергия акцепторов, доза и все тоже самое для доноров. Конечным результатом является расчет глубины залегания p-n перехода и построение графической зависимости на основе рассчитанных данных.
Также, при выборе задачи №2 из меню заставки (см. Рис. 1.2.), появляется окно для ввода необходимых данных (Рис. 2.1.).

Рис. 2.1. Окно ввода данных (задача№2)
Затем выводится окно, в котором представлены результаты расчета (Рис. 2.2.).

Рис. 2.2. Результаты расчета задачи№2
3. Расчет ионно-имплантированных структур с покрытием и без покрытия.
Ö Данная задача находится еще в проекте!
3. Математическая модель.
Задача№1:
Глубина проникновения в вещество характеризуется пробегом. Траектория отдельных ионов в кристалле подобны ломанным линиям, каждый прямолинейный участок и полная длина которых отличаются друг от друга. Вся совокупность пробегов отдельных ионов группируется по закону нормального распределения случайной величины со значением среднего полного пробега R и среднеквадратичным отклонением пробега DR. Практическую важность имеет средний нормальный пробег Rp – проекция траектории среднего полного пробега на направление первоначальной скорости иона и его среднеквадратичное отклонение DRp. Для расчета среднего полного пробега R (см) иона с энергией Е (эВ) используют формулы, в которых энергия и пробег выражены в безразмерных единицах e и r соответственно:
![]()

![]()
![]()
![]()
Здесь L-нормирующий множитель пробега, см-1; F-нормирующий множитель энергии, 1/эВ.
Радиус экранирования заряда ядра атомными электронами (см):
![]()
Коэффициент передачи ионом с массой М1 атому с массой М2 максимально возможной энергии при лобовом столкновении:
![]()
Коэффициенты, учитывающие торможение, обусловленное ядерным электронным взаимодействием:
![]()
![]()
Параметры, учитывающие торможение, обусловленные ядерным взаимодействием, с=0.45, d=0.3.
Собственная концентрация атомов в кристалле N2, см-3, заряды ядер иона Z1, атомов мишени Z2.
Профили распределения концентрации внедренных ионов определяются характером распределения средних нормальных пробегов по глубине облученного слоя. Пучок ионов, попадая в такие вещества, испытывает случайные столкновения с атомами, и распределение пробегов описывается законом распределения случайной величины. Аналогичная ситуация наблюдается и в монокристаллах, если ионный пучок попадает на произвольную ориентированную поверхность пластины относительно кристаллографических направлений с малыми индексами, например вдоль оси (763). Такое внедрение называют не ориентированным. В этом случае профиль внедренных атомов описывается, как и для аморфных веществ, кривой Гаусса:

Максимум концентрации примеси в отличие от случая введения ее методом диффузии залегает не на поверхности, а на глубине x=Rp:
![]()
Задача№2:
К примеру, для создания транзистора типа n-p-n в эпитаксиальный слой с электропроводностью n- типа производят последовательную имплантацию ионов акцепторной примеси с энергией Еа и дозой Nа для формирования базовой области и ионов донорной примеси с энергией Ед и дозой Nд для формирования эмиттера, причем Rpa>Rpd, а Cmax a < Cmax d. Суммарное распределение примеси описывается выражением:
![]()
Глубину залегания коллекторного перехода определяем из условия:

откуда
![]()
где

Глубину залегания эмиттерного перехода с учетом того, что С(Xjэ) >>Cb, определяем из условия:

откуда
![]()
где
![]()
![]()
![]()
4. Программное обеспечение:
Разработанная расчетно-информационная система предназначена для работы в среде Windows. Windows разработана корпорацией Microsoft, дата первого поступления в продажу 1995 год и крупнейшие мировые компании организовали выпуск различных приложений, использующих богатые возможности новой операционной системы.
Эффективность работы компьютера определяется не только его аппаратным обеспечением: моделью процессора, размерами жесткого диска, оперативной памяти и т. п., но и установленной на нем оперативной системой. Оперативная система это программа, которая осуществляет управление всеми устройствами компьютера и процессом обработки на нем информации.
Windows 95/98 представляет собой высокопроизводительную, многозадачную и многопоточную 32-разрядную операционную систему с графическим интерфейсом и расширенными сетевыми возможностями. Она работает в защищенном режиме и предназначена для настольных и персональных компьютеров. Операционная система Windows позволяет более полно использовать потенциал персонального компьютера.
Многозадачность означает, что можно работать с несколькими программами одновременно. Многопоточное выполнение отдельной задачи позволяет при задержке в выполнении одного потока работать со следующим. Под потоком подразумевается последовательность команд, составляющих отдельную частную задачу, решаемую внутри общей задачи (процесса).
Операционная система разработанная фирмой Microsoft обеспечивает большое количество возможностей и удобств для пользователей. Широкое распространение Windows сделало ее фактически стандартов для IBM PC совместимых компьютеров.
Поставщики программного обеспечения для ряда отраслей промышленности переходят на Windows 95, сокращая разработки для MS-DOS.
Кратко перечислю основные преимущества Windows 95 по сравнению с широко распространенной операционной системой MS-DOS:
* возможность параллельного (независимого) выполнения программ одновременно;
* легкость переключения из одной программы в другую;
* автоматизация обмена информации между различными программами, например, рисунок , полученный в графической программе, можно легко вставить в текст, созданный с использования текстового процессора;
* облегчение доступа к программам и документам за счет использования раскрывающихся меню;
* нет необходимости запоминать имена программ и документов, так как для их обозначения используются графические символы-значки;
* увеличения объема памяти за счет использования свободного пространства на жестком диске;
* защищенность прикладных программ друг от друга в случае некорректных действий одной из них.
Для разработки приложений существуют три варианта Delphi:
1. Client/Server Suite - средство создания приложений, рассчитанное на использование в организациях, где требуются высокопроизводительные, масштабируемые приложения, которые используют данные хранимые средствами управления серверами.
2. Desktop - предназначен для индивидуальных программистов.
3. Developer - ориентирован на профессиональных разработчиков.
Для реализации поставленной задачи мною был использован продукт фирмы Borland Delphi Developer версии 3.0. Delphi 3.0 представляет собой 32-битовую версию популярного средства разработки приложений для Windows 95/ Windows NT.
Выбор определялся сравнением характеристик вариантов Delphi. Наиболее приемлемые для создания расчетно-информационной системы оказались именно у Delphi Developer 3.0.
5. Техническое обеспечение:
В результате расчета и компьютерного программирования использовалось руководство пользователя: «Программирование в среде Delphi 4.0”, автор Архангельский.
6. Результаты расчета:
Результаты расчета представлены в ПРИЛОЖЕНИИ…
7. Заключение:
В данном программном проекте представлены задачи, которые удовлетворяют всем правилам и параметрам расчетов процесса ионной- имплантации, а также представлены в наглядном виде все процессы расчета данных структур, указанных в дипломном проекте.
8. Литература:
1. Архангельский «Программирование в среде Delphi 4.0».
2. А. И. Курносов, В. В. Юдин «Технология производства полупроводниковых приборов и интегральных микросхем».
3. Программирование в среде Turbo Pascal v. 7.0.
Похожие работы
... иначе использующих и развивающих основные идеи и модели, заложенные в программе SUPREM II. Основное внимание в этих программах уделялось моделированию процессов ионного легирования, диффузии, окисления и эпитаксии, ответственных за распределение примесей в полупроводниковых структурах, как правило, в одномерном приближении. Стремительный прогресс в кремниевой технологии в последние 5 – 10 лет ...
... , кратковременный отжиг при температуре 400…700 0С; 2) относительно сложное технологическое оборудование и низкая производительность процесса обработки. 1.2 Физические основы метода Процесс ионной имплантации и состояние модифицированных слоев характеризуются следующими основными параметрами, изменение которых оказывает определяющее влияние на свойства обрабатываемых поверхностей: 1) ...
... является то, что рабочий стол 6 с обрабатываемыми образцами 5 размещается внутри данного устройства. Разрабатываемое оборудование позволит осуществлять имплантацию ионов азота с энергией 1 – 10 кэВ ( Дж) в металлы и сплавы, модифицируя их свойства в нужном направлении. Заключение Несмотря на большое количество исследований в области ионной имплантации, остаётся ещё множество вопросов, ...
... . Во второй период жизненного цикла включается освоение изделия в промышленном производстве (ОСП). Практика показывает, что на этой стадии возникают и конструкторские изменения, и изменения в технологических процессах, и изменения уровня оснащенности производства специальными видами оснастки и оборудования. Точное соблюдение технологического процесса – одно из важнейших организационных условий ...






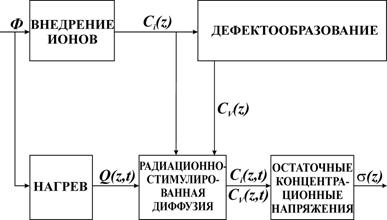






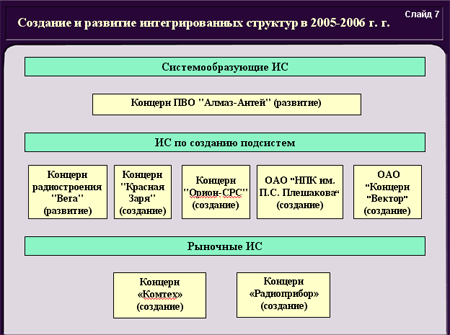
0 комментариев