Навигация
Изохорный отжиг структур, имплантированных бором
1. Изохорный отжиг структур, имплантированных бором.
Весь диапазон температур отжига разбит на три области.
Для первой области характерно наличие точечных радиационных дефектов. Повышение температуры отжига от комнатной до 500 C приводит к ликвидации таких точечных дефектов, как дивакансии.
Вторая область. При 500 C<Т< 600 С кремний содержит меньшую концентрацию атомов бора в узлах кристаллической решетки и большую концентрацию межузельных атомов бора с неопределенным положением.
В третьей области T> 600 C за счет увеличения числа кремниевых вакансий и их замащения атомами бора концентрация активных атомов примеси увеличивается. При дозах имплантированных ионов 1012 см-2 полный отжиг происходит при Т= 800 С в течение нескольких минут.
2. Изохорный отжиг структур, имплантированных фосфором.
Отжиг слоев фосфора, имплантированных при комнатной температуре мишени, производится качественно отличным способом. Доза имплантируемого фосфора от 3*1012 до 3*1014 см-2 требует проведения отжига при температурах T> 800 C для устранения более сложных радиационных дефектов по сравнению с отжигом слоев, имплантированных бором.
Когда имплантированный слой фосфора становится аморфным (при дозе выше 3*1014 см-2), начинает действовать другой механизм отжига. Температура отжига при этом несколько меньше, чем для кристаллических слоев и составляет 600 С. Более сложные процессы происходят при отжиге скрытых слоев с аморфной структурой, расположенных на определенной глубине под поверхностью подложки. Эпитаксиальная перекристаллизация начинается на обеих поверхностях раздела аморфных и монокристаллических областей.
3. Изотермический отжиг
Дополнительная информация о характере распределения имплантированных примесей может быть получена при проведении отжига при постоянной температуре, но в течение различного времени. По мере увеличения времени отжига электрическая активность легирующей примеси возрастает относительно медленно; при этом доля электрически активных атомов бора повышается от начального значения до величины, составляющей более 90 % этого значения. Энергия активации соответствует генерации и миграции термически введенных вакансий. Термически генерированные вакансии мигрируют к межузельным образованиям. При этом происходит внедрение атомов бора в узлы кристаллической решетки.
4. Диффузия имплантированных примесей.
Коэффициент диффузии бора может быть повышен за счет уничтожения кремниевых вакансий и межузельных кластеров, при этом вакансии могут увеличить коэффициент диффузии по узлам кристаллической решетки, а межузельные атомы кремния могут вытеснять атомы бора из ее узлов, что приведет к быстрой диффузии комплексов межузельный атом кремния - атом бора.
5. Быстрый отжиг.
Имплантированные слои могут быть подвергнуты лазерному отжигу с плотностью энергии в диапазоне 1-100 Дж/см2. Вследствие короткого времени нагрева имплантированные слои могут быть термообработаны без заметной диффузии примеси. Имплантированные аморфные слои толщиной 100 нм перекристаллизуются в течение нескольких секунд при Т= 800 С по механизму твердофазной эпитаксии.
Процесс быстрого отжига относиться к категориям чистых процессов, и загрязнения от элементов конструкции оборудования не создают серьезной проблемы. Лазерная энергия может быть локализована на отдельной части кристалла ИС, так что некоторые р-n переходы схемы могут размываться во время отжига за счет диффузии в большей степени, тогда как другие не претерпевают изменений.
Значительное преимущество метода то, что после расплавления и кристаллизации аморфных слоев по методу жидкофазной эпитаксии в них отсутствуют линейные дефекты.
С использованием технологии лазерного отжига создают биполярные и МОП-транзисторы, кремниевые солнечные батареи.
6. Отжиг в атмосфере кислорода.
Процессы отжига, в результате которых все имплантированные ионы занимают электрически активные положения в узлах кристаллической решетки, обычно приводят к возникновению микродефектов. Эти дефекты называют вторичными дефектами. Любые внешние микродефекты развиваются в большие дислокации и дефекты упаковки. Эти дефекты, называемые третичными дефектами, имеют достаточно большие размеры.
ПРИМЕНЕНИЕ ИОННОГО ЛЕГИРОВАНИЯ В ТЕХНОЛОГИИ СБИС
Создание мелких переходовТребование формирования n+ слоев, залегающих на небольшой глубине, для СБИС можно легко удовлетворить с помощью процесса ионной имплантации Аs. Мышьяк имеет очень малую длину проецированного пробега (30 нм) при проведении обычной имплантации с энергией ионов 50 кэВ.
Одной из прогрессивных тенденций развитии СБИС является создание КМОП- транзисторов. В связи с этим большое значение имеет получение мелких p+ - слоев. Такие слои очень сложно сформировать путем имплантации ионов В+.
Решение проблемы, связанной с имплантацией бора на небольшую глубину, на практике облегчается использованием в качестве имплантируемых частиц ВF2. Диссоциация молекулы ВF2+ при первом ядерном столкновении приводит к образованию низкоэнергетических атомов бора. Кроме того, использование молекулы ВF2 имеет преимущество при проведении процесса отжига структур.
ГеттерированиеПроцесс геттерирования основан на трех физических эффектах:
-освобождение примесей или разложение протяженных дефектов на составные части.
-диффузия примесей или составных частей дислокаций.
-поглощении примесей или собственных межузельных атомов некоторым стоком.
Рассмотрим четыре основные механизма геттерирования примесей.
Похожие работы
... иначе использующих и развивающих основные идеи и модели, заложенные в программе SUPREM II. Основное внимание в этих программах уделялось моделированию процессов ионного легирования, диффузии, окисления и эпитаксии, ответственных за распределение примесей в полупроводниковых структурах, как правило, в одномерном приближении. Стремительный прогресс в кремниевой технологии в последние 5 – 10 лет ...
... , кратковременный отжиг при температуре 400…700 0С; 2) относительно сложное технологическое оборудование и низкая производительность процесса обработки. 1.2 Физические основы метода Процесс ионной имплантации и состояние модифицированных слоев характеризуются следующими основными параметрами, изменение которых оказывает определяющее влияние на свойства обрабатываемых поверхностей: 1) ...
... является то, что рабочий стол 6 с обрабатываемыми образцами 5 размещается внутри данного устройства. Разрабатываемое оборудование позволит осуществлять имплантацию ионов азота с энергией 1 – 10 кэВ ( Дж) в металлы и сплавы, модифицируя их свойства в нужном направлении. Заключение Несмотря на большое количество исследований в области ионной имплантации, остаётся ещё множество вопросов, ...
... . Во второй период жизненного цикла включается освоение изделия в промышленном производстве (ОСП). Практика показывает, что на этой стадии возникают и конструкторские изменения, и изменения в технологических процессах, и изменения уровня оснащенности производства специальными видами оснастки и оборудования. Точное соблюдение технологического процесса – одно из важнейших организационных условий ...






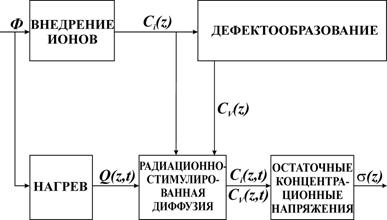






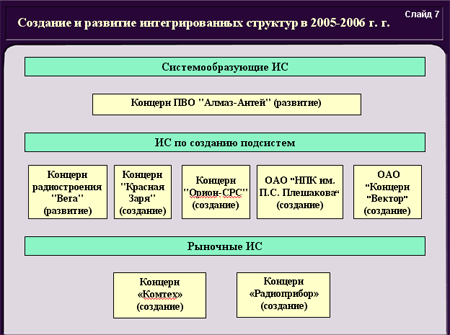
0 комментариев