Навигация
Моделирование процессов ионной имплантации
Московская Государственная Академия Тонкой Химической Технологии им. М. В. Ломоносова.
________________________________________________________________
Кафедра ТПМ КУРСОВАЯ РАБОТА
Тема: «Математическое моделирование ионно-имплантированных структур».
Руководитель Евгеньев С. Б.
Выполнил Гнездилов А. Л.
МОСКВА 1999г.
ПЛАН РАБОТЫ:
1. Общие сведения о процессе ионной имплантации.
2. Постановка задачи.
3. Математическая модель.
4. Программное обеспечение.
5. Техническое обеспечение.
6. Результаты расчета.
7. Заключение.
8. Литература.
1. Общие сведения о процессе ионной имплантации.НАЗНАЧЕНИЕ ИОННОЙ ИМПЛАНТАЦИИ
Ионной имплантацией называется процесс внедрения в мишень ионизованных атомов с энергией, достаточной для проникновения в ее приповерхностные области. Успешное применение ионной имплантации определяется главным образом возможностью предсказания и управления электрическими и механическими свойствами формируемых элементов при заданных условиях имплантирования.
Наиболее распространенным применением ИИ в технологии формирования СБИС является процесс ионного легирования кремния. Часто приходится проводить имплантацию атомов в подложку, которая покрыта одним или несколькими слоями различных материалов. Ими могут быть как тонкие слои тяжелых металлов (например, Та или TaSi2), так и диэлектриков. Существование многослойной структуры способно вызвать резкие перепады в профиле легирования на границе отдельных слоев. За счет столкновения ионов с атомами приповерхностных слоев последние могут быть выбиты в более глубокие области легируемого материала. Такие "осколочные эффекты" способны вызвать ухудшение электрических характеристик готовых приборов.
Во многих случаях для получения необходимого профиля распределения легирующей примеси в подложке применяют метод, основанный на предварительной загонке ионов с их последующей термической разгонкой в мишени. При этом имплантация проводится с малой энергией ионов.
Общая траектория движения иона называется длиной пробега R, а расстояние, проходимое внедряемым ионом до остановки в направлении, перпендикулярном к поверхности мишени, проецированной длиной пробега Rp.
|
|
Схема установки для ионной имплантации приведена на рис. 1.
1 - источник ионов
2 - масс-спектрометр
3 - диафрагма
4 - источник высокого напряжения
5 - ускоряющая трубка
6 - линзы
7 - источник питания линз
8 - система отклонения луча по вертикали и система отключения луча
9 - система отклонения луча по горизонтали
10 - мишень для поглощения нейтральных частиц
11 - подложка
12 - электрометр
Магнитный масс-спектрометр предназначен для отделения ненужных ионов от легирующих, электрометр - для измерения величины имплантированного потока ионов. Маски для ИИ могут быть изготовлены из любых материалов, используемых в технологии СБИС (фоторезист, нитриды, окислы, поликремний).
Управление дозой при ИИ затруднено рядом факторов. Это наличие потока нейтральных частиц, обмен энергии ионов с молекулами газов, вторичная электронная эмиссия из мишени, эфект обратного ионного распыления.
Для ликвидации последствий действия этих факторов используют следующие технические приемы. Нейтральные молекулы отсеивают с помощью масс-спектрометра (его магнитным полем не отклоняет нейтральные частицы и они не попадают в апертурную диафрагму). Кроме того, в камере поддерживается достаточно высокий вакуум, предотвращающий процесс нейтрализации ионов. Вторичную электронную эмиссию подавляют, располагая около мишени ловушку Фарадея.
От загрязнений поверхности кремния вследствие полимеризации углеводородов ИИ проводят через окисную пленку, которую затем удаляют.


Профиль распределения примеси при ионной имплантации бора различных энергий в кремний приведен на рис. 2. Для корректного теоретического расчета профиля, особенно для больших значений энергий пучков ионов, используют два объединенных распределения Гаусса
, где
D - поглощенная доза,
Rm - модальная длина пробега (аналог проекционной длины пробега при Гауссовском распределении),
DR1, DR2 - флуктуации первого и второго распределения,
DRi=DR1 при x>Rm, DRi=DR2 при x<=Rm.
 |
Теоретические профили, рассчитанные по приближению Пирсона с 4 параметрами и распределению Гаусса, и измеренные профили при ионной имплантации бора в кремний без проведения отжига приведены на рис. 3.
ДЕФЕКТЫ ПРИ ИОННОМ ЛЕГИРОВАНИИ И СПОСОБЫ ИХ УСТРАНЕНИЯ
Ионное каналированиеЭффект каналирования наблюдается при попадании иона в свободное пространство между рядами атомов. Как только ион попадает в это пространство, на него начинают действовать потенциальные силы атомных рядов, направляющие его в центр канала. В результате этого ион продвигается на значительные расстояния. Такой ион постепенно теряет энергию за счет слабых скользящих столкновений со стенками канала и, в конце концов, покидает эту область. Расстояние, проходимое ионом в канале, может в несколько раз превышать длину пробега иона в аморфной мишени.
Эффект каналирования характеризуется наличием "хвостов" концентрации атомов, выявляемых с помощью метода масспектрометрии вторичных ионов и "хвостов" концентрации свободных носителей зарядов, обнаруживаемых при проведении электрических измерений. Попытки устранения эффекта каналирования путем ориентации кремниевой монокристаллической подложки в наиболее плотно упакованных направлениях сводят его к минимуму, но не исключают полностью.
Были сделаны попытки практического использования эффекта каналирования при имплантации примеси на большую глубину. Однако в этом случае значительно затруднены управление профилем распределения имплантируемой примеси и получение воспроизводимых результатов из-за очень высоких требований к точности разориентации ионного пучка относительно основных кристаллографических направлений в подложке.
Образование радиационных дефектовПри внедрении ионов в кремниевую кристаллическую подложку они подвергаются электронным и ядерным столкновениям, однако, только ядерные взаимодействия приводят к смещению атомов кремния. Легкие и тяжелые ионы производят качественно различное "дерево радиационных дефектов".
Легкие ионы при внедрении в мишень первоначально испытывают в основном электронное торможение. На профиле распределения смещенных атомов по глубине подложки существует скрытый максимум концентрации. При внедрении тяжелых ионов они сразу начинают сильно тормозиться атомами кремния.
Тяжелые ионы смещают большое количество атомов мишени из узлов кристаллической решетки вблизи поверхности подложки. На окончательном профиле распределение плотности радиационных дефектов, который повторяет распределение длин пробега выбитых атомов кремния, существует широкий скрытый пик. Сложная структура различных типов дефектов вдоль траектории движения иона вызвана распределением смещенных атомов кремния.
Вводимые в процессе ионной имплантации дефекты состоят из вакансий и дивакансий. При нагреве мишени пучком ионов в процессе имплантации до температуры выше 500 С будут образовываться дислокации.
Отжиг легированных структурПараметры процесса отжига определяются дозой и видом имплантированных ионов.
Похожие работы
... иначе использующих и развивающих основные идеи и модели, заложенные в программе SUPREM II. Основное внимание в этих программах уделялось моделированию процессов ионного легирования, диффузии, окисления и эпитаксии, ответственных за распределение примесей в полупроводниковых структурах, как правило, в одномерном приближении. Стремительный прогресс в кремниевой технологии в последние 5 – 10 лет ...
... , кратковременный отжиг при температуре 400…700 0С; 2) относительно сложное технологическое оборудование и низкая производительность процесса обработки. 1.2 Физические основы метода Процесс ионной имплантации и состояние модифицированных слоев характеризуются следующими основными параметрами, изменение которых оказывает определяющее влияние на свойства обрабатываемых поверхностей: 1) ...
... является то, что рабочий стол 6 с обрабатываемыми образцами 5 размещается внутри данного устройства. Разрабатываемое оборудование позволит осуществлять имплантацию ионов азота с энергией 1 – 10 кэВ ( Дж) в металлы и сплавы, модифицируя их свойства в нужном направлении. Заключение Несмотря на большое количество исследований в области ионной имплантации, остаётся ещё множество вопросов, ...
... . Во второй период жизненного цикла включается освоение изделия в промышленном производстве (ОСП). Практика показывает, что на этой стадии возникают и конструкторские изменения, и изменения в технологических процессах, и изменения уровня оснащенности производства специальными видами оснастки и оборудования. Точное соблюдение технологического процесса – одно из важнейших организационных условий ...
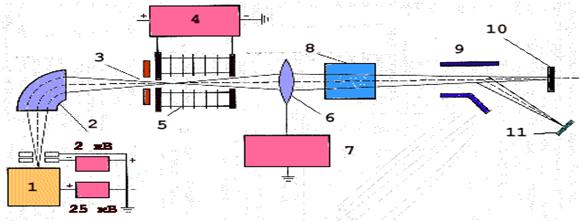






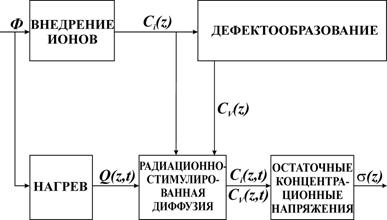






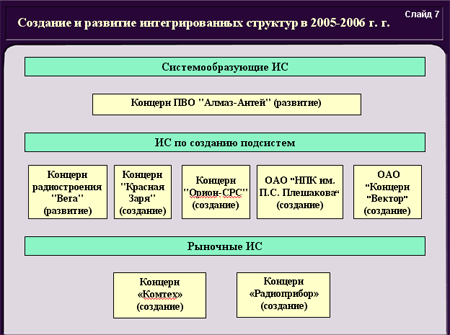
0 комментариев