Навигация
Последовательность процессов при производстве ИМС
9. Последовательность процессов при производстве ИМС
1) Составление партии пластин. Количество пластин в партии 15 – 20 штук. Используются пластины марки ЭКДБ–10 диаметром 100 мм.
Исходный вид структуры

Рис. 9.1.
2) Химическая обработка пластин.
3) Термическое окисление Si.
Пластина после термического окисления

Рис. 9.2.
4) Фотолитография по окислу кремния.
Вид структуры после фотолитографии

Рис. 9.3.
5) Имплантация ионов сурьмы. Она выполняется по режимам: Ф = 500 мкКл/см2; Е = 50 кэВ.
Имплантация ионов Sb+

Рис. 9.4.
6) Термическая диффузия имплантированных ионов сурьмы Sb+. Проводится при температуре Т = 1220 0С и времени t = 12 ч.
Структура после термической диффузии

Рис. 9.5.
7) Травление окисла и химическая обработка пластины.
Травления окисла

Рис. 9.6.
8) Наращивание эпитаксиального слоя.
ТЭ = 1150 0С, tЭ = 30,312 мин. Толщина ЭС hЭС![]() 6мкм. Удельное сопротивление ЭС = 0,4 Ом*см.
6мкм. Удельное сопротивление ЭС = 0,4 Ом*см.
Структура после эпитаксиального наращивания

Рис. 9.7.
9) Химическая обработка.
10) Термическое окисление.
11) Фотолитография по окислу Si под разделительные дорожки.
Фотолитография под РД
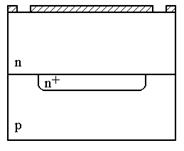
Рис. 9.8.
12) Химическая обработка.
13) Термическая диффузия бора В для создания разделительных дорожек.
1 стадия: Т1 = 1150 0С и t1 = 9,08 мин; 2 стадия: Т2 = 1220 0С и t2 = 1,43 ч.
Термическая диффузия бора в РД
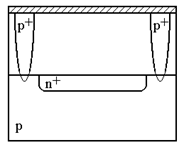
Рис. 9.9.
14) Фотолитография по окислу кремния для создания базовых областей.
Фотолитография под базовые области
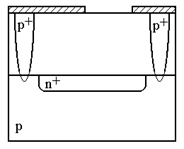
Рис. 9.10.
15) Химическая обработка.
16) Имплантация ионов бора В проводится по следующим режимам:
Е = 50 кэВ, Ф = 242 мкКл/см2.
17) Термическая диффузия имплантированных ионов бора В. Проводится при температуре Т = 1150 0С и t = 77,55 мин.
Диффузия бора в область базы
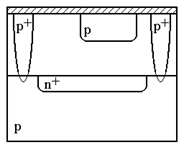
Рис. 9.11.
18) Фотолитография по окислу под эмиттер.
Фотолитография под эмиттер
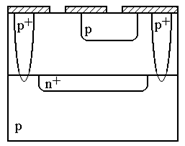
Рис. 9.12.
19) Химическая обработка.
20) Диффузия фосфора P в область эмиттера.
1 стадия: Т1 = 1100 0С и t1 = 5125,96 с; 2 стадия: Т2 = 1100 0С и t2 = 11261,85 с.
Диффузия фосфора

Рис. 9.13.
21) Фотолитография под контактные окна.
Фотолитография под контактные окна

Рис. 9.14.
22) Контроль электрических параметров элементов. Измерения проводятся при помощи зарядовой установки и ПИХЛ22.
23) Химическая обработка.
24) Напыление алюминия.
Напыление алюминия
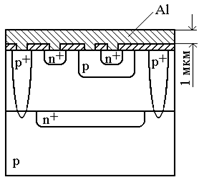
Рис. 9.15.
25) Фотолитография по алюминию.
Структура эпитаксиального n-p-n-транзистора
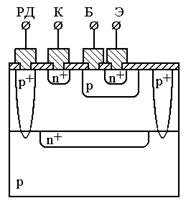
Рис. 9.16.
26) Вплавление алюминия.
ТВПЛ < ТЭВТAl-Si = 570 0С.
ТВПЛ = 565 0С, t = 3 мин
Заключение
В данном курсовом проекте при заданном напряжении коллектор-база VКБ = 15 В, ширине активной базы Wа = 0,7 мкм рассчитаны параметры структуры транзистора и определены технологические режимы ее изготовления.
Скрытый слой глубиной xjСС=8,49 мкм формируется по стандартным режимам имплантации (Е=50 кэВ, Ф=500 мкКл/см2) и последующей термической диффузии ионов сурьмы (ТСС=1220 0С, tCC=12 ч). Эпитаксиальный слой толщиной hЭС![]() 6 мкм и удельным сопротивлением ЭС=0,4 Ом*см наращивается на кремниевую пластину ЭКДБ-10. Параметры эпитаксии: температура ТЭ=1150 0С, скорость наращивания vЭН = 0,2 мкм/мин, длительность эпитаксиального наращивания tЭ=38 мин.
6 мкм и удельным сопротивлением ЭС=0,4 Ом*см наращивается на кремниевую пластину ЭКДБ-10. Параметры эпитаксии: температура ТЭ=1150 0С, скорость наращивания vЭН = 0,2 мкм/мин, длительность эпитаксиального наращивания tЭ=38 мин.
Разделительные дорожки формируются путем диффузии бора с поверхности ЭС вглубь до смыкания с подложкой (глубина залегания xjРD = 7,062 мкм). Разделительная диффузия проводится в два этапа: Т1=1150 0С и t1=9,08 мин, Т2=1220 0С и t2=1,43 ч. Формирование базовой области проводим методом имплантации ионов бора (Е=50 кэВ, Ф=809 мкКл/см2) с последующей термической диффузией имплантированных ионов (Т=1150 0С и t=77,55 мин). Эмиттерные области формируются путем последовательной диффузии фосфора Р (Т1=1100 0С и t1=5125,96 с, Т2=1100 0С и t2=11261,85 с). Величина размывания скрытого слоя в эпитаксиальный слой в процессе термообработки КЭСС равна cc = 0,36 мкм.
Областью применения результатов данного проектирования может являться расчет кремниевых эпитаксиально-планарных транзисторов.
Список использованных источников
1. Курносов А.И., Юдин В.В. Технология производства полупроводниковых приборов и интегральных микросхем. Учеб. пособие для вузов по спец. «Полупроводники и диэлектрики» и «Полупроводниковые приборы». – 3-е изд., перераб. и доп. – М.: Высш. шк., 1986. – 386 с., ил.
Приложение 1


Похожие работы
... связью (ПЗС), на которых могут быть построены сдвиговые регистры, запоминающие устройства и некоторые логические элементы. 3. Причины ограничивающие минимальные размеры интегральных микросхем Для выбранной структуры ИМС минимальные размеры элементов ИМС в целом зависят от возможностей фотолитографического процесса, которые характеризуются тремя основными параметрами: 1) минимальным размером ...
... (1.6.3), (1.6.5) могут быть решены относительно неизвестных lp0, и ln0, после чего из (1.6.4) определяется максимальное поле p-n-перехода. 1.7. Расчет параметров ступенчатого p-n-перехода. Наиболее просто определяется параметры ступенчатого p-n-перехода, так как в этом случае функция N(x) имеет вид: (1.7.1) а значение граничных условий концентрации ...
... коэффициенты линейного расширения материалов подложек, корпусов и вспомогательных материалов должны быть согласованы для обеспечения работы микросхем при повышенных уровнях мощности. Конструирование СВЧ микросхем включает расчет и проектирование изделия по заданным электрическим параметрам с учетом процессов сборки и регулировки. При этом определяют вариант схемы узла, материал и геометрические ...
... – это законченный элемент ИМС, который можно использовать при проектировании аналоговых микросхем. 1 Общие принципы построения топологии биполярных Имс Общего подхода к проектированию биполярных интегральных микросхем нет и быть не может, каждый тип характеризуется своими особенностями в зависимости от требований и исходных данных ИМС. Исходными данными при конструировании микросхем являются: ...
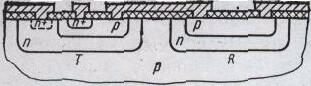

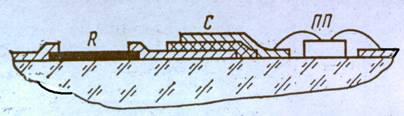




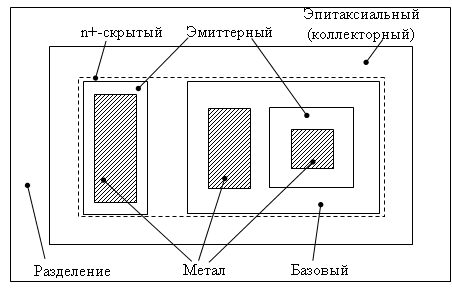


0 комментариев