Навигация
Определение удельного сопротивления эпитаксиального слоя
2. Определение удельного сопротивления эпитаксиального слоя
Величина удельного сопротивления эпитаксиального слоя (ЭС) определяется с учетом заданного значения пробивного напряжения VКБ.
Известно [1], что величина пробивного напряжения плоского резкого p-n-перехода определяется следующим соотношением:
 , (2.1)
, (2.1)
где NЭС – концентрация примеси в ЭС, в котором формируется p-n-переход коллектор–база.
Для планарного p-n-перехода справедливо следующее выражение [1]:
![]() , (2.2)
, (2.2)
где Uпр.плоск. – пробивное напряжение плоского p-n-перехода; n = 1 для цилиндрического и n = 2 для сферического p-n-перехода.
![]() , (2.3)
, (2.3)
где r – радиус кривизны p-n-перехода, равный глубине залегания этого p-n-перехода; W0 – ширина области объемного заряда (ООЗ) резкого p-n-перехода при напряжении пробоя плоского p-n-перехода:
 . (2.4)
. (2.4)
Проведем расчет для случая сферического p-n-перехода, т.е. n = 2.
Зададим значение глубины залегания p-n-перехода xjК-Б = 3 мкм, тогда r = xjК-Б =3 мкм.
Зададим приблизительное значение NЭС. Для этого воспользуемся графиком зависимости напряжения лавинного пробоя p-n-перехода с различной геометрией переходов рис. 9.3 [1]: NЭС(15 В) = 5*1016 см-3.
Используя полученное из графика значение NЭС, рассчитаем пробивное напряжение плоского p-n-перехода. Согласно формуле (2.1):
 = 17,944 В.
= 17,944 В.
Определяем величину W0 в соответствии с (2.4):
 = 6,826*10-5 см = 0,6826 мкм.
= 6,826*10-5 см = 0,6826 мкм.
Находим
![]() .
.
По формуле (2.2) определяем точное значение пробивного напряжения p-n-перехода коллектор–база при NЭС = 5*1016 см-3:
Uпр.план. = 17,944*{[(2+1+4,395) *4,3952]1/3-4,395} = 14,937 В.
Сравниваем полученное нами точное значение пробивного напряжения (14,937 В), с заданным в задании на курсовой проект значением пробивного напряжением коллектор–база (15 В). Отмечаем, что разница не превышает 10%. Поэтому оставляем выбранное нами значение концентрации эпитаксиального слоя NЭС = 5*1016 см-3. С помощью рис. 6.4 [1] найдем удельное сопротивление ЭС ЭС = 0,4 Ом*см.
3. Определение толщины эпитаксиального слоя
Толщина ЭС определяется исходя из соотношения:
hЭСmin = xjК-Б+W0+сс, (3.1)
где xjК-Б – глубина залегания p-n-перехода коллектор–база; W0 – ширина ООЗ p-n-перехода при рабочем напряжении (напряжении пробоя); сс – величина расплывания СС в ЭС, отсчитываемая от границы раздела подложка–ЭС. Зададим глубину залегания xjК-Б = 3 мкм и величину расплывания сс = 3 мкм.
Определим ширину ООЗ p-n-перехода по формуле (2.4)
 6,241*10-5 см = 0,624 мкм.
6,241*10-5 см = 0,624 мкм.
Согласно (3.1) толщина ЭС hЭС будет равна:
![]()
4. Определение режимов эпитаксии
Температура эпитаксии обычно равна 11501200 0С. Зададим температуру эпитаксии ТЭ=1150 0С.
Скорость наращивания ЭС соответствует диапазону vЭН = 0,10,3 мкм/мин. Выбираем vЭН = 0,2 мкм/мин.
Следовательно, длительность эпитаксиального наращивания:
![]()
5. Определение режимов разделительной диффузии
Разделительные дорожки (РД) формируются путем диффузии бора В+ с поверхности ЭС вглубь до смыкания с подложкой. При этом глубина залегания РД должна быть меньше ЭС на 1 мкм, т.е.
xjРD = hЭС + 1 мкм. (5.1)
В нашем случае, согласно выражению (5.1) xjРD = 7,062 мкм.
Глубина разделительной диффузии описывается следующим выражением:
![]() , (5.2)
, (5.2)
где D2t2 – параметры второй стадии разделительной диффузии; N0 – концентрация на поверхности диффузионного разделительного слоя; NП = NЭС – концентрация примеси в ЭС.
В формуле (5.2) должно выполняться соотношение: N0103NП. (5.3)
Положим, что N0 = 103NП = 103NЭС = 5*1019 см-3. Из выражения (5.2) определяем D2t2:
 .
.
Задаем температуру второй стадии диффузии: Т2=1220 0С. Определим D2. Пользуясь рис. 9.5, а [1] находим, что для Т2 = 1220 0С коэффициент диффузии бора D2(1220) = 3,5*10-12 см2/c.
Рассчитываем значение t2:
![]()
Определяем параметры первой стадии разделительной диффузии. Распределение примеси после второй стадии диффузии описывает выражение:
 , (5.4)
, (5.4)
где Q – количество примеси, введенное в полупроводник на первой стадии диффузии. Оно определяется через параметры первой стадии диффузии выражением:
![]() , (5.5)
, (5.5)
где N01 – величина предельной растворимости. Определяется по графику (рис.9.5, а) [1].
Подставим выражение (5.5) в (5.4), и выразим N0:
 , (5.6)
, (5.6)
где N0, согласно (5.3), принимаем равным N0 = 103NЭС = 5*1019 см-3.
Из (5.6) выражаем D1t1:
 . (5.7)
. (5.7)
Зададим температуру первой стадии диффузии: Т1=1150 0С. По графику зависимости рис. 9.5, а [1] находим: D1(1150 0C) = 7*10-13 см2/c.
С помощью рис. 5.2 [1] находим предельную растворимость бора в кремнии N01(T1) = N01(1150 0C) = 5,4*1020 см-3.
Определяем t1 из выражения (5.7):
![]()
В результате получаем следующее распределение примеси в разделительных дорожках:
![]() .
.
Похожие работы
... связью (ПЗС), на которых могут быть построены сдвиговые регистры, запоминающие устройства и некоторые логические элементы. 3. Причины ограничивающие минимальные размеры интегральных микросхем Для выбранной структуры ИМС минимальные размеры элементов ИМС в целом зависят от возможностей фотолитографического процесса, которые характеризуются тремя основными параметрами: 1) минимальным размером ...
... (1.6.3), (1.6.5) могут быть решены относительно неизвестных lp0, и ln0, после чего из (1.6.4) определяется максимальное поле p-n-перехода. 1.7. Расчет параметров ступенчатого p-n-перехода. Наиболее просто определяется параметры ступенчатого p-n-перехода, так как в этом случае функция N(x) имеет вид: (1.7.1) а значение граничных условий концентрации ...
... коэффициенты линейного расширения материалов подложек, корпусов и вспомогательных материалов должны быть согласованы для обеспечения работы микросхем при повышенных уровнях мощности. Конструирование СВЧ микросхем включает расчет и проектирование изделия по заданным электрическим параметрам с учетом процессов сборки и регулировки. При этом определяют вариант схемы узла, материал и геометрические ...
... – это законченный элемент ИМС, который можно использовать при проектировании аналоговых микросхем. 1 Общие принципы построения топологии биполярных Имс Общего подхода к проектированию биполярных интегральных микросхем нет и быть не может, каждый тип характеризуется своими особенностями в зависимости от требований и исходных данных ИМС. Исходными данными при конструировании микросхем являются: ...
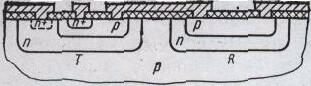

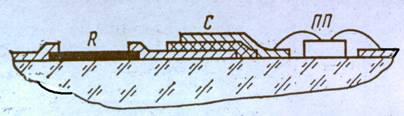




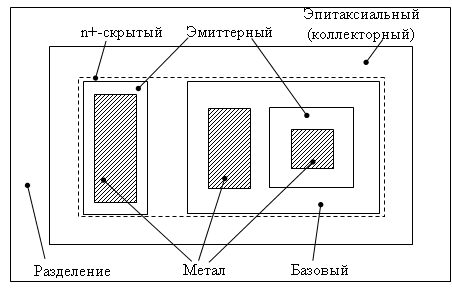


0 комментариев