Навигация
Определение режимов базовой диффузии
6. Определение режимов базовой диффузии
Формирование базовой области проведем методом имплантации ионов бора В с последующей термической диффузией имплантированных ионов.
Выбираем дозу имплантированных ионов бора Ф = 10 мкКл/см2 и энергию имплантированных ионов ЕИ = 20 кэВ. Профиль распределения примеси после термической диффузии имплантированных ионов описывается следующим выражением:
![]() , (6.1)
, (6.1)
глубина залегания p-n-перехода коллектор-база:
![]() , (6.2)
, (6.2)
где ![]() [см-3]; NП = NЭС [см-3]. Согласно соотношению (5.3) положим, что N0Б = 5*1019 см-3.
[см-3]; NП = NЭС [см-3]. Согласно соотношению (5.3) положим, что N0Б = 5*1019 см-3.
Температуру базовой диффузии выбираем равной 1150 0С. При этом D(1150 0C) = 7*10-13 см2/c.
Определяем время базовой диффузии из выражения (6.2):

Определяем параметры ионной имплантации:
![]() см-2,
см-2,
С помощью формулы (1.2) найдем дозу облучения
![]() мкКл/см2.
мкКл/см2.
Профиль распределения примеси в базовом слое описывается следующим выражением:
![]() .
.
7. Определение режимов эмиттерной диффузии
Эмиттерные области формируются путем диффузии фосфора P. Глубина перехода эмиттер–база определяется на основании следующих значений:
1) выбранного нами значения глубины залегания xjКБ = 3 мкм,
2) заданного в задании значения ширины активной базы Wa = 0,7 мкм.
Глубина залегания p-n-перехода эмиттер–база определяется выражением:
![]() , (7.1)
, (7.1)
где xjЭБ = xjКБ - Wa = 2,3 мкм.
Определяем параметры второй стадии эмиттерной диффузии. Согласно соотношению (5.3) положим, что N0Э = 5*1019 см-3. Зададим температуру второй стадии диффузии Т2 = 1100 0С. Определяем D2(T2) = 1,7*10-13 см2/с.
С помощью выражения (7.1) определяем длительность второй стадии t2:

Определяем параметры первой стадии диффузии.
Находим
![]()
Принимаем N0Э = 103NП = 8,59*1020 см-3.
Известно, что
 . (7.2)
. (7.2)
Из (7.2) выразим:
![]()
Также известно, что ![]() . Отсюда находим
. Отсюда находим
![]() . (7.3)
. (7.3)
Задаем температуру первой стадии диффузии Т1 = 1100 0С. При заданной температуре по графикам зависимостей рис. 9.5. и рис. 5.2. [1] определяем
значения коэффициента диффузии и предельной растворимости для фосфора P. Соответственно D1 = 1,7*10-13 см2/с и N01 = 2*1021 см-3.
Из выражения (7.3) найдем длительность первой стадии диффузии t1:
![]()
Выражение описывающее профиль распределения фосфора Р в эмиттере имеет следующий вид:
![]()
8. Проверка величины размывания скрытого слоя в процессе последующих диффузий
Фактическая глубина диффузии примеси из скрытого слоя в эпитаксиальный слой определяется следующим выражением:
![]() (8.1)
(8.1)
где ![]() - сумма произведений всех значений коэффициента диффузии сурьмы при температурах: эпитаксии, разделительной, базовой и эмиттерной диффузии (см. табл. 8.1), и времени; N0 – поверхностная концентрация в скрытом слое; NП – концентрация примеси в ЭС; i – индекс, соответствующий процессу термической обработки структур, начиная с эпитаксиального наращивания.
- сумма произведений всех значений коэффициента диффузии сурьмы при температурах: эпитаксии, разделительной, базовой и эмиттерной диффузии (см. табл. 8.1), и времени; N0 – поверхностная концентрация в скрытом слое; NП – концентрация примеси в ЭС; i – индекс, соответствующий процессу термической обработки структур, начиная с эпитаксиального наращивания.
Концентрация N0 определяется по следующей формуле:
 , (8.2)
, (8.2)
где Q - количество ионов сурьмы Sb+ имплантированных в подложку; Dcctcc - произведение коэффициента диффузии сурьмы и времени, соответствующее формированию СС.
Табл. 8.1
Зависимость коэффициента диффузии сурьмы в кремнии от температуры
| Т, 0C | 1100 | 1150 | 1220 |
| D, см2/c | 3,8*10-14 | 9,8*10-14 | 4,5*10-13 |
Рассчитаем величину расплывания скрытого слоя. Для рассчитанных нами технологических режимов величина
![]()
С помощью выражения (8.2) найдем поверхностную концентрацию в СС:
 .
.
По формуле (8.1) найдем
![]()
Так как полученное нами значение cc < 3 мкм, значит оставляем толщину эпитаксиального слоя без изменений.
Похожие работы
... связью (ПЗС), на которых могут быть построены сдвиговые регистры, запоминающие устройства и некоторые логические элементы. 3. Причины ограничивающие минимальные размеры интегральных микросхем Для выбранной структуры ИМС минимальные размеры элементов ИМС в целом зависят от возможностей фотолитографического процесса, которые характеризуются тремя основными параметрами: 1) минимальным размером ...
... (1.6.3), (1.6.5) могут быть решены относительно неизвестных lp0, и ln0, после чего из (1.6.4) определяется максимальное поле p-n-перехода. 1.7. Расчет параметров ступенчатого p-n-перехода. Наиболее просто определяется параметры ступенчатого p-n-перехода, так как в этом случае функция N(x) имеет вид: (1.7.1) а значение граничных условий концентрации ...
... коэффициенты линейного расширения материалов подложек, корпусов и вспомогательных материалов должны быть согласованы для обеспечения работы микросхем при повышенных уровнях мощности. Конструирование СВЧ микросхем включает расчет и проектирование изделия по заданным электрическим параметрам с учетом процессов сборки и регулировки. При этом определяют вариант схемы узла, материал и геометрические ...
... – это законченный элемент ИМС, который можно использовать при проектировании аналоговых микросхем. 1 Общие принципы построения топологии биполярных Имс Общего подхода к проектированию биполярных интегральных микросхем нет и быть не может, каждый тип характеризуется своими особенностями в зависимости от требований и исходных данных ИМС. Исходными данными при конструировании микросхем являются: ...
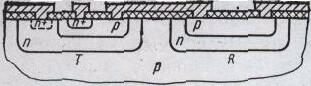

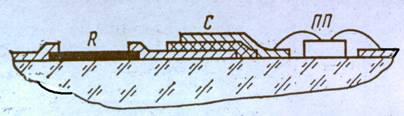




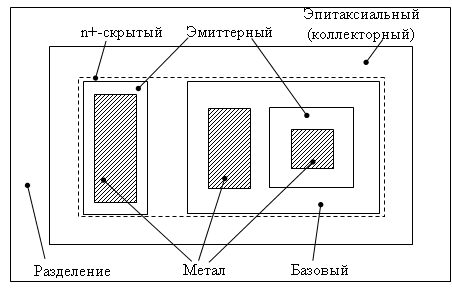


0 комментариев