Навигация
3. МЕТОДИ ГЕРМЕТИЗАЦІЇ
3.1 Спаювання
Це технологічна операція з’єднання двох металевих деталей, які перебувають у твердому стані, з допомогою розплавленого матеріалу – припою [3]. Процес спаювання відбувається при нагріванні припою до температури плавлення. Розплавлені частинки припою дифундують у з'єднувальні матеріали, розчиняють їх і при охолодженні утворюють твердий розчин.
Паяння застосовують переважно при монтажі дротом безкорпусних ІМС, напівпровідникових приладів і компонентів на плату в ГІС і МЗб, а також при монтажі кристалів зі стовпчиковими, кульковими і балковими виводами. Паяння виконують без флюсів припоями ПОС-61, ПСр-2,5 та іншими з додаванням до них порошків матеріалів, з яких виготовлена контактна площинка [2].
У деяких випадках складові частини припою можуть, вступати в хімічну реакцію зі з'єднувальними матеріалами утворюючи інтерметалічні сполуки. При охолодженні вони кристалізуються і за рахунок металічного зв'язку з іншими елементами утворюється досить міцне з'єднання. Спаювання в мікроелектроніці застосовується рідко, оскільки цей процес пов'язаний з нагріванням з'єднувальних матеріалів, що негативно впливає на параметри мікросхем. Існують низькотемпературні і високотемпературні припої. Низькотемпературні припої - це ПОС-40, ПОС-61, ПОВн-0,5, а високотемпературні (вище 350 ºС) - ПСр-45, ПСр-72 [3].
Для поліпшення змочування з'єднувальних матеріалів припоєм використовуються флюси на основі каніфолі марок ФКСп, ФПЕт, ФКТС і на основі хлористого цинку ФХЦ. Але флюси дуже забруднюють поверхню мікросхеми або залишаються в невеликих кількостях всередині корпусу після його герметизації. Тому флюси застосовують в рідкісних випадках, а спаювання, як правило, проводять у відновлюваному (водень, формідгаз) чи інертному (аргон, криптон, гелій) середовищі.
Мікроспаювання мікросхем використовується для приєднання відводів до контактних площинок, а також герметизації кришки до основи корпусу. Найчастіше спаювання застосовують для монтажу елементів на плати і дуже рідко при складанні гібридних інтегрованих та напівпровідникових мікросхем. Виникає питання, що ж обмежує застосування паяння при складанні напівпровідникових мікросхем? Це, по-перше, велика тривалість процесу, яка викликає додатковий вплив температури на параметри елементів ІМС. По-друге, вибраний припой не повинен помітно розчиняти матеріал плівкового контакту і утворювати крихкі інтерметалічні сполуки [3]. При складанні ГІМС для підвищення міцності з'єднання збільшують площу паяного контакту, іноді дротики закріплюють спеціальними затискачами чи пропускають дротяні з'єднання через наскрізні отвори у підкладці.
При під'єднанні схеми до контактних площадок важливими
є форма інструменту та вибраний метод нагріву припою.
Найчастіше інструментом є, так званий, "розщеплений електрод",
а нагрівання здійснюється з допомогою струменя гарячого
інертного газу або сфокусованого інфрачервоного випромінювання [3]. Останній метод є безконтактним і забезпечує високу продуктивність спаювання. Таким методом забезпечують складання гібридних тонкоплівкових мікросхем.
Для спаювання відводів до товстоплівкових контактних площинок з провідникових паст проводять попереднє їх лудження методом хвилі припою або трафаретного друку. При лудженні хвилею розплавленого припою, яка створюється з допомогою насоса і сопла, встановленого під кутом до напрямку руху, де проходять товстоплівкові контактні площадки мікросхеми. При такому методі виключається забруднення елементів мікросхеми різними шлаками і залишками флюсів. Застосування додаткового лудження контактних площинок відводів забезпечує підвищену міцність контактів.
Процес спаювання також використовують при герметизації мікросхем в корпусі, коли конструкція і матеріал дозволяють застосовування зварювання. Герметизацію керамічних корпусів здійснюють спаюванням із застосуванням припою, припайних прокладок чи скляної фрити, нанесених на місця з'єднання деталей. У цьому випадку процес проводиться у спеціальних касетах в атмосфері гелію чи водню.
При спаюванні безприпойних прокладок матеріал припою наносять на кришку корпусу. Місця корпусу, де планується з'єднання з кришкою, покривають золотом, щоб розплавлений припой добре змочував місце контакту з основою. Розплав припою забезпечують струменем гарячого інертного газу. Основна складність цього процесу полягає в необхідності локального нанесення золота, срібла чи паладію.
При застосуванні припойних прокладок, які переважно виготовляються з низькотемпературного припою ПОС-61, їх поміщають між кришкою і основою в місці з'єднання. Зібрані корпуси вкладають в спеціальні касети, в яких передбачений пружинний притиск кришки до основи. Після цього зібрану касету з мікросхемами з шлюзом передають в конвеєрну піч, де вона нагрівається до температури плавлення припою. При використанні припою ПОС-61 і флюсів вносяться забруднення в зону спаювання. Це є основним недоліком застосування таких припойних прокладок.
Герметизація скляною фритою проводиться без припойних прокладок. Скляна фрита складається з порошку легкоплавкого скла, старанно перемішаного з розчинником та зв'язуючим додатком. Потім її наносять на з'єднувальні ділянки, підсушують, проводять складання у спеціальних касетах і нагрівають у печі до розплавлення фрити. При затвердженні створюється надійне герметичне з'єднання кришки з корпусом.
Кріплення дискретних безкорпусних елементів здійснюють з допомогою клеїв, спаювання чи зварювання. Основа з активними елементами та гнучкими відводами з допомогою епоксидних смол приклеюється до підкладки, а відводи під'єднуються до відповідних площинок. Епоксидні смоли мають мале осідання при затвердженні і добру адгезію з різними матеріалами, не виділяють шкідливих продуктів, хімічно стабільні і добре поєднуються з різними добавками, які надають смолі необхідну еластичність і теплопровідність, а також корегуючий температурний коефіцієнт лінійного розширення [3].
Похожие работы
... ія повинна мати високу надійність, мати корозійну і радіаційну стійкість, а також бути простою та економічною у виготовлені. Висновки В курсовому проекті виконано розробку конструкторської документації гібридної інтегральної мікросхеми. При цьому розраховано геометричні розміри елементів, площу плати і вибраний її типорозмір. Для даного варіанту площа становить 51,381 мм2. отже розмір плати ...
... 4. Як графічно позначаються польові транзистори? Інструкційна картка №9 для самостійного опрацювання навчального матеріалу з дисципліни «Основи електроніки та мікропроцесорної техніки» І. Тема: 2 Електронні прилади 2.4 Електровакуумні та іонні прилади Мета: Формування потреби безперервного, самостійного поповнення знань; розвиток творчих здібностей та активізації розумово ...
... що входять до складу припою, флюсів та миючих середовищ, до приміщень та робочих дільниць, де виконується паяння, ставляться особливі вимоги. 2.2. Вимоги до виробничих приміщень, технологічних процесів і обладнання Дільниці, на яких зосереджені операції паяння, виділяють н окреме приміщення. Опорядження приміщень, повітропроводів, комунікацій, опалювальних приладів має допускати їх очищення ...
... напилення резистивної плівки, а також контактних майданчиків і провідників через маску; фотолітографія резистивного шару; нанесення захисного шару. [1] РОЗДІЛ 3. МЕТОДИ МЕТАЛІЗАЦІЇ ІНТЕГРАЛЬНИХ СХЕМ 3.1 Термічне (вакуумне) напилення Схема цього методу показана на рис 3.1. Металевий або скляний ковпак 1 розташований на опорній плиті 2. Між ними знаходиться прокладка 3, що забезпечує пі ...
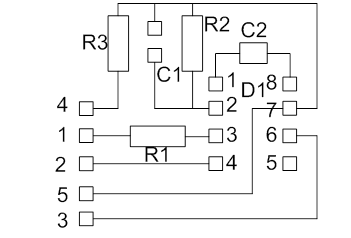




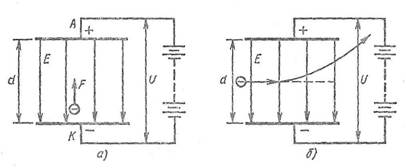





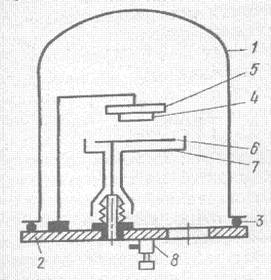
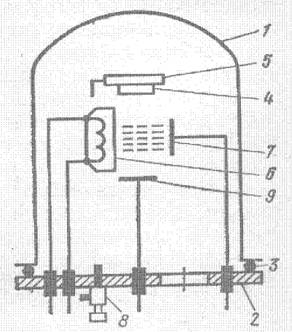
0 комментариев