Навигация
Визначення параметрів технологічного процесу
2.2. Визначення параметрів технологічного процесу.
Для проведення досліджень параметрів структур Si-SiO2 необхідно отримати плівки заданої товщини, яка співрозмірна з товщиною діелектрика напівпровідникових приладів. Оптимізацію ефективності процесу гетерування необхідно проводити шляхом вивчення впливу концентрації легуючої домішки на параметри структур.
Для зменшення об’єму емпіричних досліджень вирощування плівок проведено розрахунок температурно-часових характеристик технологічного процесу отримання плівок SiO2 заданої товщини при різному складі парогазового середовища в реакторі. В якості вихідних використали відомі з літератури [10] залежності швидкості росту оксидних плівок на монокристалічному кремнії в атмосфері або зволоженого кисню, або парах води з вмістом хлориду водню, які найближчі до досліджуваного в даній роботі процесу гетерування дефектів плівок SiO2. Це визначається тим, що в ньому в склад окислювального середовища вводять хлорид цинку, тобто, він є, в якійсь мірі, аналогом відомого з літератури процесу хлорного окислення. Тому тут використані такі стандартні рівняння:
1. d2=4.16*103p1.6t exp(-1.7/kT) – в парах води (16);
2. d=1.4*103p0.8t exp(-1.7/kT) – в сухому кисні (17),
де d – товщина плівки [нм];
t – час [с];
T – температура [К];
k – постійна Больцмана.
При розрахунках товщину плівки підзатворного діелектрика задавали в межах від 50 до 150 нм. З умов проведення експерименту загальний тиск в системі приймали рівним атмосферному. Температуру процесу окислення задавали в межах від 950 до 1100°С з кроком 50°С. Для розрахунків використовували програмний пакет “Maple 6”.
Результати розрахунків приведені в табл. 1
2.3 Методика досліджень дефектності діелектричних плівок.
Методи дослідження дефектності плівок розробляли виходячи з особливостей структури, кількості, розмірів та розміщення дефектів у матеріалі. При чому, в залежності від характеристик об’єкту досліджень, методи досліджень суттєво відрізняються між собою [10].
В діелектричних плівках виробів електронної техніки пори проявляються як поодинокі небажані дефекти. Пори в плівках мають, як правило, субмікронні розміри і безпосередньо не виявляються оптичними приладами.
Методи дослідження дефектності, зокрема пористості діелектричних плівок виробів електронної техніки описані в [10]. Проведемо їх аналіз. За дією на об’єкт досліджень їх можна поділити на дві групи: руйнуючі і неруйнуючі. Суцільною рисою всіх методів є фіксація місця розміщення пори на поверхні і наступні металографічні дослідження.
Неруйнуючі методи:
а) одним з методів виявлення дефектних місць у діелектричній плівці на монокристалічній напівпровідниковій підкладці є “бульбашковий” метод: підкладку занурюють в електролітичний розчин і освітлюють її поверхню. До підкладки прикладають від’ємну напругу зміщення так, що в провідних місцях (електрично активних) утворюються бульбашки газоподібного водню. Електроліт не повинен окислювати поверхню напівпровідникової підкладки. Як електроліти використовують 1-2% розчини лимонної або оцтової кислоти в деіонізованій воді. Роль анода у електролітичній комірці виконує платиновий дріт. Контроль якості діелектричних плівок з допомогою методів, основаних на виділенні газоподібних продуктів електролізу з дефектних місць, проводиться також при електролізі розчинів метилового і етилового спиртів, які містять 1% оцтової або сірчаної кислоти у деіонізованої води [15,16].
Виділення бульбашок водню з дефектних місць при електролізі спиртових розчинів починається при напрузі 8-10 В. плавне підвищення прикладеної напруги приводить до виявлення менших за розмірами пор і збільшення їх густини, але при напрузі більшій 30 В відбувається інтенсивне віялоподібне виділення водню у електроліті, що робить неможливим реєстрацію і визначення істинної густини дефектів.
Електроліз супроводжується виділенням водню на пластині–катоді у місцях дефектів і кисню на аноді. В реальному випадку за рахунок впливу поляризації електроліту і типу електродів для розкладення деіонізованої води необхідно прикладати напругу 2,1-2,6 В. Розроблена комірка, яку застосовували для вивчення електрохімічних процесів виділення бульбашок, в якій їх реєстрували на поверхні діелектричної плівки в дефектних місцях після 2-3 хв. електролізу при напрузі 4-6 В. Продовження електролізу веде до збільшення бульбашок за розміром і у випадку їх утворення над дефектами великих розмірів – до віддалення від поверхні, тому підрахунок густини бульбашок проводиться після вимикання або зниження напруги. Роздільна здатність цього методу складає 40-60 мкм.
б) зручнішим для аналізу дефектності діелектричних плівок є метод, який полягає у використанні спеціального електроліту, до складу якого входять: сірчанокисла мідь – 5 г/л; желатин – 5 г/л; деіонізована вода – 1л [13,14].
Суть методу полягає в наступному. При подачі напруги з області пори на пластині-катоді відбувається електрофоретичне виділення водню в результаті електролізу. Процес проводять при напрузі 10-50 В. Бульбашки водню покриті плівкою желатину, армованою міддю, що забезпечує високу міцність плівки і добре зчеплення з поверхнею діелектрика. Висока чутливість (біля 0.1 мкм) методу забезпечується тим, що електроліз води йде не на кремнії, а на міді, яка осідає у порі і виходить на поверхню плівки. Вказаний метод ми використовували для дослідження наших об’єктів.

Рис 2.3.1. Схема установки.
Руйнуючі методи:
а) Анодне травлення використовується для виявлення дефектів в підкладці з полікристалічного кремнію [15] і має переваги хімічного травлення і методу наведення струму. Електролітична комірка складається з пластмасової склянки з електролітом, в який занурюють катод з платинового дроту і зразок – анод, закріплений на металевому стержні. Електролітом служить розчин плавикової кислоти концентрації 1-10%. Напруга живлення від джерела постійного струму регулюється в межах від 0.5 до 20 В. Оптимальне розтравлення дефектів спостерігали в області потенціалів між 0.7 і 2 В. Встановлено, що характер травлення дефектів в кремнії р-типу залежить від прикладеної напруги; при дуже низькій напрузі травляться дефекти, які класифікують за методом наведеного струму як “електрично активні”, при збільшенні напруги травлення стає подібним до хімічного, але зростає чутливість до дефектів (видно дефекти, які не завжди проявляються при хімічному травленні); анодне травлення – метод виявлення дефектів в будь-яких напівпровідниках р- і n-типу провідності, здатний повністю замінити методи хімічне травлення і наведеного струму.
б)Хімічне травлення в травниках, що містять плавикову кислоту (НNO3:HF: CH3COOH) приводить як до зменшення товщини нарощеної плівки, так і до розтравлення її в місці пори до розмірів, достатніх для спостереження під мікроскопом.
Характерно, що при обробці поверхні у вказаному травнику розтравлюється також поверхня кремнієвої пластини під порою, що дозволяє встановити точне положення пор на пластині.
Апробація вказаного методу для наших об’єктів досліджень показала, оптимальний час травлення у вказаному травнику при кімнатній температурі складає 5-7 хвилин. При цьому пори можна спостерігати під мікроскопом при збільшенні х100 (рис. 2.3.2.)

Рис. 2.3.2 Вид поверхні кремнієвої пластини після селективного травлення. (Ділянки темного фону розміщені строго під порами у плівці.)
2.4. Методика вимірювання вольт-фарадних характеристик систем Si-SiO2
МДН-структура є сформованим конденсатором. Для дослідження їх електрофізичних характеристик широко використовується метод вольт-фарадних характеристик (ВФХ), в основі якого лежить вивчення залежності поперечної диференціальної ємності МДН-структури (Сс) від зовнішньої напруги, прикладеної між підкладкою і верхнім електродом (U). Зміна Сс викликана модуляцією зовнішньої напруги ємності приповерхневої області просторового заряду напівпровідника [16].
Еквівалентом вимірювання низькочастотної ВФХ є так званий квазістатичний метод. Якщо до елементарного кола, що складається з резистора і конденсатора, прикладати напругу, лінійно зростаючу з часом Uc=at (де а звичайно складає 0.05 – 0.2 В/с), то струм в цьому колі буде пропорційний ємності. Схема установки для знімання квазістатичних ВФХ приведена на рис.2.4.1. [17]
Знімати ВФХ краще в напрямку від інверсії до збагачення. Для вибору початкової робочої точки генератор пилоподібної напруги з’єднують послідовно з джерелом постійної регулюючої напруги. Тоді Uc=В+аt. Вибір полярності напруг залежить від типу провідності підкладки і знаку поверхневого заряду.
Високочастотною (ВЧ) вважається така область частот, при якій можна знехтувати вкладом у ємність МДН-структури, ємності інверсного шару (С1) і ємності поверхневих станів (Сss). Умови високочастотності записуються:
Rpb>>1/wCd, Rhs>>1/wCd.
Апаратура для вимірювання високочастотних ВФХ розрізняється за методом вимірювання ємності, методом вимірювання зміщення на МДН – структурі (Uc), методиці фіксації і методом обробки результатів.

11
Рис. 2.4.1. Схема установки для вимірювання квазістатичних ВФХ.
1 – джерело пилоподібної напруги; 2 – електрометричний підсилювач.

Рис. 2.4.2. Схема установки для вимірювання високочастотних ВФХ:
1 – джерело зміщення МДН-структури; 2 – ВЧ-генератор; 3 –резонансний підсилювач; 4 – двокоординатний самописець.
На рис.2.4.2. показана схема установки для вимірювання високочастотних ВФХ.
Від генератора змінної напруги через розділюючий конденсатор С1 сигнал поступає на ланку, що складається із Сс, який має МДН-структури, і еталонного резистора R1 (C1>>Cсвч). Спад ВЧ напруги на резисторі R1 (R1<<1/wCcвч) пропорційний Свч.[18]
Підсилена і випрямлена напруга, пропорційна Свч реєструється по координаті “Y” двокоординатного самописця. Зміщення Uc, яке повільно змінюється, через роздільний резистор (R2>>1/wCcвч) подається на МДН-структуру і координату “Х” самописця. В результаті двокоординатний самописець фіксує ВФХ досліджуваної структури.
Високочастотна напруга на МДН-структурі Свч повинна забезпечувати малосигнальний режим і відповідно задовольняти співвідношенню Uc<<kT/q у всьому діапазоні Uc. При записі ВФХ МДН-структура повинна перебувати в темноті для уникнення фотоефекту.
При зніманні ВФХ доцільно застосовувати таку послідовність операцій: до МДН-структури прикладається напруга зміщення, яка відповідає глибокій інверсії; освітлюється МДН-структура для збільшення генерації неосновних носіїв і утворення рівноважного шару (часто буває достатньо використання звичайного лабораторного освітлення); потім МДН-структура повністю затемнюється, і напруга зміщення починає змінюватись від інверсії до збагачення, при цьому на самописці фіксується рівноважна високочастотна ВФХ.
Іншим варіантом ФВХ є диференціальний високочастотний вольт-фарадний метод. При аналізі високочастотного вольт-фарадного методу зазначалося, що для визначення густини поверхневих станів необхідно порівнювати нахили експериментальної і теоретичної високочастотних ВФХ. Це означає графічне диференціювання експериментальної кривої. Зручніше проводити диференціювання експериментальної ВФХ апаратурним методом. Для цього в установку зйомки ВФХ додатково вводять диференціюючу ланку [11]. При використанні зміщення Uc=at, яке лінійно змінюється, диференціююча ланка на виході забезпечує сигнал, пропорційний dC/dU, який записується на самописці одночасно з записом ВФХ. Розшифровка залежностей С(V) відбувається аналогічно до розшифровки високочастотних ВФХ. Перевага цього методу полягає в більшій швидкодії і підвищенні точності в порівнянні з вольт-фарадним методом. [17]
Блок-схема установки для дослідження МДН-структур приведена на рис. 5.3. при вимірюванні С(V) і G(V) залежностей (П1 – в положенні “1”, П2 – в положенні “2”) на структуру подаються два сигнали: малий синусоїдальний від генератора (2) і напругу зміщення з генератора пилоподібної напруги (КГТН) (4). Сигнал з виходу інтегруючого (ІП)( 8) або диференціюючого (ДП) (9) підсилювача подається на вхід широкополосного (10) або вибіркового (11) підсилювача і далі на фазовий (ФД) (12) або амплітудний (АД) (13) детектор. На вхід “2” ФД подається опорний сигнал з генератора (2). Встановлення фази сигналу на вході “1” ФД створюється незначним розладнанням підсилювача (11). Напруга з виходу ФД (VG) і АД (VC) подається на входи “Y” двокоординатних самописців (6) і (7). На входи “Х” самописців поступає напруга з виходу КГТН.
При вимірюванні С(t) залежностей (П1, П2 і П3 в положенні “2”) на структуру подається стрибок напруги або послідовність імпульсів з формувача (3). Вихідний сигнал КГТН при дослідженні повільних процесів використовується для часової розгортки самописців. Для реєстрації процесів з часами релаксації 0.3 с використовується осцилограф (14).
Градуювання С(V), G(V), i C(t) – залежностей проводиться магазином ємностей і провідностей (П2 в положенні “1”). Установка дозволяє проводити експрес вимірювання параметрів, та досліджувати їх неоднорідності.

Рис.2.4.3. Блок-схема установкт для вимірювання C(V), G(V) та С(t)-характеристик:
1 – магазин ємностей та провідностей;
9 – диференціюючий підсилювач;
3 – генератор;
4 10 – широкосмуговий підсилювач;
3 – формувач;
11 – вибірковий підсилювач;
5 – керуючий генератор трикутної напруги;
6 12 – фазовий детектор;
5 – МОН-структура;
13 – амплітудний детектор;
7 – двокоординатний самописець;
8 14 – осцилограф;
7 – двокоординатний самописець
15 – вимірювач температури.
8 – інтегральний підсилювач;
3. Результати досліджень.
3.1. Дослідження пористості плівок термічного диоксиду кремнію.
Дефектами плівок диоксиду кремнію вважають порушення однорідності аморфного шару [23]. До їх числа відносяться включення іншої фази: пори і кристалічні ділянки. Густина структурних дефектів визначає вихід виробів електронної техніки, особливо ВІС високого ступеня інтеграції, тому розробка способів виявлення дефектів і вивчення механізмів дефектоутворення привертала увагу ряду дослідників. Для їх дослідження розроблено ряд методів, описаних в огляді, та роботах [19,20].
Літературні дані про природу пороутворення часто носять дискусійний характер. Переважно їх появу пов’язують з неконтрольованим забрудненням поверхні кремнієвої пластини до і в процесі росту плівки оксиду. Це викликало необхідність проведення циклу експериментальних досліджень пористості плівок для встановлення механізмів їх утворення.
Плівки SiO2 товщиною від 0.1 до 0.6 мкм вирощували в стандартних процесах термічного окислення кремнієвих пластин в середовищі сухого і вологого кисню. Дефектність плівок визначали шляхом металографічних досліджень під мікроскопом NU-2E після візуалізації пор бульбашками желатину при електролізі водного розчину CuSO4 і желатину (250 : 5 : 5) і шляхом селективного травлення поверхні плівок в травнику складу HF : HNO3 : CH3COOH (1 : 10 : 1) протягом 3...7 хвилин. Селективне тралення плівки оксиду проводили аж до підтравлювання підкладки, після чого знімали плівку в розчині HF і виявляли дислокації поверхні кремнієвих пластин в травнику Сіртля.

Рис. 3.2.1. Неоднорідності візуалізації пор, обумовлені їх різними розмірами (металографія, x 200)
При дослідженні пористості плівок мідножелатиновим методом, як видно з рис.3.2.1., в місцях провідних ділянок плівок виростали або желатинові грона, або бульбашки желатину значно меншого розміру. Це обумовлено суттєвою різницею швидкості процесу електролізу в різних провідних ділянках плівки викликану різними розмірами пор, що вказує на наявність щонайменше двох механізмів процесу пороутворення. Як правило, желатинові грона хаотично розміщалися по поверхні пластини і спостерігалися по подряпинах плівки. Встановлено взаємозв’язок густини “великих” пор від запиленості технологічного приміщення в якому перебували пластини після передокислювальної хімічної обробки. При запиленості в межах 4...30 л-1 їх густина в плівках SiO2 товщиною 0,1 мкм складала 0,5...2 см-2 і зменшувалась з ростом товщини плівки. В той же час, порушення норм запиленості, або спеціальна, навіть короткочасна, витримка пластин в середовищі з запиленістю до 300 л-1 приводила до різкого росту дефектності плівок до 102...103 см-2. В той же час, при ретельному контролі та дотриманні чистоти технологічного приміщення “великі” пори практично не проявлялися.
При дослідженні плівок SiO2, препарованих за методикою [24], шляхом просвічуючої електронної мікроскопії на МВ-100 встановлено, що розміри “великих” пор співрозмірні з товщиною плівки [24].
Виходячи з приведених результатів, механізм утворення наскрізної пори можна подати таким чином: при згоранні або випаровуванні речовини пилинки чи інших неконтрольованих забруднень кремнієвої підкладки при температурі окислення тиск пари в хмаринці домішок може досягнути критичної величини, достатньої для локального руйнування плівки оксиду. Аналогічний механізм пороутворення може проявлятися при випаровування преципітатів як легуючих, так і неконтрольованих домішок, сконцентрованих на структурних порушеннях кремнієвої підкладки.
Що стосується “дрібних” пор, то їх густина, усереднена на пластину, складала 1,5...3, 3,4...5,5 і 6,5...15 cм-2 для плівок термічного диоксиду кремнію товщиною 1, 0,5 і 0,15 мкм відповідно. Виявлена тенденція зменшення густини пор від краю до центру пластини. Причому, біля 80% пор розміщалися по її периметру в області до 7...12 мм від краю. Характерно, що густина пор в цій області майже на порядок вища, ніж в центрі. Скупчення пор (рис.3.2.2) проявлялися також в місцях контакту пластини з кварцовим човником і в значній мірі визначалися щільністю входження пластини в його пази.

Рис.3.2.2. Вид поверхні пластини після візуалізації пор (x200, металографія)
Як правило, по декілька пор розміщалися в ряд, причому лінії їх утворення відповідали кристалографічним лініям ковзання дислокацій. Різко неоднорідний розподіл пор в плівках SiO2, який відображає дефектоутворення в кремнієвих підкладках і свідчить про тісний взаємозв’язок умов росту плівки з дефектоутворенням в кремнію, яке проявляється в конкретному циклі дифузійно-окислювальних процесів спостерігали також в [9].

Ідентичність якісного радіального розподілу дефектів в плівках SiO2 і кремнієвих підкладках підтверджена послідовними дослідженнями розподілу пор та дислокацій вздовж фіксованих смуг шириною 5 мм вздовж діаметра пластини. Однак, в кількісному відношенні, густина пор в плівках значно нижча від густини дислокацій, які виходять на поверхню підкладки. Це вказує на те, що далеко не кожна дислокація є ініціатором пороутворення в вирощуваній плівці термічного SiO2.
3.2. Взаємозв’язок структурної досконалості монокристалічної кремнієвої підкладки і плівок SiO2.
Розглянемо можливі причини неоднорідного розподілу дефектів. Розрахунок характеру нагріву однієї пластини [19] і партії пластин [20] показав, що як при прогріві, так і при охолодженні росте нерівномірність розподілу температур вздовж радіуса пластини. В результаті розв’язання крайової задачі теплопровідності і аналізу кінетики нагріву та теплообміну в партії пластин в [20] показано, що максимальний перепад температури складає 46К при швидкості завантаження 0,002 м/c і 340К при 0,01 м/c. При цьому радіальні і тангенціальні термічні напруження пластини ростуть пропорційно різниці температур:
![]() (19)
(19)
![]() (20)
(20)
де: a - коефіцієнт термічного розширення; E - модуль Юнга; DT - різниця температур; r - координата; R - радіус пластини.
Під їх дією утворюються дислокації і проходить знімання термічного напруження в межах даної ділянки. При повторній циклічній обробці знов виникають термічні напруження, причому умови утворення дислокацій значно полегшуються (проходить розмноження дислокацій і починає діяти механізм їх передачі). Оскільки градієнт температури максимальний на краю пластини, дислокації виникають практично завжди на периферії в вигляді ліній зсувів і, в подальшому, переміщаються до центру вздовж площин ковзання [21]. Внаслідок того, що плівка SiO2 жорстко зв’язана з підкладкою, в місцях переміщення сусідніх атомних площин в напрямку ковзання дислокацій виникатимуть максимальні напруження плівки, релаксація яких буде проходити шляхом локального руйнування плівки і утворення пор. Таким чином, на нашу думку, пори повинні наслідувати не дислокації як такі, а утворюватися при їх русі вздовж площин ковзання [21].
Вказане припущення підтверджене експериментально при металографічному дослідженні протравленої в дислокаційному травнику підкладки після візуалізації пор методом [19]. На рис. 3.1.1. ділянки темного фону відповідають розтравленій поверхні кремнієвої пластини під порою. Ямки травлення виходів дислокацій на цих ділянках проявляються вздовж ліній їх утворення. Наслідування порами плівки смуги ковзання дислокацій підтверджує також рис. 2.3.2. Як видно з рисунків, в кількісному відношенні густина розтравлених ямок травлення значно менша їх сумарної густини.
Використовуючи в якості відліку орієнтацію пластин кремнію і базового зрізу встановлено напрями ліній пороутворення в плівках диоксиду кремнію. Вони відповідають кристалографічним напрямам <110> в підкладці, які, згідно [22], є найвірогіднішими напрямками ковзання в гратці типу алмаз.

Рис. 3.1.1. Закристалізована ділянка протравленої плівки SiO2
Як винятки, при металографічному дослідженні поверхні частково протравлених плівок SiO2 спостерігали також закристалізовані ділянки (Рис.3.1.1).
Пори на цих ділянках проявлялися між границями кристалітів і аморфної матриці. Їх утворення зв’язують з механічними напруженнями, що перевищують критичні, обумовленими різними значеннями к.т.р. кремнієвої підкладки, кристалічного і аморфного диоксиду кремнію. Ініціатором локальної кристалізації плівок через рідку фазу диоксид кремнію - домішка можуть служити навіть незначні кількості домішок лужних металів, найімовірнішим джерелом яких може бути поверхня кварцового реактора та неконтрольовані забруднення використовуваних реагентів.
Виходячи з викладеного можна виділити такі механізми пороутворення в плівках термічного диоксиду кремнію:
· руйнування плівки внаслідок випаровування або згорання матеріалу локальних забруднень поверхні кремнієвих пластин в процесі росту плівки;
· утворення пор при русі дислокацій підкладки під дією термомеханічних напружень;
· утворення пор при локальній кристалізації плівок, стимульованій домішками.
Характерно, що переважаюча кількість пор утворюється внаслідок дії механізму пороутворення, пов’язаного з рухом дислокацій кремнієвої підкладки в процесі росту плівки.
Похожие работы
... принтера також містить різні мови опису даних (Adobe PostScript, PCL і тощо.). Ці мови знову ж таки призначені для того, щоб забрати частину роботи у комп'ютера і передати її принтеру. Розглянемо фізичний принцип дії окремих компонентів лазерного принтера. 2.5.29 Фотобарабан Як вже писалося вище, найважливішим конструктивним елементом лазерного принтера є фотобарабан, що обертається, за ...
... а все обладнання кабіни - надійно заземлене. Пересувні пости використовують при зварюванні великих виробів безпосередньо на виробничих ділянках. Розділ 2.Основна частина 2.1 Опис технологічного процесу ручного дугового зварювання В основі будь-якого промислового виробництва лежить технологічний процес, який є частиною виробничого процесу. Виробничий процес – це сукупність технологічних ...
... ією носіїв заряду, що забезпечують велику холівську напругу. Для виготовлення магнітоелектричних приладів використають арсенід індію й телурид ртуті. Термоелектричні прилади виготовляють із напівпровідникових матеріалів, що забезпечують максимальний коефіцієнт ефективності, тобто які мають високу і низьку теплопровідність. Такими властивостями володіють антимонід цинку телурид і селенід вісмуту ...

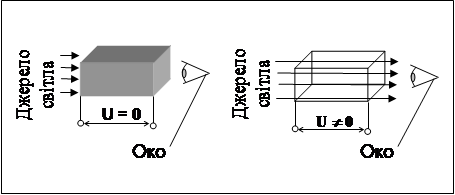


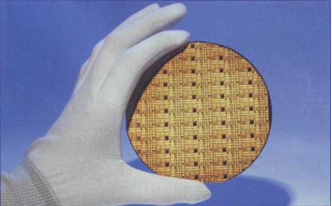


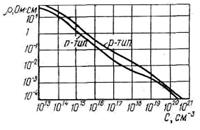


0 комментариев