Навигация
Определение времени жизни по стандарту ASTM F28-91
2. Определение времени жизни по стандарту ASTM F28-91
Cтандарт ASTM F28-91 определяет порядок и условия определения обьемного времени жизни носителей в германии и в кремнии. Эта стандарт основан на измерении спада импульсного тока вызванного импульсной засветкой образца.
Другие стандарты измерения времени жизни:
1) DIN 50440/1 “Измерение времени жизни в монокристаллах кремния на основе спада фототока”
2) IEEE Standart 255 “Измерение времени жизни неосновных носителей в кремнии и германии на основе спада фототока ”.
Стандарт ASTM F28-91 определяет три типа образцов, применяемых при измерениях. Типы образцов приведены в таблице 2.1.
Таблица 2.1. Размеры образцов, применяемых при измерениях.
| Тип образца | Длина, мм | Ширина, мм | Высота, мм |
| A | 15,0 | 2,5 | 2,5 |
| B | 25,0 | 5,0 | 5,0 |
| C | 25,0 | 10,0 | 10,0 |
Таблица 2.2 Максимально допустимые обьемные времена жизни неосновных носителей для разных полупроводников и образцов , mсек.
| Материал | Тип А | Тип B | Тип C |
| p-тип германий | 32 | 125 | 460 |
| n-тип германий | 64 | 250 | 950 |
| n-тип кремний | 90 | 350 | 1300 |
| р-тип кремний | 240 | 1000 | 3800 |
Таблица 2.3. Темп поверхностной рекомбинации для разных полупроводников и типов образцов, Rs , mS-1.
| Материал | Тип А | Тип B | Тип C |
| p-тип германий | 0,03230 | 0.00813 | 0.00215 |
| n-тип германий | 0.01575 | 0.00396 | 0,00105 |
| n-тип кремний | 0,01120 | 0,00282 | 0,00075 |
| р-тип кремний | 0,00420 | 0,00105 | 0,00028 |
После засветки образца импульсом света напряжение на образце меняется по закону:
DV=DV0exp(-t/tf) (2.1)
где:
DV – напряжение на образце
DV0 - максимальная амплитуда напряжения на образце
t - время
tf - измеренное время экспоненциального спада.
В силу нескольких причин экспоненциальная форма сигнала (2.1) может быть искажена. Это может быть обусловлено как поверхностной рекомбинацией , скорость которой много выше обьемной, так и наличия глубоких уровней, на которых могут захватыватся носители. Устранение влияния поверхностной рекомбинации достигается 2 методами:
1) Использованием длины волны излучения, возбуждающего носители
больше 1 мкм (для этого применяются фильтры см. рис. 2.1.)
2) Использование образца соответствующих размеров (см. Таблицу 2.3)
Для устранения прилипания носителей используются два метода:
1) Нагревание образца до 70 °С
2) Фоновая постоянная подсветка образца.
Однако при использовании температурного метода необходимо иметь в виду, что время жизни сильно зависит от температуры образца ( ~ 1% на градус).
Поэтому при сравнении времен жизни на нескольких образцах необходимо следить, чтобы температурные условия измерений были одинаковы.
Кроме того необходимо удостоверится, что в проводимости учавствуют носители, воникшие в результате возбуждения импульсом света. Для этого напряжение смещения Vdc, поданное на измеряемый образец должно удовлетворять требованию:
Vdc £ (106×Lc×L)/(500×m×tf) (2.2)
Где :
Lc – растояние от края области засветки образца до области контакта , мм
L – длина образца , мм
tf - измеренное время экспоненциального спада, mS.
m - - подвижность неосновных носителей, см2/В×сек
Экспоненциальный спад тока фотопроводимости соответствует времени жизни в случае , если уровень инжекции фототока мал в сравнении с уровнем инжекции тока, протекающего под действием потенциала смещения. Это требование удовлетворено в случае выполнения соотношения:
DV0/Vdc £ 0.01 (2.3)
Если это условие не выполнено, то следует внести поправку в экспоненциальный спад тока фотопроводимости по формуле:
tf = tf изм×[ 1- (DV0/Vdc) ] (2.4)
Где:
tf изм - экспоненциальный спад тока фотопроводимости
tf - экспоненциальный спад тока фотопроводимости после внесения поправки
После внесения этой поправки объемное время жизни неосновных носителей вычисляется по формуле :
t0 = (tf-1 – Rs)-1 (2.5)
Где Rs определяется из таблицы 2.3.
Стандартом ASTM F28 – 91 при выполнении вышеперечиленых условий устанавливается погрешность ±50% для измерений на германиевых образцах и ±135% для измерений на кремниевых образцах.
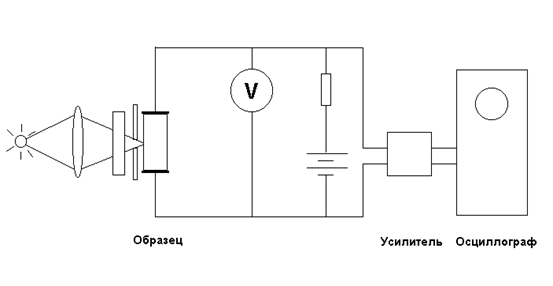
Рис. 2.1. Блок схема установки по измерению времени жизни фотоэлектирическим методом.
3. Механизмы рекомбинации
По виду передачи энергии рекомбинирующих частиц различают три основных типа рекомбинации.
1. Рекомбинация называется излучательной, или фотонной, если энергия рекомбинирующих частиц выделяется в виде энергии фотона.
2. Если энергия частицы передаётся решетке (фононам) , то рекомбинация называется безизлучательной, или фононной.
3. Одним из видов безизлучательной рекомбинации является ударнaя ионизация ( процессы Оже ), когда энергия рекомбинирующих частиц передается третьей частице , которая благодаря этому становиться “горячей”. “Горячая” частица в результате нескольких столкновений передает свою энергию фононам.
Помимо этих трех основных механизмов, энергия рекомбинирующих частиц может передаваться электронному газу ( плазменная рекомбинация ). Если электрон и дырка образуют в качестве промежуточного состояния экситон, то такая рекомбинация носит название экситонной.
Фотонная, фононная и рекомбинация Оже могут протекать по разному в зависимости от механизма перехода электрона из зоны проводимости в валентную зону. Если частицы рекомбинируют в результате непосредственной встречи электрона и дырки, то такая рекомбинация называется прямой, или межзонной. Прямая рекомбинация играет роль в полупроводниках с малой шириной запрещенной зоны порядка 0,2 – 0,3 эВ и меньше.
Если ширина запрещенной зоны больше 0,5 эВ , то рекомбинация происходит через локализованные состояния , лежащие в запрещенной зоне. Эти сосстояния обычно называются рекомбинационными ловушками.
Предположим, что в полупроводнике имеются дефекты уровни энергии которых лежат в запрещенной зоне , а уровень энергии Et не занят электроном (дыркой). Возможен целый ряд процессов, схематически изображенных на
Рис. 3.1.

Рис. 3.1. Схемы рекомбинации носителей. Ес –дно зоны проводимости, Et – уровень в середине запрещённой зоны, Еv – уровень валентной зоны.
а)- нейтральный дефект захватывает свободную дырку
б)- отрицательно заряженый дефект отдает электрон в зону проводимости. Таким образом, электрон , побыв некоторое время
на уровне дефекта, вновь становится свободным. Если дефект с уровнем энергии Et осуществляет захват свободных электронов с последующим их освобождением , то он называется ловушкой захвата электрона;
в)- нейтральный дефект захватывает свободную дырку ( отдает электрон валентной зоне);
г)- положительно заряженый дефект захватывает электрон из валентной зоны; такой дефект называется ловушкой захвата дырки;
д)- захватив электрон из зоны проводимости, отрицательно заряженый дефект захватывает свободную дырку – отдаёт захваченый электрон в валентную зону. Происходит процесс рекомбинации пары электрон - дырка;
е)- захватив свободную дырку, положительно заряженый дефект захватывает свободный электрон, превращаясь в нейтральный дефект. Происходит процесс рекомбинации свободной пары электрон – дырка.
Захват носителей заряда не влияет на стационарное время жизни,
но оказывает влияние на мгновенное время жизни. Освобождение захваченного носителя заряда может быть вызвано тепловым перебросом.
В некоторых случаях это происходит в результате подсветки.
4. Выводы
В связи с бурным развитием силовой электроники в последнее время проявляется повышенный интерес к высокоомному кремнию. Высокоомный кремний является материалом для таких приборов как IGBT, GTO, IGCT, MCT. Поэтому контроль времени жизни в кремнии, возможность его регулирования в заданных пределах предсталяет большой практический интерес.
Литература:
1. W.L. Engl, R. Laur and K. Dirks, IEEE, CAD-1,85, 1982
2. Technology Modeling Associates. Inc.Palo Alto,California. USA, MEDICI user’s manual. March 1992
3. W. Van Robosbroek, Bell System Technical Journal, 29 , 560 , 1950
4. W. Shokley and T.W. Read, Physical Review 87, pp. 835-842, 1952 ; R. N. Hall, Physical Review 87, 387, 1952.
5. M. S. Tiyagi, R. Van Oberstaen, Minority carrier recombination in in heavily doped silicon. Solid State Elrctronics, Vol. 26, No. 6, pp. 577-597, 1983
6. A.G. Milnes, Deep Impurities in Semiconductors, Wiley, New York, 1973.
7. I.V. Grekhov, N.N Korotkov and A.E. Otbelsk, Soviet Physics Semicond., 12, 184 , 1977.
8. J. M. Dorkel, Ph. Lecturcq, Solid – State Electronics, Vol. 24, pp. 821 –825, 1981.
9. Y.G. Gerstenmaier, Proc. Of the 6th Internat. Symposium on Power
Semiconductor Devices & IC’s, Davos, Switzerland, May 31 – June2, pp. 271 –274 ,1994
10. Ichiro Omura and Akio Nakagava, Proc. Of 1995 ISPSD, pp. 422-426, 1995, Yokohama.
11. Olof Tornblad et al, Proc. Of 1995 ISPSD, pp. 380-384, 1995, Yokohama.
12. Thomas Flohr and Reinhard Helbig, IEEE Transactions on Electron Devices Vol. 37, No. 9 Sept., pp. 2076-2079, 1990.
13. Shinji Aono, Tetsuo Takahashi, Katsumi Nakamura, Hideki Nakamura, Akio Uenishi, Masana Harada. A simple and effective lifetime evaluation method with diode test structures in IGBT. // IEEE Trans. On Electron. Dev. n.2, pp. 117-120, 1997.
14. Годовой отчет по интеграционному проекту. ИФП СО РАН, 1997.
15. M. W. Huppi, Proton irradiation of silicon : Complete electrical characterization of the induced recombination centers, Jour. Applied Physics, vol. 68, pp 2708-2707, 1990.
16. Simon Eicher, Tsuneo Okura, Koichi Sugoyama, Hideki Ninomiya, Hiromichi Ohashi, Advanced Lifetime Control for reducing turn-off swithing losses of 4.5 kV IEGT devices, Proc. Of 1998 International Symposium on Power Srmiconductor Devices & IC’s, Kyoto, 1998.
17. Яновская С.Г., Реферат “ Формирование и геттерирующие свойства нитридных преципитатов в слоях Si, имплантированных ионами азота.”, ИФП СО РАН, 1997.
Похожие работы
... измениться в е раз из-за рекомбинации. Для диода с тонкой базой при низкой частоте постоянная времени равна (1.6) 2. РАСЧЕТ и исследование мощных низкочастотных диодов на основе кремния 2.1 Расчет параметров диода Проведем расчет и исследования статических и динамических характеристик 4H-SiC p+-п0-n+ диодов, рассчитанных на обратное напряжение 6, 10 и 20 кВ и ...
... большой I (откр., или вкл. сост.). Принцип действия Т тесно связан с принципом действия бип. транз-ра, в кот. и электроны, и дырки участвуют в механизме проводимости. Название «тиристор» произошло от слова «тиратрон», поскольку электрические хар-ки обоих приборов во многом аналогичны. Благодаря наличию двух устойчивых состояний и низкой мощности рассеяния в этих состояниях Т обладают уникальными ...
... n-базе. А это требует специальных мер, в связи, с чем разумно ограничить расширение области объемного заряда в n-базу созданием сильнолегированного n+ - слоя. Расчет геометрических размеров слоев диффузионного выпрямительного элемента сравнительно легко можно провести, используя приближение экспоненциального перехода. Параметры аппроксимации λ и N0 и глубина залегания диффузионного перехода ...
... что образование на тыльной стороне p – n перехода существенно ухудшает электрофизические параметры СЭ. ВЫВОДЫ Одним из наиболее перспективных методов диффузионного легирования кремния для производства кремниевых солнечных элементов является диффузия из поверхностного источника. Особенностью этого метода является то, что создание слоя примесносиликатного стекла, из которого будет идти диффузия ...
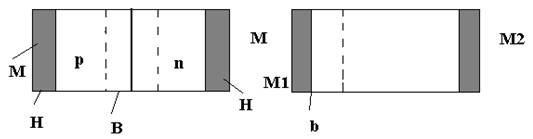


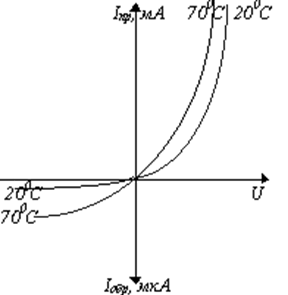
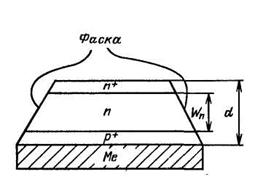

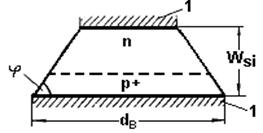
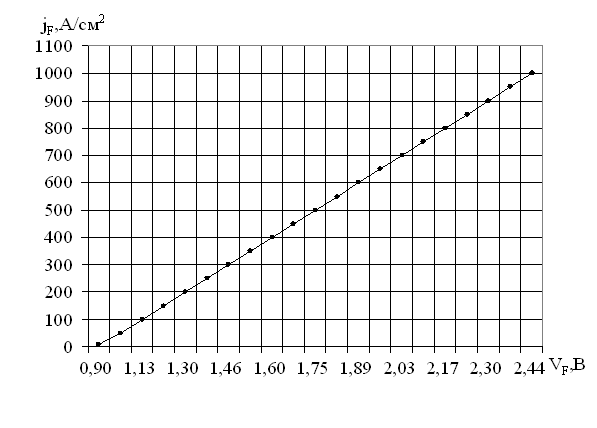


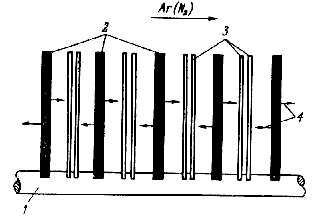
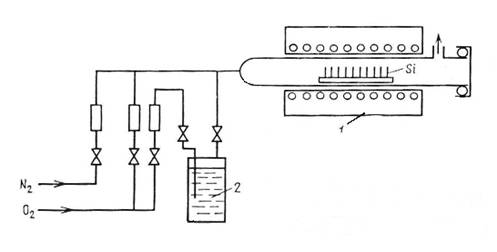
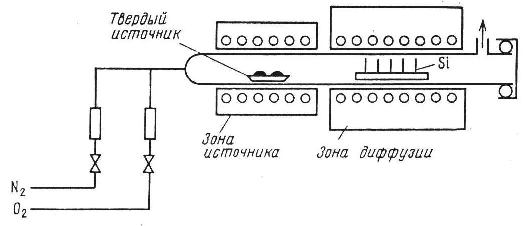


0 комментариев