Навигация
Определение времени жизни носителей в высокоомном кремнии. Влияние времени жизни на параметры высоковольтных приборов на кремнии
Российская Академия Наук
Сибирское отделение
Институт физики полупроводников
Реферат
к сдаче кандидатского экзамена
по специальности 01.04.10
“Физика полупроводников”
на тему:
“ Определение времени жизни носителей в высокоомном кремнии.
Влияние времени жизни на параметры высоковольтных приборов на кремнии.”
Чернявский Е. В. Научный руководитель:
к.ф-м. н. Попов В.П.
Новосибирск - 1999Содержание:
Введение1. Обзор литературы
2. Определение времени жизни по стандарту ASTM F28-91
3. Механизмы рекомбинации
4. Выводы
Введение
Для биполярных приборов, работа которых связана с инжекцией неосновных носителей, особенно для приборов, работающих в области высоких напряжений, врямя жизни носителей чрезвычайно важно для таких параметров как: падение напряжения в открытом состоянии , динамические характеристики, поткри при выключении. Обычно компромисс между этими конкурирующими параметрами достигается путём облучения электронами, протонами или легированием примесями , дающими глубокие уровни в кремнии. Также время жизни является важным параметром для характеризации высокоомного кремния , его структурного совершенства. В связи с этим измерения времени жизни, возможность его регулирования представляет большой практический интерес.
1. Обзор литературы.
Для многих приборов, таких как высоковольтные тиристоры, необходим
большой температурный диапазон работы, в пределах 40° С - 125° С. Поэтому изменение времени жизни носителей в зависимости от температуры может оказать существенное влияние на характеристики прибора.
В программах моделирования полупроводниковых приборов
( одномерных [1], двумерных [2]) решаются стандартные уравнения диффузионно – дрейфового приближения [3]. Обычно применяется модель рекомбинации Шокли – Холла - Рида [4] для одного уровня в запрещённой зоне. Время жизни для электронов и дырок в этой модели описывается как
tр=1 /spVthNt tn=1 /snVthNt (1.1)
где:
Nt – концентрация рекомбинационных центров.
Vth = (3kT/m)1/2» 107 см/сек – тепловая скорость носителей
sp , sn – сечение захвата электронов и дырок соответственно.
В пренебрежении зависимостью sp , sn от температуры это позволяет предположить, что tn,р меняется с температурой как Т-1/2. Многочисленные исследования [5], [6], [7], показывают, что температурная зависимость tn,р существенно сильнее. Согласно [7] температурная зависимость времени жизни определяется как:
tр ~T2.8 tn ~T2.2 (1.2)
Кроме того, при моделировании приборов необходимо учитывать зависимость времени жизни от концентрации акцепторной и донорной примеси. Такая зависимость рассмотрена в [8]. Она определяется формулой :
tn,p(x) = tn,p / (1+( {Na(x)+Nd(x)}/3*1015 )1/2 ) (1.3)
В работе [9] проводилось 2-х мерное моделирование зависимости тока управляющего электрода в GTO (Gate Turn Off thyristor) от температуры. В этой работе использовалась модель подвижности Даркеля и Летурка [8], в которой учитываются эффекты рассеяния носителей заряда на носителях, возникающие при высоких уровнях инжекции. Также была модифицирована температурная зависимость подвижности носителей. Были добавлены учет диссипации энергии при протекании тока и учет энергии рекомбинации. Дополнительно к сокращению времени жизни в высоколегированных областях ( по Шарфеттеру) n-эмиттера использовался коэффициент 0,8 учитывающий эффекты геттерирования и коэффициент 0,3 в высоколегированных слоях р-эмиттера , учитывающий вжигание аллюминиевой металлизации на анодном контакте. Рассчитанный по этой модели ток сравнивался с экспериментом. Полученная таким образом зависимость времени жизни приведена на рис. 1.1

Рис. 1.1. Температурная зависимость времени жизни по [9]
В температурном диапазоне 25° С - 125° С наблюдается линейный рост времени жизни в зависимости от температуры.
В сязи с массовым выпуском IGBT (Insulated Gate Bipolar Transistor), GTO встает вопрос о быстром и надежно тестировании времени жизни носителей непосредственно на кристалле прибора. В работах [10] , [11], [12] рассматривается вопрос о использовании для этой цели p-i-n диодов. В работе [13] приводится пример тестовой структуры , изготавливаемой непосредственно на кристалле IGBT, применяемой для контроля времени жизни. Приведены вольт – амперная характеристика и значения падения напряжения на диоде в зависимости от времени жизни в n— базе. Максимальная плотность тока в диоде 100 А/см2. Тестируемые значения времени жизни от 4 до 100 mсек. Определенные времена жизни по падению напряжения проверялись по методу восстановления обратно смещенного диода.
Однако площадь тестовых элементов, расположенных на скрайбовой дорожке кристалла может оказаться мала для уверенного определения времени жизни. В лаб. 10 ИФП СО РАН разработан метод, позволяющий определять время жизни на рабочих структурах МСТ после дополнительных технологических обработок [14]. Применяемый метод – восстановление обратно смещенного диода. В качестве катода использовался Р-карман над которым расположен контакт к затвору тиристора. В процессе измерений сравнивались кристаллы МСТ, изготовленные по одному технологическому маршруту на двух предприятиях – АО “Ангстрем” и АО “Восток”. Средние значения времени жизни составили – 40,3 мкс (АО “Ангстрем”) и 11,6 мкс (АО “Восток”). Из сравнения времен жизни видно, насколько важна технологическая чистота процессов, используемых при изготовлении высоковольтных приборов. Недостатком метода является то, что этот метод – разрушающий.
Так как время жизни жизни в высокомной базе определяет такую важную характеристику прибора как , как потери энергии во время выключения прибора, то в литературе уделяется большое внимание регулированию этого параметра. В качестве одного из методов применяется облучение протонами эмиттерной (анодной) стороны прибора [15]. Эта технология позволяет уменьшить потери при выключении прибора путем введения большого числа рекомбинационных центров и уменьшения времени жизни носителей в базовой области , примыкающей к аноду. В работе [16] в качестве примера рассматривался IEGT (Injection Enhanced Gate Transistor) c напряжением блокирования 4,5 кВ. Для облучения применялись протоны с дозами 5×1011 см-2 и 7×1011 см-2. Об энергиях протонов в статье не сообщается, но по глубине залегания радиационных дефектов можно сказать, что она не менее 2 МэВ. Падения напряжения в открытом состоянии составили не менее 4,7 и 5,4 В соответственно при плотности тока 100 А/см2. Потери энергии при выключении составили 35 mДж/см2 и 25 mДж/см2. Однако при повышении дозы облучения на ВАХ появлется участок с отрицательным динамическим сопротивлением, что приводит к осцилляциям тока и ухудшению характеристик прибора. В статье [16] указано на необходимость точного подбора дозы облучения.
Регулирование времени жизни представляет интерес не только с точки зрения его уменьшение. Падение напряжения в низколегированой области зависит от величины времени жизни. В процессе технологических обработок пластины загрязняются примесями, многие из которых представляют из себя рекомбинационные центры. Поэтому встаёт вопрос о геттерировании таких примесей в процессе технологических обработок с целью повышения времени жизни носителей. Вопросы геттерирования подробно рассмотрены в [17] .
Похожие работы
... измениться в е раз из-за рекомбинации. Для диода с тонкой базой при низкой частоте постоянная времени равна (1.6) 2. РАСЧЕТ и исследование мощных низкочастотных диодов на основе кремния 2.1 Расчет параметров диода Проведем расчет и исследования статических и динамических характеристик 4H-SiC p+-п0-n+ диодов, рассчитанных на обратное напряжение 6, 10 и 20 кВ и ...
... большой I (откр., или вкл. сост.). Принцип действия Т тесно связан с принципом действия бип. транз-ра, в кот. и электроны, и дырки участвуют в механизме проводимости. Название «тиристор» произошло от слова «тиратрон», поскольку электрические хар-ки обоих приборов во многом аналогичны. Благодаря наличию двух устойчивых состояний и низкой мощности рассеяния в этих состояниях Т обладают уникальными ...
... n-базе. А это требует специальных мер, в связи, с чем разумно ограничить расширение области объемного заряда в n-базу созданием сильнолегированного n+ - слоя. Расчет геометрических размеров слоев диффузионного выпрямительного элемента сравнительно легко можно провести, используя приближение экспоненциального перехода. Параметры аппроксимации λ и N0 и глубина залегания диффузионного перехода ...
... что образование на тыльной стороне p – n перехода существенно ухудшает электрофизические параметры СЭ. ВЫВОДЫ Одним из наиболее перспективных методов диффузионного легирования кремния для производства кремниевых солнечных элементов является диффузия из поверхностного источника. Особенностью этого метода является то, что создание слоя примесносиликатного стекла, из которого будет идти диффузия ...
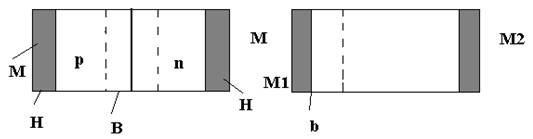


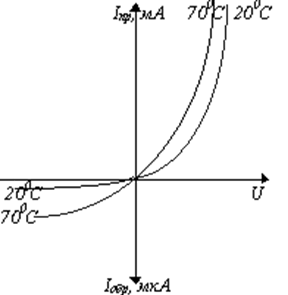
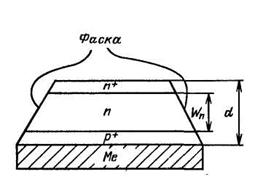

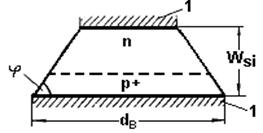
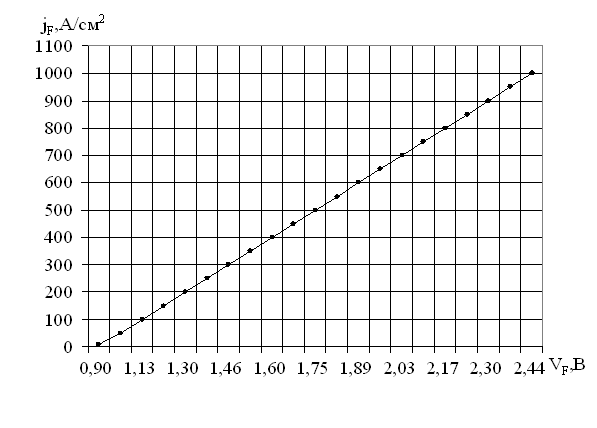


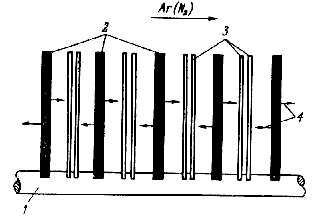
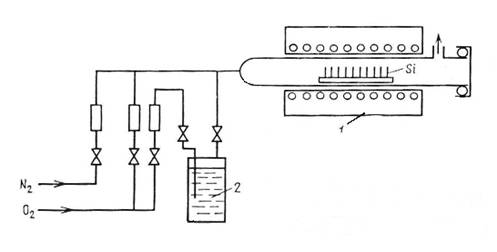
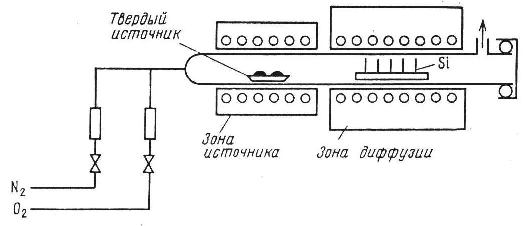


0 комментариев