Навигация
Формирование защитного рельефа
2. Формирование защитного рельефа
Одной из важнейших стадий является совмещение изображений на шаблоне и подложке. В любом фотолитографическом методе — контактном, проекционном, и в методе сканирующего луча — необходимым отправным пунктом является некоторый шаблон, образец, содержащий информацию о размерах, расположении, конфигурации и т. д. получаемых изображений.
Чаще всего для этой цели используются пластинки из оптического стекла с полученными фотографическим или иным способом непрозрачными элементами, хотя для решения некоторых задач могут применяться, например, плоские металлические пластинки со сквозными отверстиями.
При наличии современных фоторезистов и отработанной технологии качество фотолитографии во многом определяется качеством фотошаблонов, а производство их является в настоящее время одним из наиболее сложных процессов, связанных с фотолитографией. Сложность изготовления высококачественных фотошаблонов для распространенной в настоящее время контактной фотолитографии определяется их специфическими особенностями:
1. Высокая разрешающая способность. Фотошаблон содержит элементы весьма малых размеров: от 0,1 мкм
2. Большое количество идентичных изображений, количество изображений доходит до 20000.
3. Высокая контрастность изображения, т. е. максимально большая оптическая плотность непрозрачных участков и прозрачность остальных областей, оптические свойства фотошаблонов измеряют в видимом диапазоне, а используют фотошаблоны, как правило в УФ области. Учет спектральных свойств материала фотошаблона является характерной особенностью фотолитографии па полупроводниках.
4. Высокая точность соблюдения размеров элементов и шага между элементами, точность по размерам и точность по шагу определяются необходимостью последовательного совмещения фотошаблонов комплекта. В полупроводниковой технологии в 90% случаев используется не отдельный фотошаблон, а комплект из многих (до 20) фотошаблонов, степень совмещаемости которых целиком зависит от указанных точностей.
5. Высокое качество и однородность, под однородностью при этом понимается равномерно высокое качество всех повторяющихся изображений.
6. Стабильность характеристик (геометрических, оптических и др.). Фотошаблоны, например, не изготовляются на фотопленке (хотя насчитывается немало сортов пленки с весьма высокой разрешающей способностью), так как размеры элементов и взаимное их расположение не должны меняться с изменением влажности и температуры окружающей среды.
7. Высокая устойчивость к истиранию, эмульсионный фотошаблон теряет качества после 20 операций контактной печати, металлизированные, в частности хромовые, фотошаблоны обладают гораздо большей (по некоторым данным в 3000 раз) износоустойчивостью, нежели эмульсионные.
8. Плоскостность рабочей (контактной) стороны шаблона.
Возможны два метода совмещения: базовое и визуальное. При базовом методе шаблоны комплекта укрепляются в специальных приспособлениях — рамках, снабженных установочными микрометрическими винтами. С помощью этих винтов под микроскопом фотошаблоны выставляются таким образом, чтобы элементы их совпадали для всего комплекта. В рамках предусмотрены также фиксирующие упоры или плоскости. На пластинке полупроводника должны быть выполнены особые базовые отметки. Чаще всего от круглой пластинки отрезают сегмент, базой служит получающийся срез. Пластина прижимается двумя точками базового среза и одной точкой окружности к фиксирующим элементам рамки; тем самым положение пластины точно определяется. При повторной фотолитографии пластина устанавливается в рамку со вторым фотошаблоном и снова выставляется фиксирующими элементами в точно такое же положение, как и на первой рамке. Изображения второго фотошаблона в результате совмещаются с изображениями, оставшимися на пластине после первого фотошаблона (и так далее для всех шаблонов комплекта). Базовый метод отличается простотой и высокой производительностью, однако ему свойственны принципиальные ограничения: малая точность и чувствительность к повреждениям пластинки.
Малая точность совмещения объясняется тем, что воспроизводимым образом прижимать пластинку к фиксирующим элементам рамки трудно; метод позволяет реализовать точность порядка ± 10 мкм. Еще более ограничивает применимость метода то обстоятельство, что при повреждении базовых поверхностей пластинка переходит в неисправимый брак. Визуальный метод заключается в том, что изображение на пластине непосредственно наблюдается (под микроскопом) в неактиничном свете и совмещается с изображением на фотошаблоне при помощи, например, микрометрических подач. Собственно, эта же операция визуального совмещения входит неотъемлемой частью и в базовый метод, когда фотошаблоны выставляются в рамках. Экспонирование фоторезиста может осуществляться контактным или проекционным способом. В любом случае под действием актиничного излучения в слое образуются локальные участки с изменившимися свойствами. Выбор источника, пригодного для экспонирования того или иного фоторезиста, определяется спектральным распределением чувствительности данного резиста. Для экспонирования резистов пригодны угольные дуги, ртутно-кварцевые лампы сверхвысокого и высокого давления типа ПРК-2, ПРК-4, СВДШ-250, СВД-120 и др. Зная спектральные характеристики фоторезиста и источников, можно рассчитывать, какой из них наиболее эффективен. Проявление и сушка рельефа. Процесс проявления в любом случае – для негативных или позитивных фоторезистов—заключается в удалении ненужных участков слоя; в результате на поверхности подложки остается защитный рельеф требуемой конфигурации. Однако если у негативных фоторезистов проявление является простым удалением неполимеризованных областей (иногда в том же растворителе, какой использовался для приготовления резиста), то у позитивных проявление связано с химической реакцией превращения инден-карбоновых кислот в растворимые соли. Проявление позитивных слоев — критичный процесс, зависящий от ряда факторов: а) тип проявителя (щелочное соединение, добавки и др.) и его концентрация; б) время и температура проявления; в) дополнительное механическое удаление растворенных участков. Для проявления позитивных фоторезистов на основе хинондиазидов обычно используют сильно разбавленные водные растворы едкого натра или тринатрийфосфата. Некоторые фирмы прилагают к фоторезистам специализированные проявители. Сушка проявленного рельефа отличается от сушки слоя тем, что при ней можно не опасаться теплового сшивания (или разрушения) фоторезиста. Соответственно температура второй сушки задается более высокой — это повышает защитные свойства рельефа.
Похожие работы
... связью (ПЗС), на которых могут быть построены сдвиговые регистры, запоминающие устройства и некоторые логические элементы. 3. Причины ограничивающие минимальные размеры интегральных микросхем Для выбранной структуры ИМС минимальные размеры элементов ИМС в целом зависят от возможностей фотолитографического процесса, которые характеризуются тремя основными параметрами: 1) минимальным размером ...
... используется комбинация стандартного фотолитографического процесса с литографией при помощи электронного пучка. Пучки сфокусированных ионов (чаще всего ионов Ga) также применяются при изготовлении фотонных кристаллов методом травления, они позволяют удалять часть материала без использования фотолитографии и дополнительного травления. Современные системы использующие сфокусированные ионные пучки ...
... кремний перестает смачиваться травителем. При травлении пленок диоксида и нитрида кремния возможны различные виды брака, обусловленные следующими причинами. Так, растравливание, характерным признаком которого является появление интерференционных кругов под слоем фоторезиста вокруг вскрытых окон, вызывается нарушением межоперационного времени хранения подложек, плохой адгезией фоторезиста к их ...
... фотолитографии по алюминиевой металлизации, которая не превышает ±1 мкм. Использование поликремния в качестве материала затвора (рис.5) позволило получить ряд существенных конструктивно-технологических преимуществ и значительно повысить параметры МДП-приборов. Значительно уменьшена глубина залегания р-п переходов истока и стока (до 2...1 мкм) и боковой диффузии (до 0,6...1,4 мкм), а вместе с ...
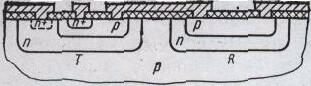

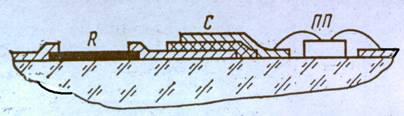


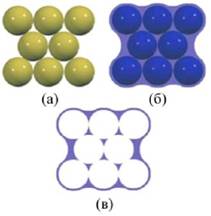

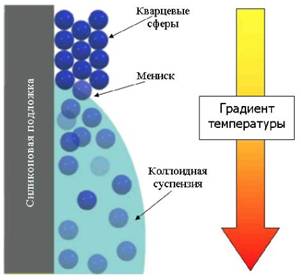


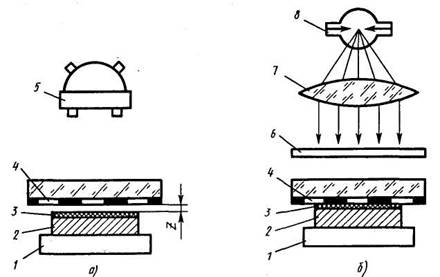
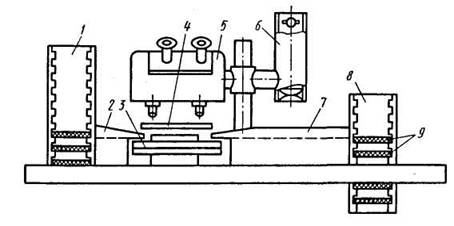
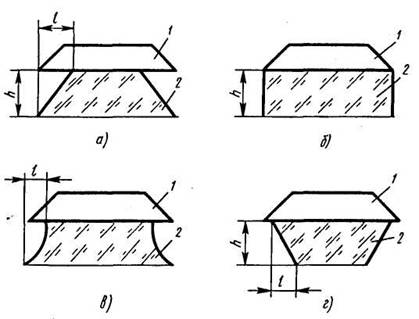
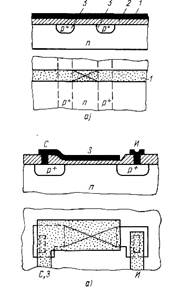
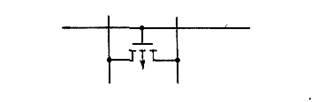
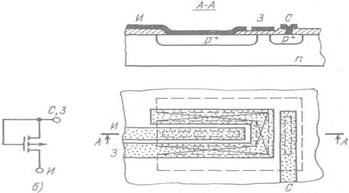
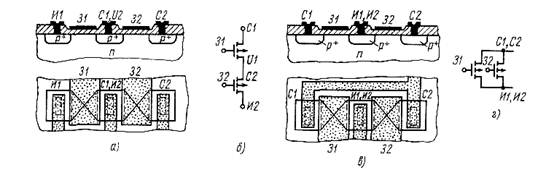
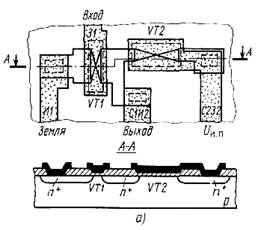
0 комментариев