Навигация
Эквивалентная схема и быстродействие МДП-транзистора
1.8 Эквивалентная схема и быстродействие МДП-транзистора
Исходя из общефизических соображений, МДП-транзистор можно изобразить в виде эквивалентной схемы, представленной на рис. 1.15. Здесь Rвх обусловлено сопротивлением подзатворного диэлектрика, входная емкость СBX - емкостью подзатворного диэлектрика и емкостью перекрытия затвор - исток. Паразитная емкость Спар обусловлена емкостью перекрытий затвор - сток. Выходное сопротивление Rвых равно сопротивлению канала транзистора и сопротивлению легированных областей истока и стока. Выходная емкость Свых определяется емкостью р-n-перехода стока. Генератор тока i1 передает эффект усиления в МДП-транзисторе [3].

Рисунок 1.15 - Простейшая эквивалентная схема МДП-транзистора
Определим быстродействие МДП-транзистора исходя из следующих соображений. Пусть на затвор МДП-транзистора, работающего в области отсечки, так что Vgs = Vds = Vпит, подано малое переменное напряжение ũ = u0sin(ωt).
Тогда за счет усиления в стоковой цепи потечет ток i1, равный:
![]() =S·ũ (1.18)
=S·ũ (1.18)
Одновременно в канал с электрода затвора потечет паразитный ток смещения через геометрическую емкость затвора, равный:
![]() = й2πfCOXWL (1.19)
= й2πfCOXWL (1.19)
С ростом частоты выходного сигнала f паразитный ток будет возрастать и может сравниваться с током канала за счет эффекта усиления. Определим граничную частоту работы МДП-транзистора f =fмакс, когда эти токи будут равны. Получаем с учетом (6.22):
 (1.20)
(1.20)
Поскольку напряжение исток-сток VDS порядка напряжения VGS - VT, то, используя определение дрейфовой скорости
 (1.21)
(1.21)
можно видеть, что предельная частота усиления fмакс определяется временем пролета τ электронов через канал транзистора:
 (1.22)
(1.22)
Оценим быстродействие транзистора.
Пусть величина подвижности μn = 500 см2/(В·с),длина канала L = 10 мкм = 10-3 см, напряжение питания Vпит = 10 В. Подставляя эти значения в (1.20), получаем, что максимальная частота для МДП-транзистора составляет величину порядка fмакс ≈ 1 ГГц. Заметим, что собственное быстродействие транзистора обратно пропорционально квадрату длины инверсионного канала. Поэтому для повышения быстродействия необходимо переходить на субмикронные длины канала.
2 РАСЧЕТ ПАРАМЕТРОВ И ХАРАКТЕРИСТИК МДП-ТРАНЗИСТОРА НА ОСНОВЕ АРСЕНИДА ГАЛЛИЯ
2.1 Основные сведения об арсениде галлия
Арсени́д га́ллия (GaAs) — химическое соединение галлия и мышьяка. Важный полупроводник, третий по масштабам использования в промышленности после кремния и германия. Используется для создания высокочастотных интегральных схем, светодиодов, лазерных диодов, диодов Ганна, туннельных диодов и транзисторов.
Некоторые электронные свойства GaAs превосходят свойства кремния. Арсенид галлия обладает более высокой подвижностью, позволяющей работать на частотах 250 ГГц.
Также приборы на основе GaAs генерируют меньше шума, чем кремниевые устройства на той же операционной частоте. Из-за более высокого напряжения пробоя в GaAs чем в Si эти приборы могут работать при большей мощности. Эти свойства делают GaAs широко применяемым в мобильных телефонах, твердотельных лазерах, некоторых радарных системах. Полупроводниковые приборы на основе арсенида галлия имеют более высокую радиационную стойкость, чем кремниевые, что обуславливает его использование при наличии радиационного излучения (например, в солнечных батареях в космической технике).
GaAs — прямозонный полупроводник, что также является его преимуществом. GaAs может быть использован в оптических приборах: светоизлучающих диодах, твердотельных лазерах.
Сложные слоистые структуры арсенида галлия в комбинации с арсенидом алюминия (AlAs) или тройными растворами AlxGa1-xAs можно вырастить с помощью молекулярно-лучевой эпитаксии (МЛЭ). Из-за практически полного согласования постоянных решёток слои имеют малые напряжения и могут выращиваться произвольной толщины.
Основны свойства и параметры полупроводника представлены в таб. 2.1.
Таблица 2.1 - Основны параметры GaAs
| Свойства | |
| Общие | |
| Название | арсенид галлия |
| Химическая формула | GaAs |
| Внешний вид | Тёмно-серые кубические кристаллы |
| Структура | |
| Атомный вес | 144,64 ат. ед. |
| Постоянная решётки | 0,56533 нм |
| Кристаллическая структура | цинковой обманки |
| Физические | |
| Агрегатное состояние при н. у. | твёрдое |
| Точка плавления при н. у. | 1513 K |
| Электронные | |
| Ширина запрещённой зоны при 300 K | 1.424 эВ |
| Электроны, эффективная масса | 0.067 me |
| Лёгкие дырки, эффективная масса | 0.082 me |
| Тяжёлые дырки, эффективная масса | 0.45 me |
| Подвижность электронов при 300 K | 9200 см²/(В·с) |
| Подвижность дырок при 300 K | 400 см²/(В·с) |
По физическим характеристикам арсенид галлия более хрупкий материал, чем кремний. Кроме того подложки из арсенида галлия гораздо сложнее для изготовления и дороже, что ограничивает применение материала.
Токсические свойства арсенида галлия не были детально исследованы, но это вещество токсично и канцерогенно [9].
2.2 Основные параметры МДП-транзистораСox — удельная емкость подзатворного диэлектрика
IсID — ток стока
IзIG — ток затвора
IDS — ток канала исток-сток
R0 — омическое сопротивление
Ri — внутреннее сопротивление
S — крутизна характеристики
Uзи UGS — напряжение затвор-исток
Uси UDS — напряжение исток-сток
Uзс UDG — напряжение сток-затвор
UЗИ пор Uпор UGS(th) VT — пороговое напряжение
UЗИ отс Uотс UGS(off) — напряжение отсечки
Vox — падение напряжения на окисном слое
VТ — пороговое напряжение
VSS — напряжение, приложенное к подложке
μ — коэффициент усиления
2.3 Расчет параметров МДП-транзистораИсходные данные для расчетов:
- ширина п/п структуры Zк=1500·10-4 см;
- длина канала Lk=6·10 -4 см;
- толщина оксидного слоя (изолятора затвора) d=0,16·10-4 см ;
- концентрация акцепторов в подложке Na=6·1015 см -3 ;
- поверхностная плотность зарядов Nпов=1,2·1011 см -2;
- толщина истока hист=4·10-4 см;
- длина истока lист=7·10-4 см;
- толщина стока hcток=4·10-4 см;
- длина стока lсток=7·10-4 см;
- тепловое сопротивление корпуса Rt= 40 К/Вт .
Рассчитаем напряжение смыкания, В:
 (2.1)
(2.1)
где q – заряд электрона, а j f = 0,38 В – потенциал уровня Ферми.
![]()
Найдем удельную емкость «затвор-канала», Ф:
![]() (2.2)
(2.2)
где ![]() = 4 – диэлектрическая проницаемость диоксида кремния.
= 4 – диэлектрическая проницаемость диоксида кремния.
![]()
Ширина обедненного слоя в канале при Uзи =0 находится по формуле:
 (2.3)
(2.3)

Плотность заряда нескомпенсированных ионизированных атомов примеси в подложке, Кл/см2:
![]() (2.4)
(2.4)
![]()
Плотность заряда на границе диэлектрик-полупроводник, Кл/см2:
![]() (2.5)
(2.5)
![]()
Крутизна, А/В:
![]() (2.6)
(2.6)
где ![]() =0,15 м2∙В-1∙с-1— подвижность электронов в канале.
=0,15 м2∙В-1∙с-1— подвижность электронов в канале.
![]()
Пороговое напряжение транзистора, В:
![]() (2.7)
(2.7)
![]()
Коэффициент К:
![]() (2.8)
(2.8)
![]()
Паразитные емкости затвора, Ф:
![]() (2.9)
(2.9)
где Sз=Zk·Lk — площадь затвора.
![]()
Сопротивление стока и истока, Ом:
![]() (2.10)
(2.10)
где ![]() — удельное сопротивление канала.
— удельное сопротивление канала.
![]()
На рисунке 2.1 построено семейство передаточных характеристик транзистора для значений напряжения между стоком и истоком 1, 2, 4 В.
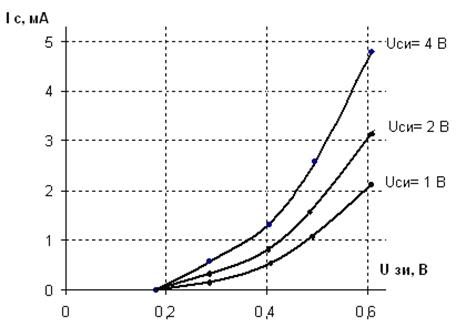
Рисунок 2.1 - Стоко-затворная характеристика полевого транзистора.
Семейство стоковых (выходных) характеристик МДП-транзистора с индуцированным каналом строим путём совмещения двух областей его ВАХ - триодной и области насыщения.
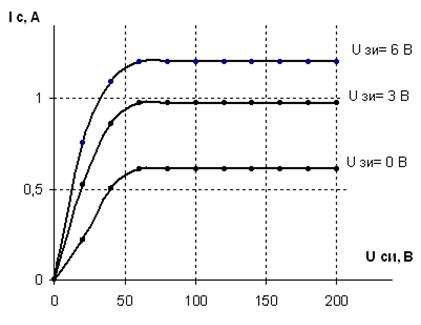
Рисунок 2.2 - Семействo выходных вольт-амперных характеристик полевого транзистора
ВЫВОДЫ
В ходе данной курсовой работе:
были рассмотрены свойства МДП-структури, а также типы и устройство полевых транзисторов;
рассмотрены характеристики МДП-транзистора;
определено влияние типа канала на вольт-амперные характеристики прибора;
рассмотрены основны свойства и параметры полупроводника арсенида галлия;
рассчитаны параметры и характеристики МДП-транзистора.
В результате расчетов параметров и характеристик полупроводниковых приборов были получены результаты, не противоречащие справочным данным.
Так же были получены значения основных параметров: пороговое напряжение ![]() , напряжение смыкания
, напряжение смыкания ![]() , сопротивление стока и истока rи=rс=42,07 Ом. В результате построений характеристик МДП-транзистора были получены типичные вольтамперные характеристики транзистора МДП-типа с индуцированным каналом n-типа.
, сопротивление стока и истока rи=rс=42,07 Ом. В результате построений характеристик МДП-транзистора были получены типичные вольтамперные характеристики транзистора МДП-типа с индуцированным каналом n-типа.
СПИСОК ЛИТЕРАТУРЫ
1. Ніконова З.А., Небеснюк О.Ю. Твердотіла електроніка. Конспект лекцій для студентів напрямку «Електроніка» ЗДІА/ Запоріжжя: Видавництво ЗДІА, 2002. - 99с.
2. Твердотіла електроніка. Навчальний посібник до курсового проекту для студентів ЗДІА спеціальності «Фізична та біомедична електроніка» денної та заочної форм навчання /Укл: З.А. Ніконова, О.Ю. Небеснюк,, М.О. Літвіненко, Г.А. Слюсаревська. Запоріжжя, 2005. - 40с.
3. Батушев В. А. Электронные приборы. – М. , “Высшая школа” 1980..
4. Гусев В.Г., Гусев Ю.М. Электроника – М.: Высшая школа, 1991г. - 617с.
5. Гуртов В. А. Твердотельная электроника: Учеб. пособие // В. А. Гуртов; ПетрГУ. – Петрозаводск, 2004. - 312 с.
6. Городецкий Л. Ф. Полупроводниковые приборы // Л. Ф. Городецкий,А. Ф. Кравченко, М.: Высшая школа, 1967, - 348 с.
7. Епифанов Г.И. Физические основы микроэлектроники М.: Сов. радио, 1971 г. - 376 с.
8. Ефимов И. Е., Козырь И. Я., Горбунов Ю. И. Микроэлектроника. М.: Высшая школа, 1987г. - 326 с.
9. Ефимов И.Е., Козырь И.Я. Основы микроэлектроники. - 2-е изд., перераб. и доп. - М.: Высшая школа, 1983г. - 384 с.
10. Жеребцов И.П. Основы электроники. - Энергоатомиздат, Ленинградское отд-ние, 1989г. - 352 с.
11. Зи С. Физика полупроводниковых приборов: Пер. с англ. М.: Мир, 1984. - 368 с.
12. Полупроводниковые приборы: транзисторы. Справочник. Под ред. Н. Н. Горюнова - М.: Энергоатомиздат, 1985г. - 204 с.
13. Пасынков В. В., Чиркин Л. К. Полупроводниковые приборы. М.: Высшая школа, 1987г. - 479 c.
14. Степаненко И.П. Основы микроэлектроники. - М.: Сов. радио, 1980г. - 424 с.
15. Тугов Н.М., Глебов Б.А., Чарыков Н.А. Полупроводниковые приборы. - М.: Энергоатомиздат, 1990г. - 376 с.
16. Федотов Я. А. Основы физики полупроводниковых приборов. М., “Советское радио”, 1970г. - 392 с.
17. Электроника: Энциклопедический словарь.//Гл. ред. В. Г. Колесников. М.: Советская энциклопедия, 1991. - 688 с.
Похожие работы
... . По этой причине все основные разновидности логических МДП-элементов статического, квазистатического и динамического действия строятся на одноканальных МДП-транзисторах n-типа. Основные принципы построения логических схем статического действия на МДП-транзисторах одной структуры во много соответствуют принципам построения транзисторных логических схем с непосредственными связями (DCTL). Так, для ...
... новые виды реализуемых функций, которые позволяют построить экономичные схемы триггеров, сумматоров, дешифраторов и других цифровых устройств. Особенности логических элементов, реализуемых в составе БИС Рис. 5. Логический элемент НЕ, И-НЕ на КМДП с ВБ: а) схема элемента 4И-НЕ; 6) функциональное обозначение Рис. 6. Логический элемент на КМДП с ВБ: а) ...
... более что на высоких частотах они мало заметны. Радикальное снижение искажений в области этих частот возможно при использовании в выходном каскаде комплементарных пар МДП-транзисторов. 5. Моделирование схемы в пакете Multisim 8 5.1 Подбор элементной базы и проверка работоспособности Для моделирования схемы необходимо подобрать аналоги отечественным компонентам схемы (транзисторы, диоды, ...
... потенциал затвора, поэтому изменяется ток в цепи исток-сток. Рисунок 2.6 - Структура (а) и эквивалентная схема (б) МДП-транзистора с фотодиодом на основе p-n перехода. МДП-фототранзисторы являются удобными фоточувствительными элементами для создания многоэлементных фотоприемников [2]. 2.5 Гетерофототранзисторы Гетерофототранзисторы (рис. 3.4) основаны на принципе действия обычного ...











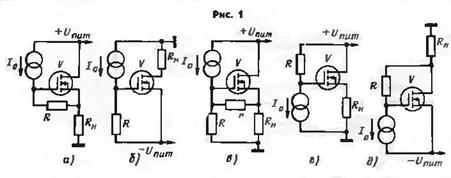







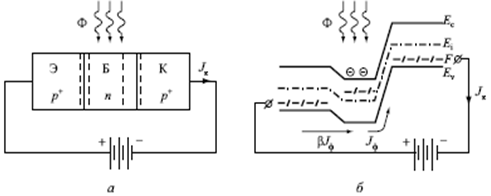
0 комментариев