Навигация
Разработка физической структуры кристалла и технологического маршлута изготовления ИМС
4. Разработка физической структуры кристалла и технологического маршлута изготовления ИМС
Схема электрическая принципиальная разработана на основе биполярных транзисторов, поэтому примем структуру кристалла изготовляемую по стандартной эпитаксиально - плонарной биполярной техпологии.
Для уменьшения площади кристалла ИМС в структуре предусмотреим двустороннюю разделительную диффузию. Для создания конденсаторов на основе МДП структуры необходимо предусмотреть наличие слоя Si3N4 под металической обкладкой.
Учитывая тот факт что разрабатаваемая ИМС – АМ-ЧМ приемник, следовательно транзисторы используемые в схеме должны работать на высоких частотах. Для работы транзистора на высоких частотах он должен иметь тонкую активную базу, для чего необходимо уменьшить глубину ее залегания. Уменьшение же глубины залегания базовой области достигается только снижением уровня лигирования.
В связи с тем, что базовая область будет иметь низкий уровень лигирования, необходимо предусмотреть область p-типа проводимости, которая обеспечит хороший контакт к базовой области. Для создания этой дополнительной области не будем вводить новых технологических операций, а используем разделительную диффузию.
При разработке физической структуры также необходимо учитывать что изготавливаться данная ИМС будет на предприятии ОАО “Микрон”. Поэтому будем придерживаться тех параметров структуры которые наиболее отработана на предприятии и хорошо конролируются.
Изобразим структуру кристалла разработанную с учетом вышеперечисленных особенностей. Так как самым сложным элементом структуры является n-p-n – транзистор, то приведем именно его структуру. (рисунок 4.1).
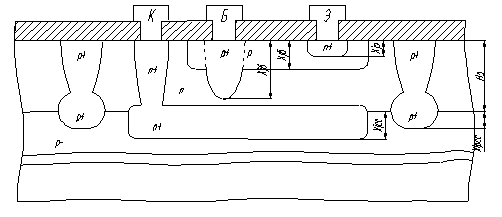
HЭ – толщина эпитаксиального слоя;
XjБ – глубина залегания базовой области;
XjБ1 – глубина залегания глубокой базы;
XjЭ – глубина залегания базовой области;
XjСС – глубина залегания скрытого слоя;
XjРСС – глубина залегания скрытого р-слоя.
Рисунок 4.1 – Физическая структура ИМС.
В состав ИМС входят следующие элементы:
а) NPN - транзисторы;
б) PNP - транзисторы горизонтальные;
в) резисторы на активной базе;
г) МДП емкость.
Используя данные обо всех элементах используемых в схеме ИМС и слоях необходимых для создания данных элементов, разработаем технологический маршрут изготовления ИМС.
Технологический маршрут
0. Исходный материал КДБ 10 (111)
1. Окисление
2. ОПФЛ “Метки”
3. 1ПФЛ “N+скр. слой”
4. ЖХТ +снятие Ф/Р.
5. Травление микрорельефа.
6. Диффузия сурьмы 1,2 стадии.
7. Окисление 0.27 мкм.
8. ПФЛ “Р+скр. слой”
9. И.Л. бора+отжиг.
10. Эпитаксия 4мкм.
11. Окисление 0.27 мкм.
12. ПФЛ “Метки-2”.
13. ПХТ меток.
14. Травление SiO2.
15. Окисление 0.27 мкм.
16. ПФЛ “N+емкость”.
17. Диффузия глубокого коллектора.
18. Окисление 0.3 мкм.
19. ПФЛ пассивная база.
20. И.Л. пассивная база.
21. Отжиг пассивной базы.
22. П.Ф.Л. “Активная база”.
23. И.Л. Активная база.
24. Отжиг базы 1.
25. П.Ф.Л. “Жесткая маска Si3N4.
26. П.Х.Т. Ж.М. SiO2 до Si.
27. Отжиг базы 2.
28. П.Ф.Л.”Технологический эмиттер”.
29. И.Л. фосфора 50/800.
30. Отжиг эмиттера.
31. Осаждение Si3N4.
32. П.Ф.Л.”Контактные окна”.
33. П.Х.Т.”Контактные окна”.
34. Подгонка Вст., контроль Вст.
35. Напыление Al-Si; 0,45мкм.
36. П.Ф.Л. “Ме-1” + Ж.Х.Т
37. Осаждение И.Д.
38. П.Ф.Л. И.Д.+П.Х.Т. И.Д.
39. Напыление “Ме-2” - Al-Si 1,4мкм.
40. П.Ф.Л. “Ме-2”+Ж.Х.Т. “Ме-2”.
41. Осаждение пассивации.
42. П.Ф.Л. пассивации + П.Х.Т.
43. Вжигание +контроль В.А.Х.2
Параметры физической структуры разрабатываемой ИМС приведены в таблице 4.1.
Таблица 4.1 - Параметры физической структуры
| Слой | № литографии | Область структуры | Параметр | Единица измерения | Значение | ||
| Mин. | Тип. | Мaк. | |||||
| Н1 | p- подложка <111> | rv | Ом´см | – | 10 | – | |
| Н2 | 1 | n+ СС | Rs | Ом/кв. | 15 | 20 | 25 |
| Xj | мкм | 4.0 | 5.0 | 6.0 | |||
| Н3 | 6 | Р+ База | Rs* | Ом/кв. | 30 | – | 50 |
| Xj | мкм | 2 | – | 3 | |||
| H4 | Эпитаксия | Толщина Hэ | мкм | 3.5 | 4.0 | 4.5 | |
| rv | Ом´см | 0.85 | 1.0 | 1.15 | |||
| H5 | 2 | Глубокий коллектор | Rs | Ом/кв. | 12 | – | – |
| Xj | мкм | 4.0 | 4.5 | 5.0 | |||
| Н6 | 6 | Р+ База | Rs* | Ом/кв. | 200 | 220 | 240 |
| Xj | мкм | 2 | – | 3 | |||
| Н7 | 7 | База | Rs | Ом/кв. | 660 | 700 | 760 |
| Xj | мкм | 0.7 | – | 1.2 | |||
| H8 | 11 | Эмиттер | Rs | Ом/кв | 12 | 15 | 18 |
| Xj | мкм | 0.35 | 0.4 | 0.45 | |||
| Н9 | SiO2 : | ||||||
| N пленкой | D SiO2 | мкм | – | 0.3 | – | ||
| Базовыми обл. | D SiO2 | мкм | – | 0.3 | – | ||
| Эмиттерными обл. | D SiO2 | мкм | – | 0.3 | – | ||
| Н10 | Si3N4 | D Si3N4 | A | 240 | – | 290 | |
| H11 | 12 | Металл 1 AL+Si | D Me1 | мкм | 0,45 | – | – |
| H12 | 13 | Изолирующий диэлектрик | D SiO2 | мкм | 1 | – | – |
| H13 | 14 | Металл 2 Al+Si | D Me2 | мкм | – | 1.4 | – |
| H14 | 15 | Пассивация | D SiO2 | мкм | – | 1 | – |
Электрические параметры элементов ИМС для разработанной физической структуры, изготовленной по вышеуказанному технологическому маршруту приведены в таблице 4.2.
Таблица 4.2 - Электрические параметры элементов
| Элементы | Параметры | Нижний предел | Типовое | Верхний предел |
| NPN транзистор | Коэффициент усиления Iк=10мкA | 100 | 150 | 200 |
| Напряжение пробоя К-Э Iк=100 мкA | 10 В | – | 20 | |
| Напряжение пробоя Э-Б Iэ=10мкA | 6.2 В | 6.5 В | 6.8 В | |
| Прямое напряжение Э-Б Iэ=50мкA | 0.67 В | 0.69 В | 0.71 В | |
| Напряжение пробоя К-Б Iк=10 мкA | 30 В | – | 40 | |
| Напряжение пробоя К-П I=10 мкA | 30 В | – | – | |
| PNP транзистор | Коэффициент усиления Iк=100мкAUкэ=5В | 30 | – | – |
| Напряжение пробоя К-Э Iк=10мкA | 15 В | – | – | |
| Резисторы на базе | Поверхностное сопротивление | 700Ом/кв | 760Ом/кв | 820Ом/кв |
Конструктивно-топологические ограничения (вариант ПФЛ).
N+скрытый слой.
Минимальная ширина - 5.0 мкм.
Глубокий коллектор.
Минимальный размер - 2.5мкм.
Разделение.
Минимальная ширина - 4.0 мкм;
минимальное расстояние до N+СС - 6.0 мкм;
минимальное расстояние до гл. коллектора - 4.0 мкм.
Р+база.
Минимальная размер - 2.0 мкм;
минимальное расстояние (в том числе база PNP) - 3.5 мкм;
минимальное расстояние до разделения - 4,0 мкм;
минимальное расстояние до гл. коллектора - 4.0 мкм.
База.
Минимальный размер - 6.0 мкм;
минимальное расстояние - 4.0 мкм;
минимальное расстояние до разделения - 4.0 мкм;
минимальное расстояние до гл. коллектора - 4.0 мкм.
Эмиттер.
Минимальный размер - 3.0 мкм;
минимальное расстояние - 2.0 мкм;
минимальное расстояние до базы - 1.5 мкм;
минимальное расстояние от Р+ базы до эмиттера - 1.5 мкм.
Емкость.
Минимальный размер - 5.0 мкм;
минимальное расстояние емкость – эмиттер - 1.0 мкм.
Контактные окна.
Минимальный размер - 2.0 мкм;
минимальное расстояние до базы, резисторов - 1.0 мкм;
минимальное расстояние до эмиттера - 0.5 мкм;
минимальное расстояние до коллектора - 0.0 мкм.
Металл 1.
Минимальная ширина - 3.0 мкм;
минимальное расстояние - 2.8 мкм;
минимальное перекрытие контактных окон - 1.0 мкм.
Изолирующий диэлектрик (ИД).
Минимальный размер окон в ИД - 3.0 мкм;
минимальное расстояние металл 1- окно в ИД - 1.0 мкм.
Металл 2.
Минимальная ширина - 5.0 мкм;
минимальное расстояние - 5.0 мкм;
минимальное перекрытие контактных окон ИД - 2.0 мкм.
Пассивация.
Размер контактной площадки по металлу 1 - 94´94 мкм;
расстояние от края окна в пассивации до металла КП - 10 мкм;
расстояние между контактными площадками - 40 мкм.
0 комментариев