Навигация
4.3.1. Термообработка.
Сущность термообработки состоит в нагреве пластины или подложки до температуры, при которой происходят удаление адсорбированных поверхностью загрязнений, разложение поверхностных загрязнений и испарение летучих соединений.
Отжиг осуществляют в вакуумных или термических установках непосредственно перед проведением основных операций формирования полупроводниковых или пленочных структур.
Эффективность очистки зависит от температуры, максимальное значение которой ограничено температурой плавления очищаемых материалов и процессами диффузии примесей.
4.3.2. Газовое травление.
Сущность газового травления заключается в химическом взаимодействии материала пластин с газообразными веществами и образовании при этом легко улетучиваемых соединений. В процессе газового травления загрязнения удаляются вместе со стравливаемым приповерхностным слоем пластин.
Газовое травление как метод окончательной очистки применяют в первую очередь непосредственно перед теми технологическими процессами, в которых определяющую роль играет структура поверхностного слоя (например, перед эпитаксиальным наращиванием). В качестве травителей используют смеси водорода или гелия с галогенами (фтор, хлор, бром), галогеноводородами (HBr, HC1), сероводородом![]() , гексафторидом серы.
, гексафторидом серы.
Молярное содержание этих веществ в водороде или гелии может изменяться от десятых долей процента до единиц процентов. Очистку осуществляют при температурах 800-1300°С в установках термического окисления либо непосредственно в реакторах эпитаксиального наращивания.
Наибольшее распространение получило травление кремниевых пластин хлористым водородом при температурах 1150-1250°С, при этом происходит реакция:
![]() (9)
(9)
Скорость травления зависит от температуры и концентрации HC1 в водороде. Аналогично происходит травление кремния в HBr.
Травление кремниевых пластин в парах тетрахлорида кремния сопровождается реакцией
![]() (10)
(10)
При хлорном травлении в качестве газоносителя используют гелий. Травление осуществляют при температуре около 1000°С и содержании хлора в гелии не более 0,2% в соответствии с реакцией:
![]() (11)
(11)
Травление кремния в парах сероводорода происходит по реакции:
![]() (12)
(12)
![]()
При этом получаются большие скорости травления (до 15 мкм/мин). Однако сероводород токсичен. Гексафторид серы, наоборот, не токсичен и обеспечивает хорошее качество поверхности при травлении кремния и сапфира. Травление кремния сопровождается реакцией:
![]() (13)
(13)
Газовое травление обеспечивает получение более чистых поверхностей по сравнению с жидкостной, обработкой. Однако его применение ограничено из-за высоких температур процессов и необходимости использования газов особой чистоты.
4.3.3. Ионное травление.
Сущность ионного травления состоит в удалении поверхностных слоев материала при его бомбардировке потоком ионов инертных газов высокой энергии. При этом ускоренные ионы при столкновении с поверхностью пластин или подложек передают их атомам свою энергию и импульс.
* Ионное травление - процесс удаления загрязнений вместе с распыляемым в вакууме поверхностным слоем обрабатываемой поверхности при ее бомбардировке ускоренными ионами инертного газа.
Если во время столкновения энергия, передаваемая атому, превышает энергию химической связи атома в решетке, а импульс, сообщаемый атому, направлен наружу от поверхности, то происходит смещение атомов, их отрыв от поверхности - распыление. Для реализации этого процесса требуются определенные вакуумные условия, а ионы должны обладать определенными значениями энергий, достаточными для распыления материалов.
Разновидностью ионного травления является ионно-химическое (реактивное) травление, основанное на введении в плазму химически активного газа, обычно кислорода. При этом изменяется скорость травления вследствие химического взаимодействия между подложкой и добавленным газом.
4.3.4. Плазмохимическое травление.
В отличие от ионного плазмохимическое травление основано на разрушении обрабатываемого материала ионами активных газов, образующимися в плазме газового разряда и вступающими в химическую реакцию с атомами материала при бомбардировке поверхности пластин или подложек. При этом молекулы газа в разряде распадаются на реакционно-способные частицы - электроны, ионы и свободные радикалы, химически взаимодействующие с травящейся поверхностью. В результате химических реакций образуются летучие соединения.
Для травления кремния и его соединений (оксида и нитрида кремния) наиболее часто используют высокочастотную плазму тетрафторида углерода ![]() (возможно применение гексафторида серы
(возможно применение гексафторида серы ![]() и фреона-12 -
и фреона-12 - ![]() ).
).
При взаимодействии этих газов с электронами плазмы происходит разложение ![]() и образуются ионы фтора и другие радикалы:
и образуются ионы фтора и другие радикалы:
![]()
![]() (14)
(14)
![]()
Ионы фтора, а в ряде случаев и радикал ![]() активно взаимодействуют с кремнием, образуя летучее соединение
активно взаимодействуют с кремнием, образуя летучее соединение ![]() . Уравнения, характеризующие химические реакции травления кремния, оксида и нитрида кремния в плазме
. Уравнения, характеризующие химические реакции травления кремния, оксида и нитрида кремния в плазме ![]() , имеют вид
, имеют вид
 (15)
(15)
Характерно, что частицы, участвующие в травлении, травят различные материалы с разной скоростью. На этом основано свойство плазмохимического травления. Скорость травления определяется концентрацией атомов фтора и постоянной скорости химической реакции ![]() :
:
![]() (16)
(16)
Концентрация ![]() обусловливается скоростью генерации атомов, что определяется конструкцией и мощностью реактора, а также временем жизни частиц в реакторе, которое зависит от скорости газового потока, давления и условий рекомбинации частиц.
обусловливается скоростью генерации атомов, что определяется конструкцией и мощностью реактора, а также временем жизни частиц в реакторе, которое зависит от скорости газового потока, давления и условий рекомбинации частиц.
Скорость травления строго зависит от температуры; ее влияние предопределяется физическими свойствами травящегося материала и газовым составом плазмы. Так, добавка кислорода к чистой плазме ![]() повышает скорость травления.
повышает скорость травления.
В плазме фторсодержащих газов можно травить некоторые металлы. Для травления применяют также плазму хлорсодержащих газов. Для удаления органических материалов используют кислородную плазму.
Промышленные конструкции реакторов рассчитаны на групповую обработку пластин с кассетной загрузкой и программным управлением.
В отечественной промышленности для различных целей плазмохимической обработки кремниевых пластин используются автоматизированные реакторы «Плазма 600» (для удаления фоторезиста и очистки поверхности пластин при изготовлении биполярных ИМС) и «Плазма 600Т» (для удаления фоторезиста, очистки поверхности пластин и травления диэлектрических слоев). Плазмохимическое травление применяют также для локальной обработки поверхностей.
Способы сухой очистки пластин и локальной их обработки наиболее эффективны при создании БИС и СБИС на элементах с микронными и субмикронными размерами.
4.4. Типовые процессы очистки пластин и подложек.
Выбор способа очистки зависит от вида загрязнений. Эффективная очистка достигается при сочетании нескольких способов очистки. В качестве примера в таблице 2 приведены данные по использованию различных способов очистки в зависимости от вида загрязнений.
Таблица 2
Виды загрязнений и способы их удаления
| Виды загрязнений | Способы очистки |
| Физические включения (пылинки, пух, небольшие частицы полупроводника, металла, абразива) | Растворение и одновременное ультразвуковое перемешивание |
| Загрязнения ионами (остатки кислот, осадки, получаемые при электролитическом покрытии, ионы металлов) | Промывка в деиониэованной или дистиллированной воде до установления постоянного сопротивления. Промывка в кислотах для удаления адсорбированных ионов. Ионная очистка |
| Минеральные жиры и органические материалы | Ультразвуковая промывка в нагретом органическом растворителе. Кипячение в органическом растворителе. Ионная очистка |
| Сложные химические включения (полярный органический материал, окислы, сернистые соединения) | Травление кислотами. Промывка кремниевых пластин в метиловом спирте |
| Загрязнения парами | Ионная очистка. Вакуумный отжиг. Термическое травление. Обработка в кислотах |
Однако при изготовлении ИМС возможные виды загрязнений проявляются комплексно, а на различных стадиях изготовления к качеству чистоты поверхности предъявляются различные требования. Поэтому для качественной и эффективной очистки пластин и подложек разрабатывают типовые процессы очистки, представляющие собой комбинирование различных способов очистки, выполняемых в определенной последовательности. В составе таких процессов основными операциями являются обезжиривание, травление, промывка, сушка.
На протяжении всех этапов изготовления кристаллов полупроводниковых ИМС очистку полупроводниковых пластин проводят многократно - после механической обработки пластин и перед основными операциями формирования структур: окислением, эпитаксиальным наращиванием, диффузией, металлизацией, фотолитографией (и после нее), защитой.
5. Заключение.
В заключении своего реферата приведу пример типового процесса обработки пластин кремния перед термическим окислением, который включает следующие операции:
1) обезжиривание в горячем (75-80°С) перекисно-аммиачном растворе;
2) промывание в проточной деионизованной воде (удаление продуктов реакции предыдущей обработки);
3) обработка в горячей (90-100°С) концентрированной азотной кислоте (удаление ионов металлов);
4) промывание в проточной деионизованной воде (удаление остатков кислот);
5) гидродинамическая обработка пластин бельичими кистями в струе деионизованной воды;
6) сушка пластин с помощью центрифуги в струе очищенного сухого воздуха;
7) травление в растворе фтористоводородной кислоты (снятие поверхностного слоя и удаление загрязнений).
6. Список литературы.
1. Ефимов И.Е., Козырь И.Я., Горбунов Ю.И. Микроэлектроника. Учебное пособие для ВУЗов. М., "Высшая школа", 1986.
2. Зи Ф.М. Технология СБИС. М., "Мир", 1986.
Похожие работы
... - внутренняя и наружная шестерни, 4 - сепараторы , 5 - пластины По характеру воздействия абразива на полупроводниковые пластины различают шлифование свободным и связанным абразивом. В зависимости от зернистости используемого абразива, режимов обработки и качества полученной поверхности различают предварительное (черновое) и окончательное (чистовое) шлифование. Шлифование свободным абразивом ...
... от структуры силикатных стёкол, и способно выдерживать умеренные концентрации катионов (например, натрий до 0,1%), не увеличивая электропроводимость. Боратное стекло отвечает требованиям герметизации полупроводниковых приборов: свободно от щелочных металлов, уплотняется (спаивается) при температуре до 800С, относительно инертно и водонепроницаемо, имеет регулируемые коэффициенты температурного ...
... должно соблюдаться на протяжении всего процесса зонной плавки. Для того, чтобы допущение 3 оказалось состоятельным, требуется использовать при кристаллизационной очистке исходные материалы прошедшие предварительную очистку. 1.2 Расчет распределения примеси вдоль слитка кремния после зонной плавки (один проход расплавленной зоной) 1.2.1 Расчет распределения Si-Ga. Рассчитаем распределение галия ...
... слитка используют следующий маршрут: подготовка слитка и разделение его на пластины, предварительная, а затем окончательная обработка пластин. Подготовка и разрезание полупроводникового слитка на пластины Слитки калибруют (шлифуют) по диаметру в связи с тем, что после выращивания они могут иметь конусность и волнистость цилиндрической поверхности, а также отклонения диаметра превышающие ...


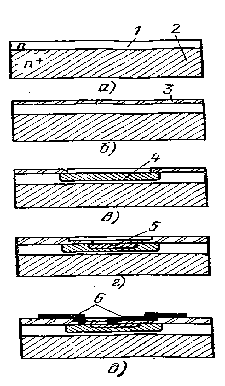
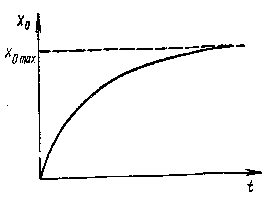



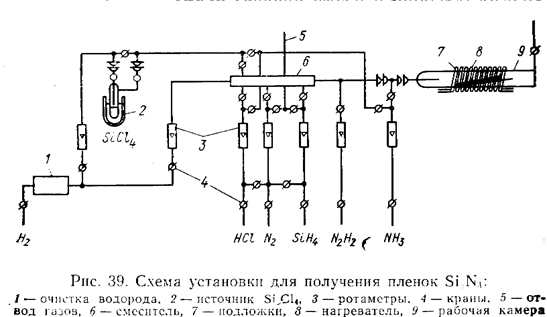
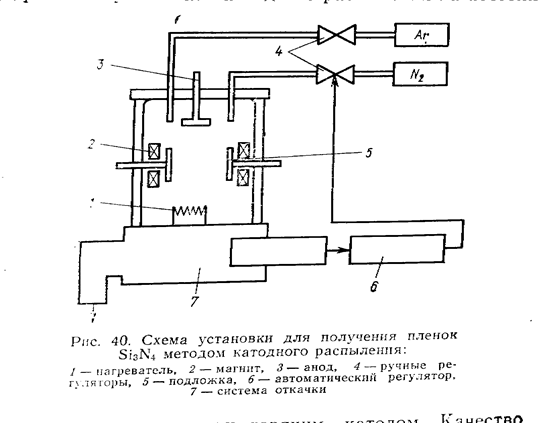

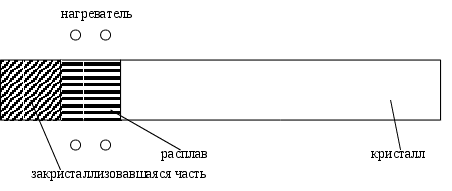









0 комментариев