Навигация
4 Заключение
В данной работе представлен обзор основных конструкций магнетронных систем распыления, некоторых конструктивных элементов (мишеней, магнитных систем и другое), описаны основные параметры установок и приведены типичные характеристики магнетронов. Так же рассмотрены сравнительные характеристики различных конструкций магнетронных систем распыления, их достоинства и недостатки. На примере планарной конструкции магнетронной системы показаны типичные характеристики разряда: вольтамперные характеристики, зависимости мощности разряда и влияние на них магнитного поля и давления рабочего газа. Представлены характеристики материалов мишеней. Кроме того, описывается принцип работы магнетрона, поведение заряженных частиц в плазме разряда, а так же распределение магнитных и электрических полей.
В заключение отметим, что потенциальные возможности применения магнетронных распылительных систем в настоящее время еще далеко не полностью выяснены и реализованы. Но уже сейчас применение магнетронных установок весьма широко. Они заняли прочные позиции в технологиях изготовления полупроводниковых приборов и интегральных микросхем. В частности, применяются для формирования контактов к различным полупроводниковым и пассивным элементам схем. Это изготовление резистивных пленок гибридных микросхем, магнитных пленок, низкоомных контактов и многое другое.
Кроме того, они широко используются в промышленных установках для нанесения тонкопленочных покрытий. Это – всевозможные фильтрующие, отражающие, защитные и теплосберегающие оптические покрытия на стеклах.
Магнетронные системы нашли широкое применение в вопросах плазмохимической обработки, травления и получения материалов.
Несмотря на всю широту использования магнетронных систем распыления, нельзя утверждать то, что к настоящему моменту они являются достаточно хорошо изученными. Все большее практическое применение МРС значительно опередило разработку теории и методику их расчета.
5 Conclusion
The paper presents review of basic magnetron sputtering system constructions, some construction elements (targets, magnetic systems and so on), key parameters and typical magnetron characteristics are described as well. Besides, the dependences of the working space parameters on the magnetron discharge plasma are presented. Moreover, comparative characteristics of the different magnetron sputtering systems constructions and their advantages and limitations are described. For example, the critical discharge characteristics of the planar magnetron are given, such as volt-ampere and the power discharge characteristics and influence on those ones the magnetic field and process gas pressure values. The study also presents characteristics of material, the targets made. Then, there are described the magnetron operations, behavior of the species in discharge plasma, magnetic and electric fields distributions.
In conclusion it is necessary to point out, that potential possibilities of the magnetron sputtering system applications have not been studied quite sufficiently. But by now the magnetron sputtering system usage is already prevailing. Those ones are widely used in the manufacturing of semi-conductor devices and integrated circuits. In particular, those systems are engaged for the interconnection formatting to the semi-conductor and passive elements of the circuits, the hybrid microcircuit resistive films producing, magnetic films, low-resistance contacts and so on.
Moreover the magnetron sputtering systems are widely used in commercial plants for thin film deposition, namely for various color filtering, reflective, protective and low-emission optical glass coatings.
Magnetron systems have found their application for solving the problems regarding to the plasmochemistry processing, etching and producing the materials.
Though magnetron system is widely used, at present, one cannot say that, they are studied sufficiently. The wide propagation of the magnetron sputtering system passed ahead of theoretical background of the problem.
Список использованных источников
1 Francis F. Chen. Industrial applications of low – temperatures plasma physics. Phys. Plasmas vol. 2, n. 6, June 1995, pp. 2164 – 2175.
2 N. Singh, R. Kist, H. Thiemann. Experimental and numerical studies on potential distributions in a plasma. Pl. Phys., vol. 22, 1980, pp. 695 – 707.
3 Плазменные ускорители/Под общей редакцией Л. А Арцимовича. – М.: Машиностроение, 1973.
4 Данилин Б. С., Неволин В. К., Сырчин В. К. Исследование магнетронных систем ионного распыления материалов. – Электронная техника. Сер. Микроэлектронника, 1977, вып. 3 (69), с. 37 – 44.
5 Данилин Б. С., Сырчин В. К. Магнетронные распылительные системы. – М.: Радио и связь, 1982.
6 L. Vriens. Energy balance in low – pressure gas discharges. J. Appl. Phys. vol. 44, n. 9, September 1973, pp. 3980 – 3989.
7 J. –P. Boeuf. A two – dimensional model of dc glow discharges. J. Appl. Phys. vol. 63, n. 5, March 1998, pp. 1342 – 1349.
8 S. Maniv. Generalization of the model for I – V characteristics of dc sputtering discharges. J. Appl. Phys. vol. 59, n. 1, January 1986, pp. 66 – 70.
9 W. D. Westwood, S. Maniv. The current – voltage characteristic of magnetron sputtering systems. J. Appl. Phys. vol. 54, n. 12, December 1983, pp. 6841 – 6846.
10 F. A. S. Ligthart, R. A. J. Keijser. Two – electron group model and electron energy balance in low - pressure gas discharges. J. Appl. Phys. vol. 51, n. 10, October 1980, pp. 5295 – 5299.
11 A. Fiala, L. C. Pitchford, J. P. Boeuf. Two – dimensional, hybrid model of low – pressure glow discharges. Phys. Review. ser. E, vol. 49, n. 6, June 1994, pp. 5607 – 5622.
12 K. Kuwahara, H. Fujiyama. Application of the Child – Langmuir Law to Magnetron Discharge Plasmas. IEEE Trans. Plasma. Sci., vol. 22, n. 4, August 1994, pp. 442 – 448.
13 T. E. Sheridan, M. J. Goeckner, J. Goree. Electron distribution Functions in a sputtering Magnetron Disharge. Jap. J. Appl. Phys., vol. 34, P. 1, n. 9A, September 1995, pp. 4977 – 4982.
14 Tsutomu Muira, Tatsuo Asamaki. A theory on planar magnetron discharge. Thin Solid Films 281–282, 1995, pp. – 190 – 193.
15 F. A. Green, B. N. Chapman. Electron effects in magnetron sputtering. J. Vac. Sci. Technol., vol. 13, n. 1, January/February 1976. pp. 165–168.
16 J. G. Kirk, D. J. Galloway. The evolution of a test particle distribution in a strongly magnetized plasma. Pl. Phys., vol. 24. n. 4, 1982, pp. 339 – 359.
17 N. D’ Angelo, M. J. Alport. On “anomalously” high ion temperatures in plasma discharges. Pl. Phys., vol. 24. n. 10, 1982, pp. 1291 – 1293.
18 M. Katsch, K. Wiesmann. Relaxation of supratermal electrons due to coulomb collisions in a plasma. Pl. Phys., vol. 22, 1980, pp. 627 – 638.
Приложение А (справочное)
Рабочие и энергетические характеристики распылительных систем
| Вид распылительной системы | Рабочее давление, Па | Рабочее напряжение, кВ | Энергия ионов, Wi1,610-16 Дж | Ионный ток Ii, А | Мощность, подводимая к системе c, кВт | Коэф. преобразования мощности =IiUi/c | Энергетическая эффективность (по меди) | |
| распыления, 10-9 кг/Дж | системы, 10-9 кг/Дж | |||||||
| Диодная на постоянном токе | 1,3 - 13 | 3,0 – 5,0 | 2,0 – 3,5 | 0,5 – 0,8 | 2,0 – 5,0 | 0,5 – 0,6 | 0,9 – 1,4 | 0,5 – 0,7 |
| ВЧ диодная | 0,6 – 6,6 | 1,0 – 2,0 | 0,7 – 1,5 | 1,0 – 2,0 | 3,5 – 5,0 | 0,3 – 0,6 | 1,6 – 2,5 | 0,5 –1,0 |
| Триодная | 0,06 – 0,66 | 1,0 – 2,0 | 1,0 – 2,0 | 3,0 – 5,0 | 10 –15 | 0,3 – 0,7 | 1,4 – 2,1 | 0,6 – 1,0 |
| Триодная с локализацией плазмы магнитным полем | 0,013 – – 0,13 | 1,0 – 2,0 | 1,0 – 2,0 | 10 – 15 | 35 – 40 | 0,3 – 0,7 | 1,4 – 2,1 | 0,6 – 1,0 |
| С автономным ионным источником | 0,0013 – – 0,013 | 1,0 – 3,0 | 1,0 – 3,0 | 0,2 – 0,5 | 8,0 – 10 | 0,03 – 0,15 | 1,0 – 2,1 | 0,06 – 0,15 |
| Магнетронная на постоянном токе | 0,13 – 0,66 | 0,4 – 0,8 | 0,3 – 0,5 | 15 – 20 | 8 –15 | 0,6 – 0,7 | 3,0 – 3,8 | 2,1 – 2,3 |
| ВЧ магнетронная | 0,13 – 0,66 | 0,7 – 1,0 | 0,5 – 0,7 | 2,0 – 4,0 | 3,0 – 5,0 | 0,3 – 0,6 | 2,5 – 3,0 | 0,9 – 1,5 |
Министерство образования Российской Федерации
Томский Политехнический Университет
кафедра английского языка
и технического перевода
Магнетронные распылительные системы
выполнил: В.В. Жуков,
аспирант, НИИ ЯФ, Лаб. 23.
Научный руководитель: В.П. Кривобоков,
профессор, заведующий Лаб. 23, НИИ ЯФ.
Томск 2001 год.
1 ВведениеЦелью настоящей работы является обзор конструктивных элементов магнетронных распылительных систем (МРС), а также рассмотрение принципа их действия и физических параметров.
Дело в том, что еще сравнительно недавно основным методом нанесения тонкопленочных покрытий были испарение и конденсация вещества в высоком вакууме. Методы ионного распыления материалов в следствие низких скоростей осаждения и высоких радиационных воздействий на обрабатываемые структуры использовались ограниченно. Появившиеся сравнительно недавно магнетронные распылительные системы, позволяющие наносить как тонкопленочные, так и пленочные покрытия в сотни микрон, позволили существенно расширить область применения ионного распыления материалов.
В последние годы в нашей стране и за рубежом проведены научные исследования и конструкторско-технологические разработки по созданию широкого класса МРС, а также установок и линий (в том числе непрерывного действия). Подобного рода установки нашли применение во многих областях науки и техники. А целесообразность и эффективность их использования доказана значительно возросшим интересом к разработке и внедрению все новых более совершенных систем.
В настоящей работе на основе литературных источников сделан обзор конструкций магнетронных распылительных систем, их составных частей, кратко рассмотрены основные параметры и физические принципы работы.
Содержание1 Введение
2 Принцип действия и рабочие параметры МРС
3 Конструкции магнетронных распылительных систем
4 Заключение5 Conclusion
Список использованных источников
Приложение А - Рабочие и энергетические характеристики распылительных системПохожие работы
... загрязнению формируемого конденсата. Третье (дополнительное) требование подбора материала испарителя обусловлено, прежде всего, технологическими соображениями – конструкцией токовых вводов и зажимов вакуумной установки. КОНСТРУКЦИИ ПРЯМОНАКАЛЬНЫХ ИСПРАРИТЕЛЕЙ. Простейшие испарители изготавливают в виде проволочной спирали, многожильных жгутов, корзиночек, плоской ленты с углублениями, ...
... покрытий. - Покрытия характеризуются высокой адгезией, так как распыленные атомы имеют достаточно высокую скорость и степень ионизации. - Высокая автоматизация процесса. - Устройства для нанесения покрытий методом распыления, как правило, и не содержат сложные системы подачи вещества в зону генерации газовой фазы. Недостатки методов распыления следующие: 1.Низкая скорость осаждения покрытий ...
... технологий показана возможность создания гибких производственных робототехнических комплексов. Даны примеры типовой компоновки гибких технологических робототехнических комплексов для электрофизической обработки, включающих подготовительные технологические операции. Роботизированные установки для напыления тонкослойных покрытий на поверхность листового материала Установки представляют собой ...
... классификация многослойных покрытий, наносимых на инструментальный материал, приведена в табл.4. Таблица 4 Классификация многослойных покрытий для режущего инструмента. Многослойные Одноэлементные Многоэлементные Многокомпонентные Композиционные На основе Соединения одного Тугоплавкого металла Пример: ...





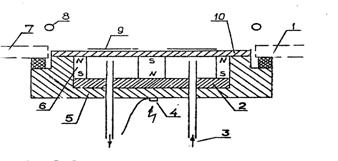


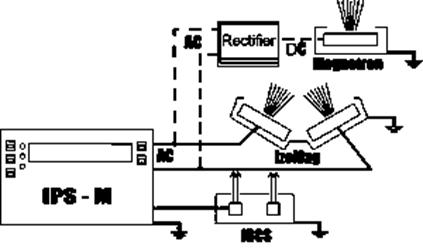





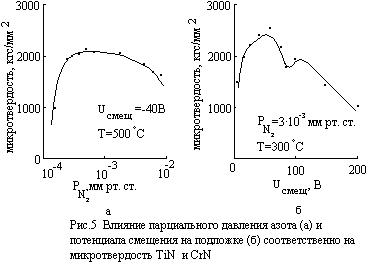
0 комментариев