Навигация
Легирование объемных кристаллов из жидкой фазы
2. Легирование объемных кристаллов из жидкой фазы
Рассмотрим особенности легирования кристаллов в процессе их выращивания из жидкой фазы. Широко применяемым методом получения легированных монокристаллов полупроводников является выращивание их из расплава, к которому добавлена нужная примесь.
Общие принципы такого легирования заключаются в следующем. Навеска примеси pi, подлежащая введению в расплав или жидкую зону для получения в твердом кристалле концентрации Ni, рассчитывается по формуле, определяющей коэффициент разделения примеси.
K0 = CS/CL = NiMiVL/NApi,
pi = NiMiVL/K0NA, (1)
где Mi — атомный вес примесного элемента, NA — число Авогадро, VL — объем расплава.
При выборе примесей для легирования необходимо учитывать величину коэффициента разделения и ее изменение при изменении условий выращивания. Эти факторы являются чрезвычайно важными для получения монокристаллов с равномерным распределением примесей из-за принципиальной однократности процесса легирования и невозможности исправления ошибок в дозировании примеси.
Пусть, для определенности, K0 < 1. Тогда если скорость роста кристалла V больше, чем скорость выравнивания состава в жидкой фазе, то из-за оттеснения примеси из твердой фазы в жидкую и замедленности диффузионных процессов установления равновесия в жидкой фазе концентрация примеси в расплаве у границы раздела будет возрастать.
Накопление избытка примеси приведет к образованию перед движущимся фронтом кристаллизации диффузионного слоя δ, из которого примесь путем диффузии переходит в объем расплава. Если K0 > 1, то вблизи поверхности роста ощущается недостаток примеси. Таким образом, от равновесного коэффициента разделения K0 мы переходим к эффективному K и учитываем влияние условий выращивания на процессы легирования:
K(f,D, δ) = K0/[K0 + (1 − K0) exp(−Vδ/D)], (2)
где D — коэффициент диффузии примеси в расплаве
В некоторых случаях, если характер перемешивания расплава задан, определение значения δ возможно аналитически. Так, если при получении легированных кристаллов методом Чохральского перемешивание расплава осуществляется вращением кристалла и тигля вокруг своих осей во встречных направлениях с угловыми скоростями ωк и ωт, то значение δ при невысоких скоростях роста V может быть определено по формуле
δ = AD1/3ν1/6(ωк + ωт)−1/2, (3)
где A — постоянная, принимающая значение от 1.3 до 1.6, а ν — кинематическая вязкость расплава.
Зависимость K от V показана на рис.1 для двух скоростей вращения и трех значений равновесного коэффициента разделения K0. Видно, что только при скоростях V < 4 · 10−3 см/с можно говорить о совпадении K и K0. Из рисунка также видно, сколь важно вращение расплава и (или) кристалла для выравнивания концентрации примеси в расплаве.
Особенно это важно в условиях зонной плавки: без перемешивания расплава δ может достигать размеров зоны. При δ = 1 см K и K0 становятся сопоставимы по величине только при V < 10−4 см/с. Именно поэтому скорости выращивания кристаллов в методе зонной плавки значительно меньше, чем при вытягивании кристалла из расплава.
При выборе примеси чрезвычайно важным является учет ее чистоты, так как попадание в растущий кристалл вместе с легирующей примесью неконтролируемых сопутствующих примесей даже в очень малых количествах может приводить к существенному ухудшению параметров выращиваемых кристаллов (например, существенно снижать время жизни неосновных носителей заряда). Поэтому перед легированием оценивают требуемую чистоту легирующего элемента с учетом особенностей используемого метода легирования и допустимого содержания в легируемом кристалле посторонних примесей.

Рис. 1. Зависимость K от скорости кристаллизации V при разных скоростях вращения расплава и кристалла.
3. Методы выравнивания состава вдоль кристалла
Из рассмотренного материала можно сделать вывод, что существует несколько факторов, вызывающих появление неоднородностей состава в растущем кристалле. Неоднородности по причинам их возникновения можно разделить на две группы: сегрегационные и технологические.
Сегрегационные (или как их часто называют фундаментальные) связаны с закономерными изменениями состава растущего кристалла, обусловленными основными законами фазовых превращений в многокомпонентных системах. Эти закономерные неоднородности охватывают весь объем выращенного кристалла.
Технологические неоднородности имеют незакономерный характер. Они связаны с нарушениями стабильности условий роста кристаллов и охватывают небольшие объемы кристалла. Ясно, что технологические неоднородности могут быть устранены усовершенствованиями технологической аппаратуры для выращивания монокристаллов полупроводников и подбором оптимальных условий роста. Подобные способы уже рассматривались в предыдущей главе. В тоже время сегрегационные неоднородности таким путем устранены быть не могут. Для борьбы с ними необходимо разрабатывать специальные методы.
Методы выравнивания сегрегационных неоднородностей состава кристалла делятся на две группы: пассивные и активные методы. В первом случае монокристаллы с заданной однородностью распределения примеси получают без внесения каких-либо изменений в кристаллизационный процесс, то есть используются части кристалла с приблизительно равномерным распределением примеси. Под активными методами подразумеваются такие, которые позволяют активно влиять на ход процесса легирования во время роста, то есть по существу, позволяют программировать процесс изменения состава.
Эффективность метода выравнивания состава оценивают величиной, называемой выходом процесса или выходом годного материала. Выходом принято называть отношение части количества вещества с необходимыми для дальнейшего использования свойствами к общему его количеству, подвергнутому технологической обработке. В литературе также часто используется такое понятие, как теоретический выход годного материала. Имея аналитическое выражение для распределения состава в кристалле, выращиваемом каким-либо методом, можно рассчитать значение теоретического выхода для этого процесса. Поскольку теоретический расчет учитывает только сегрегационные неоднородности состава, то значение теоретического выхода будет характеризовать максимальный предел, выше которого нельзя увеличить реальный выход годного материала.
Похожие работы
... иначе использующих и развивающих основные идеи и модели, заложенные в программе SUPREM II. Основное внимание в этих программах уделялось моделированию процессов ионного легирования, диффузии, окисления и эпитаксии, ответственных за распределение примесей в полупроводниковых структурах, как правило, в одномерном приближении. Стремительный прогресс в кремниевой технологии в последние 5 – 10 лет ...
... нейтральных атомах примеси. При наличии только этого механизма рассеяния подвижность не зависит от температуры, а определяется только концентрацией примеси. Использовались источники [1, 2].2. Полупроводниковые материалы Si и Ge 2.1 Основные сведения о кристаллическом строении Германий(Ge) и кремний(Si) – элементы 4-й группы периодической системы элементов – образуют кристаллы по правилу ...
... по миру. Если в 1900 г. в год получали около 8 тысяч тонн легкого металла, то через сто лет объем его производства достиг 24 миллионов тонн. 2. Металлические проводниковые и полупроводниковые материалы, магнитные материалы 2.1 Классификация электротехнических материалов Электротехнические материалы представляют собой совокупность проводниковых, электроизоляционных, магнитных и ...
... установкой и откачивают выделяющиеся во время расплавления материала газы и летучие соединения. Откачка длится от нескольких минут до нескольких часов в зависимости от времени плавки. Высокую степень чистоты полупроводниковых материалов получают возгонкой или сублимацией. Этот метод основан на способности некоторых твёрдых веществ переходить в парообразное состояние, минуя жидкую фазу, а затем в ...
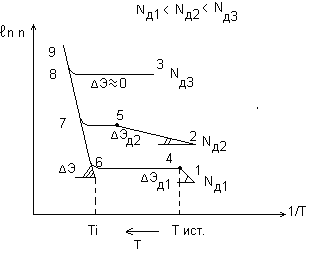
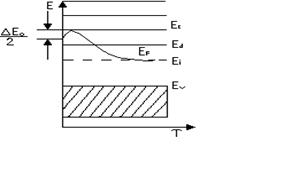
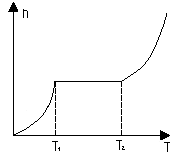



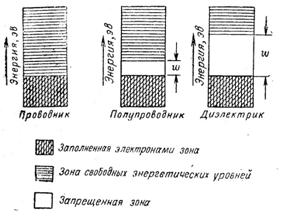
0 комментариев