Навигация
Расчет инжекции не основных носителей тока
2.2.6 Расчет инжекции не основных носителей тока
В основе работы полупроводниковых светоизлучающих диодов лежит ряд физических явлений, важнейшие из них: инжекция не основных носителей в активную область структуры электронно-дырочным гомо- или гетеропереходом; излучательная рекомбинация инжектированных носителей в активной области структуры.
Явление инжекции не основных носителей служит основным механизмом введения неравновесных носителей в активную область структуры светоизлучающих диодов (эти приборы часто называют инжекционными источниками света). Вопросы физики протекания инжекционного тока в р-n-переходах рассмотрены в работах Шокли и многих монографиях. В обобщенном виде инжекция носителей р-п-переходом может быть представлена следующим образом (рисунок 2.5).
Когда в полупроводнике создается р-n-переход, то носители в его окрестностях распределяются таким образом, чтобы выровнять уровень Ферми. В области контакта слоев p- и n-типов электроны с доноров переходят на ближайшие акцепторы и образуется дипольный слой, состоящий из ионизованных положительных доноров на n-сторон и ионизованных отрицательных акцепторов на р-стороне. Электрическое поле дипольного слоя создает потенциальный барьер, препятствующий дальнейшей диффузии электрических зарядов [5].
При подаче на р-n-переход электрического смещения в прямом направлении U потенциальный барьер понижается, вследствие чего в р-область войдет добавочное количество электронов, а в n-область - дырок. Такое диффузионное введение не основных носителей называется инжекцией.
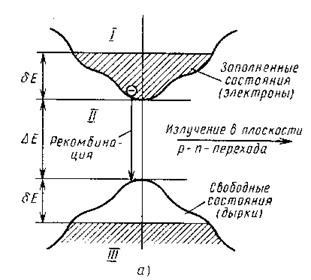

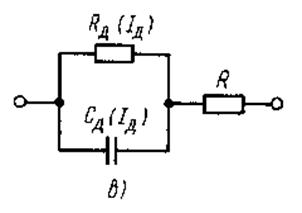
І- зона проводимости; ІІ –запрещённая зона; ІІІ – валентная зона
Рисунок 2.5 - Энергетическая диаграмма, поясняющая механизм действия инжекционного светодиода (а); его яркостная характеристика (б) и эквивалентная схема.
Концентрация инжектированных электронов на границе р-n-перехода и р-области n'(хp) определяется выражением:
п'(Хр)=np·exp(еU/kT), (2.7)
где nр-концентрация равновесных электронов в р-области;
k-константа Больцмана;
Т-температура;
e-заряд электрона.
Концентрация инжектированных носителей зависит только от равновесной концентрации не основных носителей и приложенного напряжения.
Поскольку инжектированные носители рекомбинируют с основными носителями соответствующей области, то их концентрация п'р в зависимости от расстояния от р-n-перехода изменяется следующим образом (для электронов в р-области):
n'p=n(xp)exp[-(x-xp)/Ln], (2.8)
где Ln- Диффузионная длина электронов.
Как следует из формулы (2.8) концентрация избыточных носителей экспоненциально спадает по мере удаления от р-n-перехода и на расстоянии Ln (Lр) уменьшается в e раз, где e » 2,72 (основание натурального логарифма).
Диффузионный ток In, обусловленный рекомбинацией инжектированных электронов, описывается выражением:
In=eDnnp[exp(eU/kT)-1]/Ln (2.9)
где Dn - коэффициент диффузии электронов. Диффузионный ток дырок In описывается аналогичным выражением. В случае, когда существенны оба компонента тока (электронный и дырочный), общий ток I описывается формулой:
I = (In0 + Iр0)·[exp(eU/kT) - 1], (2.10)
где
In0 = eDn·np/Ln; Ip0=eDp*pn/Lp. (2.11)
Особенность решения вопросов инжекции при конструировании светоизлучающих диодов, в которых, как правило, одна из областей p-n-структуры оптически активна, т.е. обладает высоким внутренним квантовым выходом излучения, заключается в том, что для получения эффективной электролюминесценции вся инжекция неосновных носителей должна направляться в эту активную область, а инжекция в противоположную сторону-подавляться [4].
Если активна область р-типа, то необходимо, чтобы электронная составляющая диффузионного тока преобладала над дырочной, а интенсивность рекомбинации в области объемного заряда была низка. Коэффициент инжекции gп , т.е. отношение электронной компоненты тока In0 к полному прямому току I=In0+Ip0, определяется по формуле:
gn=LpNd/[LpNd+(Dp/Dn)·LnNa], (2.12)
где Nd и Na - концентрации доноров и акцепторов в л- и р -областях.
Из выражения (2.6) следует, что для получения величины gп, близкой к 1, необходимо, чтобы Nd>>Na, Lp>Ln, Dn>Dp. Решающую роль, безусловно, имеет обеспечение соотношения Nd>>Na. Однако повышение концентрации носителей в инжектирующей области имеет свои пределы. Как правило, значения Nd (или Na) не должны превышать (1-5)·I019 см-3, так как при более высоком уровне легирования возрастает концентрация дефектов в материале, что приводит к увеличению доли туннельного тока и ухудшению, тем самым, инжектирующих свойств р-n-перехода [2]. Как будет видно из дальнейшего изложения, для повышения внутреннего квантового выхода излучательной рекомбинации в прямозонных полупроводниках необходимо повышать концентрацию носителей и в активной области, в связи с чем возникают дополнительные трудности с обеспечением одностороннего характера инжекции. Таким образом, в гомопереходах существуют трудности по обеспечению высокого коэффициента инжекции носителей в активную область, обусловленные противоречивыми требованиями к легированию p- и n-областей структуры для достижения высокого коэффициента инжекции и максимального квантового выхода электролюминесценции в активной области. В некоторых полупроводниках высокий коэффициент инжекции носителей в одну из областей р-n-перехода может быть обеспечен разницей в подвижности электронов и дырок. Так, в GaAs и других прямозонных соединениях высокий коэффициент инжекции электронов в р-область может быть осуществлен за счет более высокой подвижности электронов.
2.2.7 Расчёт светодиодного резистораСветодиод должен иметь резистор последовательно соединенный в его цепи, для ограничения тока, проходящего через светодиод, иначе он выйдет из строя практически мгновенно.
Резистор R определяется по формуле :
R = (V S - V L) / I
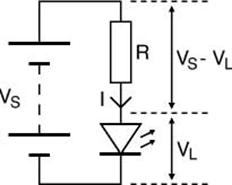
Рисунок 2.6 - Схема подключения .
V S = напряжение питания
V L= прямое напряжение, расчётное для каждого типа диодов (как правило от 2 до 4 волт)
I = ток светодиода (например 20мA), это должно быть меньше максимально допустимого для выбраного диода
Например: Если напряжение питания V S = 9 В, и есть красный светодиод (V = 2V), требующие I = 20мA = 0.020A,
R = ( 9 В) / 0.02A = 350 Ом.
Вычисление светодиодного резистора с использованием Закон Ома
Закон Ома гласит, что сопротивление резистора R = V / I, где :
V = напряжение через резистор (V = S - V L в данном случае)
I = ток через резистор
Итак R = (V S - V L) / I =(9В-3,6В)/0,02А=270Ом.
ВЫВОДЫ
В ходе данной курсовой работы:
были рассмотрены свойства светоизлучающих диодов, а также их типы, устройство, светоизлучающий кристалл и полупроводниковые материалы, используемые в производстве ;
были произведены расчеты некоторых параметров светодиода, а именно рассчитана эффективность светодиода, инжекции не основных носителей и нагрузочного резистора.
В ходе данных расчетов было установлено, что эффективность бывает, как приблизительная, так и уточнённая (E1=4.78 лм/Вт и E2=6.5 лм/вт). Был рассмотрен теоретический расчет инжекции не основных носителей в светодиодах и приведён пример расчёта светодиодного резистора (R=270 Ом).
Данные расчеты необходимы при проектировании, выборе и применение в какой либо цепи, светодиода.
СПИСОК ЛИТЕРАТУРЫ
1. В. И. Иванов, А. И. Аксенов, А. М. Юшин “Полупроводниковые оптоэлектронные приборы. / Справочник.”- М.: Энергоатомиздат, 1984 г..
2. Коган Л.М. Дохман С.А. Технико-экономические вопросы применения светодиодов в качестве индикации и подсветки в системе отображения информации. – Светотехника, 1990 – 289с.
3. Коган Л.М. Полупроводниковые светоизлучающие диоды, М.1989г. – 415 с.
4. Воробьев В.Л., Гришин В.Н. Двухпереходные GaP-светодиоды с управляемым цветом свечения. – Электронная техника. 1977 г. – 368 с.
5. Федотов Я.А. Основы физики полупроводниковых приборов.М.: Советское радио 1969г. – 294 с.
6. Амосов В.И. Изергин А.П. Диодные источники красного излучения на GaP, полученном методом Чахральского. 1972г. – 183 с.
7. Нососв Ю.Р. Оптоэлектроника. Физические основы, приборы и устройства. М. 1978г. – 265 с.
8. Мадьяри Б. Элементы оптоэлектроники и фотоэлектрической автоматики. М. 1979г. – 315 с.
9. Ефимов И.Е., Горбунов Ю.И., Козырь И.Я. Микроэлектроника. Проектирование, виды микросхем, функциональная электроника. – М.: Высшая школа, 1987. – 416 с.
10. Ефимов И.Е., Козырь И.Я. Основы микроэлектроники. – 2-е изд., перераб. и доп. – М.: Высшая школа, 1983. – 384 с.
11. Степаненко И.П. Основы микроэлектроники. – М.: Сов. радио, 1980. – 424 с.
12. Полупроводниковые приборы: транзисторы. Справочник. Под ред. Н. Н. Горюнова – М.: Энергоатомиздат, 1985г. – 904 с.
13. Ю П. Основы физики полупроводников /П. Ю, М. Кардона. Пер. с англ. И.И. Решиной. Под ред. Б.П. Захарчени. 3-е изд. М.: Физматлит, 2002. 560 с.
14. Федотов Я. А. Основы физики полупроводниковых приборов. М., “Советское радио”, 1970. – 392 с.
15. Тейлор П. Расчет и проектирвание тиристоров: Пер с англ. – М.: Энергоатомиздат, 1990. 208с.
16. Гершунский Б.С. Основы электроники и микроэлектроники: Учебник. – 4-е изд., К.: Вища школа,1983 г . –384 с.
Похожие работы
... в любительских и улучшенных промышленных радиоприёмниках автотрансформаторы широкого распространения не получили. В основном они нашли применение в дешевых массовых промышленных приемниках, а также в качестве устройств для поддержания необходимого напряжения при питании радиоприемников от осветительной сети, напряжение которой подвержено колебаниям. В данном устройстве представлен трансформатор ...
... измениться в е раз из-за рекомбинации. Для диода с тонкой базой при низкой частоте постоянная времени равна (1.6) 2. РАСЧЕТ и исследование мощных низкочастотных диодов на основе кремния 2.1 Расчет параметров диода Проведем расчет и исследования статических и динамических характеристик 4H-SiC p+-п0-n+ диодов, рассчитанных на обратное напряжение 6, 10 и 20 кВ и ...
... , что собственное быстродействие транзистора обратно пропорционально квадрату длины инверсионного канала. Поэтому для повышения быстродействия необходимо переходить на субмикронные длины канала. 2 РАСЧЕТ ПАРАМЕТРОВ И ХАРАКТЕРИСТИК МДП-ТРАНЗИСТОРА НА ОСНОВЕ АРСЕНИДА ГАЛЛИЯ 2.1 Основные сведения об арсениде галлия Арсени́д га́ллия (GaAs) — химическое соединение галлия и мышьяка. ...
... 0 0 0 0 11-12 Разработка электрической схемы пульта проверки 4 5 100 50 12-13 Выбор вариантов конструкции 5 6 100 50 13-14 Расчет параметров конструкции 2 3 70 50 14-15 Разработка печатной платы пульта проверки 7 8 200 180 15-16 Объединение конструкции и платы 7 9 200 150 16-17 Выполнение графической части 8 9 210 170 17-18 Подготовка основной ...
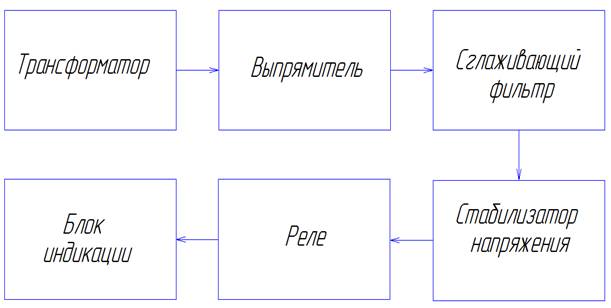

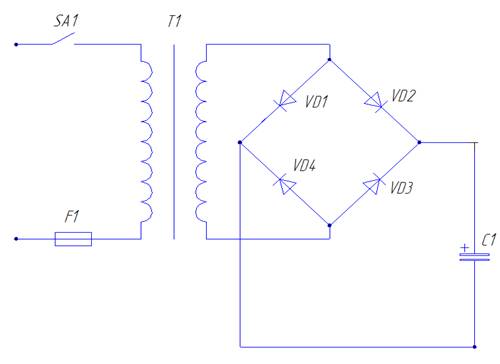
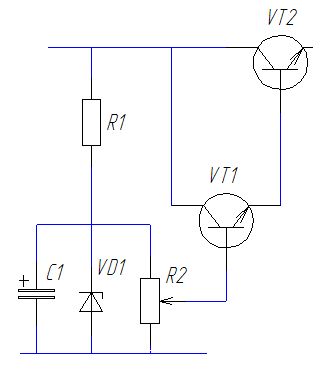
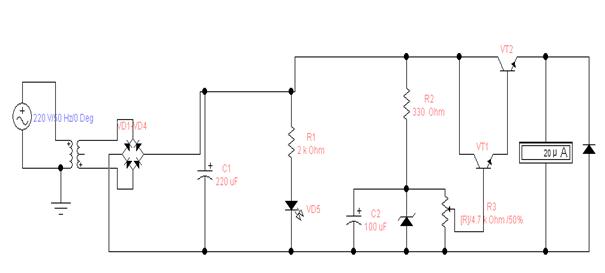
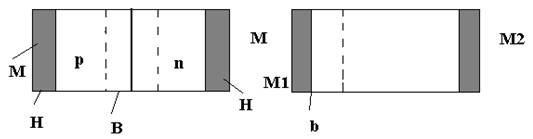


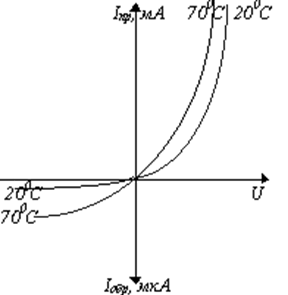
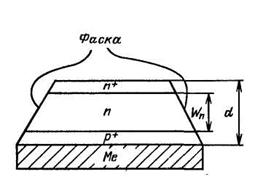
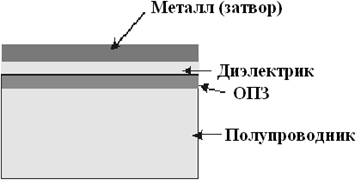


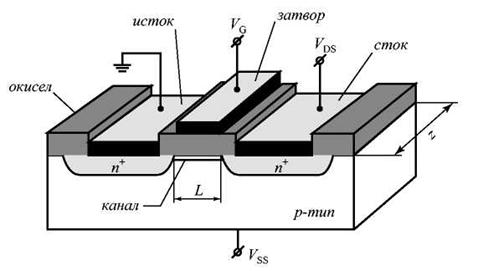
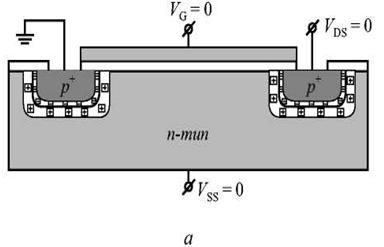
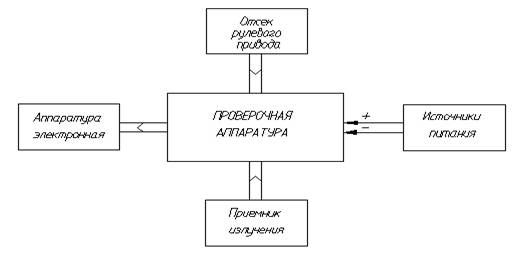
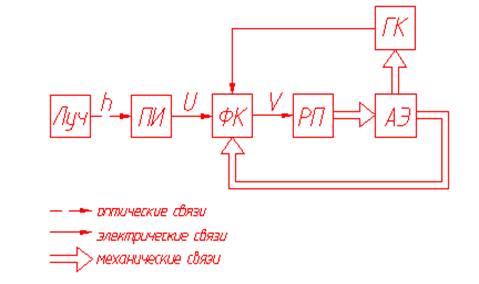



0 комментариев