Навигация
РАСЧЕТ и исследование мощных низкочастотных диодов на основе кремния
2. РАСЧЕТ и исследование мощных низкочастотных диодов на основе кремния
2.1 Расчет параметров диода
Проведем расчет и исследования статических и динамических характеристик 4H-SiC p+-п0-n+ диодов, рассчитанных на обратное напряжение 6, 10 и 20 кВ и обозначаемых далее как 6-кВ, 10-кВ и 20-кВ диоды. Концентрация примесей в сильно легированных эмиттерных областях составляет ~ 1019 см−3, уровень легирования и толщина базы n-типа определяются максимальным блокируемым напряжением (см. табл. 1).
Таблица 1 - Параметры структуры 6-кВ, 10-кВ и 20-кВ 4H-SiC р+-n0-п+ диодов
| Концентрация доноров в базе, см−3 | Толщина базы, мкм | |
| 6-кВ | 1·1015 | 50 |
| 10-кВ | 3·1014 | 150 |
| 20-кВ | 3·1014 | 200 |
В 4H-SiC диодах при малых плотностях тока основную роль играют генерация и рекомбинация носителей в области пространственного заряда (ОПЗ) р-n-перехода и их диффузионный перенос через базу. В диодах практически отсутствуют "избыточные" токи, связанные с различного рода неоднородностями структуры и обусловленные, например, механизмами полевого и термополевого туннелирования. На рис. 2.1 в качестве примера показаны прямые вольтамперные характеристики (ВАХ) 6-кВ диода, измеренные при температурах 297 и 537 K в диапазоне плотностей прямого тока jпр= 10−7−1 А/см2. В указанном интервале плотностей тока ВАХ хорошо аппроксимируются суммой рекомбинационного (jрек) и диффузионного (jдиф) токов с учетом омического падения напряжения на базе диода jпрrб, где rб - сопротивление базы):
jпр = jрек + jдиф = jобр exp(qVpn/2kT) + jкб exp(qVpn/kT) (2.1)
V = Vpn + jпрrб.
Обратный ток в исследованных 4H-SiC диодах при комнатной температуре настолько мал, что находится за пределами чувствительности измерительной аппаратуры.
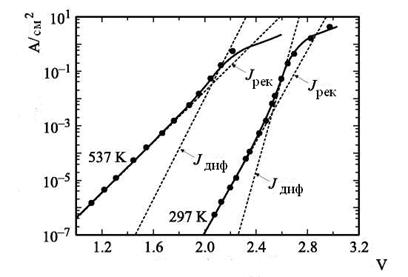
Рисунок 2.1 - Прямые ВАХ 6-кВ диода при низких плотностях тока. Т = 297K: jобр = 2.3 ∙ 10−24 А/см2, jкб = 1.5 ∙ 10−45 А/см2, rб = 7.4∙10−2 Ом∙см2, T = 537K: jобр = 1 · 10-11 А/см2, jэб = 3∙ 10−21 А/см2, rб = 1.7 · 10-1 Ом ∙ см2.
Заметный обратный ток появляется лишь при температурах свыше 600 K. На рис. 2.2 показана обратная
ВАХ 6-кВ диода, измеренная при температуре 685 K. Как видно из этого рисунка, jк ∞ (Vбэ + V)1/2 (Vбэ — контактная разность потенциалов р—n-перехода). Таким образом, обратный ток обусловлен термической генерацией носителей в ОПЗ р—n-перехода.
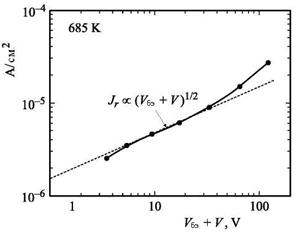
Рисунок 2.2 - Обратная ВАХ 6-кВ диода при Т = 685 K.
2.3 Модуляция базы при высоких уровнях инжекцииНа рис. 2.3 показаны импульсные квазистатические ВАХ 6-кВ, 10-кВ и 20-кВ диодов, измеренные при средних и высоких плотностях прямого тока. Как нетрудно убедиться, в 6-кВ и 10-кВ диодах реализуется достаточно глубокая модуляция базы инжектированными носителями. Так, например, при плотности прямого тока 180 А/см2 дифференциальное сопротивление 10-кВ диода rб = dV/djпр = 1.6 ∙ 10−2 Ом ∙ см2, в то время как омическое сопротивление нeмодулированной базы rб = W/qμпnо = 0.39 Ом ∙ см2 (μп = 800см2/Вс, n0 = 3 ∙ 1014см−3), т.е. в 24 раза больше измеренного дифференциального сопротивления.
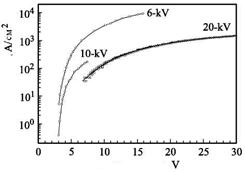
Рис. 2.3 - Импульсные квазистатические прямые ВАХ 6-кВ, 10-кВ и 20-кВ диодов. Т = 293 K.
Для 6-кВ диода омическое сопротивление немодулированной базы rб = 6.5 ∙ 10−2Ом ∙ см2 в 16 раз больше, чем rб = 4.1 ∙ 10−3 Ом ∙ cм2. Такая ситуация свидетельствует о достаточно больших величинах коэффициента инжекции эмиттера и времени жизни ННЗ в базе диодов.
С целью определения времени жизни ННЗ изучались переходные процессы в диодах: установление прямого падения напряжения при пропускании ступеньки прямого тока, спад послеинжекционной эдс после обрыва тока, восстановление блокирующей способности диодов после их переключения из проводящего состояния в блокирующее [16].
2.4 Время жизни ННЗ: включение диодов и спад послеинжекционной эдсНа рис. 2.4 показана осциллограмма напряжения на 6-кВ диоде при пропускании прямого тока, быстро нарастающего от нуля до 5 A. Реакция диода на ступеньку тока имеет „индуктивный" характер, что свидетельствует о накоплении в базе высокой концентрации ННЗ. На зависимости V(t) вначале наблюдается всплеск напряжения, амплитуда которого определяется сопротивлением немодулированной базы, а затем, по мере накопления ННЗ в базе напряжение падает до стационарного значения, определяемого сопротивлением модулированной базы. Время установления стационарного состояния (по порядку величины оно сравнимо с временем жизни ННЗ [12]) составляет около 0,6 мкс.
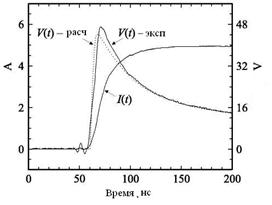
Рис. 2.4 - Осциллограммы тока и напряжения при включении 6-кВ диода.
Т = 293 K. Пунктиром показан результат расчета V(t)
На линейном участке скорость спада эдс (∆V/∆t) обратно пропорциональна времени жизни τ инжектированных в базу ННЗ [19]:
![]() (2.2)
(2.2)
где кТ — тепловая энергия. При комнатной температуре рассчитанная таким способом величина τ составляет 0,6 мкс для 6-кВ диода и 1,55 мкс для 10-кВ и 20-кВ диодов. Принимая подвижность дырок в базе μр = 117см2/В ∙ c, подвижность электронов μп= 880 см2/В ∙ c, получим, что амбиполярный коэффициент диффузии Da = 2(kT/q)[ μnμP/(μп + μр)] = 5,3см2/с. Амбиполярная диффузионная длина ННЗ в базе, La = (Daτ)1/2, составляет 17,9мкм для 6-кВ диода и 28,7 мкм для 10-кВ и 20-кВ диодов. Такие диффузионные длины действительно могут обеспечивать достаточно глубокую модуляцию базы в случае 6-кВ и 10-кВ диодов (отношение толщины базы к диффузионной длине ННЗ W/La = 2,8 и 5,2 соответственно). Однако для глубокой модуляции 200-мкм базы 20-кВ диода этого явно недостаточно (W/La = 7.0). Следует однако заметить, что с ростом температуры время жизни ННЗ во всех диодах возрастает в несколько раз, что приводит к уменьшению падения напряжения, несмотря на падение подвижности носителей тока.
2.4 Особенности переходных характеристик диодов с р-базойДоказано что в отличие от диодов с n-базой, которые демонстрируют довольно „мягкое" восстановление блокирующей способности, диоды с р-базой могут восстанавливаться довольно „жестко". При одних и тех же величинах прямого тока накачки и обратного напряжения максимальный обратный ток в диодах с р-базой существенно больше, и этот ток обрывается очень резко за время меньше одной наносекунды.
Расчетное время обрыва тока в диодах с р-базой оказалось равным 0,5 ± 0,05 нс, тогда как в диодах с n-базой минимальное время обрыва составляло 3 нс. Показано, что главным фактором, определяющим разный характер восстановления, является большая величина отношения подвижностей электронов и дырок в 4H-SiC, b = μn/μp.
Известно, что скорость „вытягивания" плазмы обратным током значительно выше из прианодной области, чем из прикатодной (в b2 раз до и в b раз после восстановления эмиттерных переходов [9]). В карбиде кремния (р = 7,5) этот процесс проявляется даже более ярко, чем в кремнии (b = 3), и доминирует во всех типах диодов независимо от асимметрии эффективности эмиттеров и вызванной ею начальной неоднородности распределения плазмы в высокоомной базе. В диоде с р-базой область, свободная от плазмы, возникает на аноде и, расширяясь со временем, достигает катода раньше, чем успевает восстановиться переход катодного эмиттера. В результате к моменту начала восстановления ОПЗ неравновесные носители практически полностью выносятся из базы обратным током. В этом случае граница восстанавливающейся ОПЗ будет перемещаться в отсутствие ННЗ, т.е. с насыщенной скоростью.
2.6 Расчет ВАХ при высоких плотностях прямого тока: влияние электронно-дырочного рассеяния
На рис. 2.5 показаны ВАХ 6-кВ диода, измеренные при температурах 293−553 K до плотностей тока j = 104 А/см2. Как видно, при достаточно больших плотностях тока имеет место „инверсия" температурной зависимости ВАХ. Точка инверсии приходится на область плотностей тока 2000−3000 А/см2, что более чем на порядок превышает плотность тока инверсии для аналогичных кремниевых структур. Для объяснения этого результата необходим анализ вклада различных нелинейных эффектов, определяющих вид ВАХ в области больших плотностей тока. К ним относятся эффекты, связанные с высоким уровнем легирования эмиттеров: сужение ширины запрещенной зоны, уменьшение подвижности основных носителей заряда, бимолекулярная и оже-рекомбинация. Кроме того, необходим учет взаимного рассеяния подвижных носителей друг на друге — электронно-дырочного рассеяния (ЭДР). Отметим, что эффекты, обусловленные ЭДР, оказываются чрезвычайно существенными в таких хорошо исследованных материалах, как Ge , Si и GaAs , так как сильно уменьшают подвижность носителей заряда в биполярных приборах при больших плотностях тока.
Для определения параметров ЭДР в 4H-SiC нами был предложен метод, основанный на анализе ВАХ диодных структур в области больших плотностей тока [2]. Составляющая падения напряжения на базе Veh, обусловленная ЭДР, обычно записывается в виде
 (2.3)
(2.3)
где μnp = Gp0/p — подвижность, обусловленная ЭДР. Анализ экспериментальных ВАХ диодов показал, что при Т = 293 K константа Gpo, определяющая подвижность μnp равна 5.8∙ 1019В−1см−1с−1, а величина qGp0, определяющая вклад ЭДР в ВАХ, — 9.3 Ом−1 см−1. Отметим, что найденные значения параметров ЭДР в SiC оказываются примерно в 2 раза меньшими, чем в Si, в 4 раза меньшими, чем в Ge, и в 60 раз меньшими, чем в GaAs. Это означает, что влияние ЭДР в SiC оказывается в соответствующее число раз более эффективным, чем в Si, Ge и GaAs.
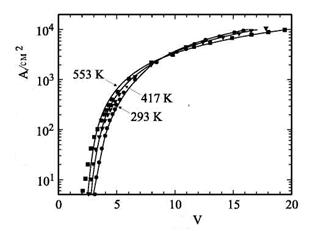
Рис. 2.5 - Прямые ВАХ 6-кВ диодов. Точки — эксперимент, сплошные линии — расчет с учетом ЭДР.
2.7 Методы производства диодовКремниевые диоды обычно изготовляются из кремния n-типа со сравнительно большим удельным сопротивлением. К пластинке кремния приваривают проволочку из вольфрама, покрытого алюминием. Алюминий является для кремния акцептором. Полученная область кремния р-типа работает в качестве эмиттера.
Диоды изготовляются главным образом методами сплавления (вплавления) или диффузии (рис. 2.6). В пластинку кремния n-типа вплавляют при температуре около 500 °С каплю алюминия, которая, сплавляясь с кремнием, образует слой кремния р-типа. Область с электропроводностью р-типа имеет более высокую концентрацию примеси, нежели основная пластинка сравнительно высокоомного кремния, и поэтому является эмиттером. К основной пластинке кремния и к алюминию припаивают выводные проволочки, обычно из никеля. Если за исходный материал взят высокоомный кремния р-типа, то в него вплавляют сурьму и тогда получается эмиттерная область n-типа.
Следует отметить, что сплавным методом получают так называемые резкие, или ступенчатые, n-р-nереходы, в которых толщина области изменения концентрации примесей значительно меньше толщины области объемных зарядов в переходе.
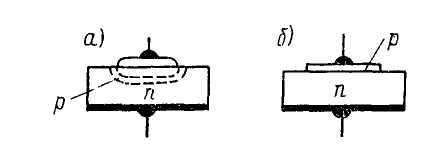
Рисунок 2.6. - Принцип устройства плоскостных кремниевых диодов, изготовленных сплавным (а) и диффузионным (б) методом
Диффузионный метод изготовления n-р-nерехода основан на том, что атомы примеси диффундируют в основной полупроводник. Примесное вещество при этом обычно находится в газообразном состоянии. Для того чтобы диффузия была интенсивной, основной полупроводник нагревают до более высокой температуры, чем при методе сплавления. Например, пластинку кремния n-типа нагревают до 900 °С и помещают в пары алюминия. Тогда на поверхности пластинки образуется слой кремния р-типа. Изменяя длительность диффузии, можно довольно точно получать слой нужной толщины. После охлаждения его удаляют путем травления со всех частей пластинки, кроме одной грани. Диффузионный слой играет роль эмиттера. От него и от основной пластинки делают выводы. При диффузионном методе атомы примеси проникают на относительно большую глубину в основной полупроводник, и поэтому n-р-nереход получается плавным, т. е. в нем толщина области изменения концентрации примеси сравнима с толщиной ООЗ.
ЗАКЛЮЧЕНИЕ
Расширилась область применения силовых электронных устройств в сфере бытовой электроники (регуляторы напряжения и др.).
Благодаря интенсивному развитию электроники, начиналось создание нового поколения изделий' силовой электроники. Базой для него явились разработка и освоение промышленностью новых типов силовых полупроводниковых приборов: запираемых тиристоров, биполярных транзисторов, МОN-транзисторов и др. Одновременно существенно повысились быстродействие полупроводниковых приборов, значения предельных параметров диодов и тиристоров, развились интегральные и гибридные технологии изготовления полупроводниковых приборов различных типов, начала широко внедряться микропроцессорная техника для управления и контроля преобразовательными устройствами.
Следует отметить, что использование полностью управляемых быстродействующих полупроводниковых приборов в традиционных схемах существенно расширяет их возможности в обеспечении новых режимов работы и, следовательно, новых функциональных свойств изделий силовой электронной техники.
ВЫВОДЫ
В данной курсовой работе:
- рассмотрена классификация полупроводниковых диодов;
- рассмотрен силовой полупроводниковый выпрямительный диод на основе кремния;
- рассчитаны параметры диода
- изучены методы производства мощных низкочастотных диодов
СПИСОК ЛИТЕРАТУРЫ
1. Управляемые полупроводниковые вентили: Пер. с англ./Ф. Джентри, Ф. Гутцвиллер, Н. Голоньяк, Э. фон Застров. М.: Мир, 1967. – 356 с.
2. Зи С. Физика полупроводниковых приборов: Пер. с англ. М.: Мир, 1984. - 368 с.
3. Евсеев Ю. А., Дерменжи П. Г. Силовые полупроводниковые приборы: Учебник для техникумов. М.: Энергоиздат, 1981. - 298 с.
4. Силовые полупроводниковые приборы/В. Е. Челноков, Ю. В. Жиляев, Н. А. Соболев и др. // Силовая преобразовательная техника (Итоги науки и техники). М.: ВИНИТИ, 1986. Т. 4. С. 1-108.
5. Моделирование и автоматизация проектирования силовых полупроводниковых приборов/В. П. Григоренко, П. Г. Дерменжи, В. А. Кузьмин, Т. Т. Мнацаканов. М.: Энергоатомиздат, 1988. - 315 с.
6. Расчет силовых полупроводниковых приборов/П. Г. Дерменжи, В. А. Кузьмин, Н. Н. Крюкова и др. М.: Энергия, 1980. - 242 с.
7. Блихер А. Физика тиристоров: Пер. с англ./Под ред. И. В. Грехова. Л.: Энергоатомиздат. Ленингр. отд-ние, 1981. - 315 с.
8. Бениш Ф. Отрицательные сопротивления в электронных схемах. М.: Сов. радио, 1975. - 196 с.
9. Челноков В. Е., Евсеев Ю. А. Физические основы работы силовых полупроводниковых приборов. М.: Энергия, 1973. - 298 с.
10. Ніконова З.А., Небеснюк О.Ю. Твердотіла електроніка. Конспект лекцій для студентів напрямку «Електроніка» ЗДІА/ Запоріжжя: Видавництво ЗДІА, 2002. – 99с.
11. Твердотіла електроніка. Навчальний посібник до курсового проекту для студентів ЗДІА спеціальності «Фізична та біомедична електроніка» денної та заочної форм навчання /Укл: З.А. Ніконова, О.Ю. Небеснюк,, М.О. Літвіненко, Г.А. Слюсаревська. Запоріжжя, 2005. – 40с.
12. Пасынков В. В., Чиркин Л. К., Шинков А. Д. Полупроводниковые приборы. – М.: Высшая школа, 1981. – 431 с.
13. Ефимов И.Е., Козырь И.Я. Основы микроэлектроники. – 2-е изд., перераб. и доп. – М.: Высшая школа, 1983г. – 384 с.
14. Тугов Н.М., Глебов Б.А., Чарыков Н.А. Полупроводниковые приборы. – М.: Энергоатомиздат, 1990г. – 376 с.
15. Жеребцов И.П. Основы электроники. – Энергоатомиздат, Ленинградское отд-ние, 1989г. – 352 с.
16. Батушев В. А. Электронные приборы. – М. , “Высшая школа” 1980. – 383 с.
Похожие работы
... IV ВАХ будет походить на обратную ветвь ВАХ обычного диода, а при достаточно большом напряжении возможен пробой одного из переходов. 2. РАСЧТ ПАРАМЕТРОВ И ПРОЕКТИРОВАНИЕ ТИРИСТОРА НА ОСНОВЕ КРЕМНИЯ: ДИНИСТОРА 2.1 Некоторые параметры динистора 1. Напряжение включения (Uвкл) – это такое напряжение, при котором тиристор переходит в открытое состояние (от 10 до 2500В).; 2. Прямое ...
... n-базе. А это требует специальных мер, в связи, с чем разумно ограничить расширение области объемного заряда в n-базу созданием сильнолегированного n+ - слоя. Расчет геометрических размеров слоев диффузионного выпрямительного элемента сравнительно легко можно провести, используя приближение экспоненциального перехода. Параметры аппроксимации λ и N0 и глубина залегания диффузионного перехода ...
... коэффициенты линейного расширения материалов подложек, корпусов и вспомогательных материалов должны быть согласованы для обеспечения работы микросхем при повышенных уровнях мощности. Конструирование СВЧ микросхем включает расчет и проектирование изделия по заданным электрическим параметрам с учетом процессов сборки и регулировки. При этом определяют вариант схемы узла, материал и геометрические ...
... – это законченный элемент ИМС, который можно использовать при проектировании аналоговых микросхем. 1 Общие принципы построения топологии биполярных Имс Общего подхода к проектированию биполярных интегральных микросхем нет и быть не может, каждый тип характеризуется своими особенностями в зависимости от требований и исходных данных ИМС. Исходными данными при конструировании микросхем являются: ...
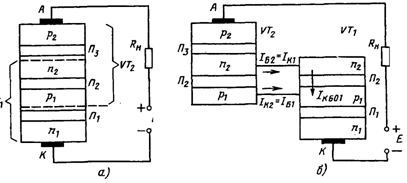
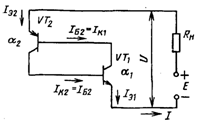
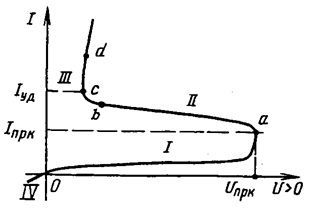



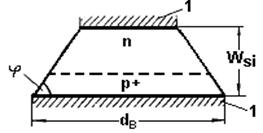
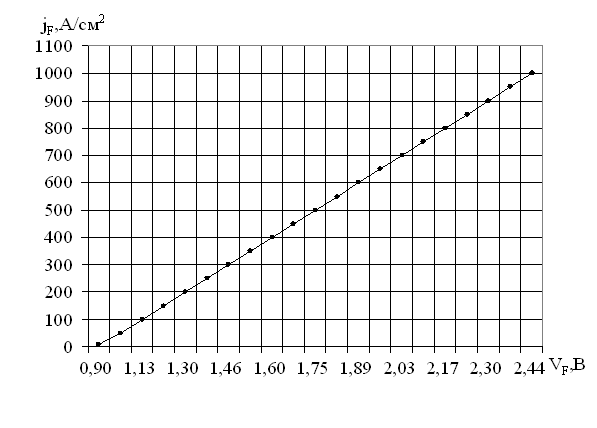




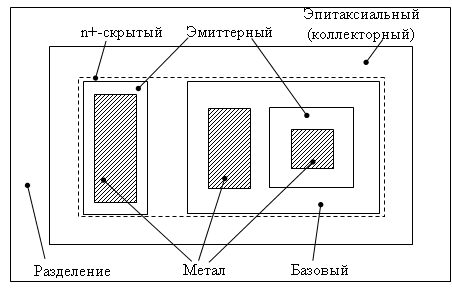


0 комментариев