Навигация
Элементы ЭСППЗУ, программируемые с помощью туннельного эффекта
2.1.1 Элементы ЭСППЗУ, программируемые с помощью туннельного эффекта
Ha рисунке 1 показана структура, а на рисунке 2 эквивалентная схема элемента памяти. Левая часть структуры образует бистабильный транзистор (1 — исток, 2 — сток, 3 — управляющий затвор, совмещенный с шиной программирования строки Хпрог, 4 — плавающий затвор). Слой диоксида 5, отделяющий сток 2 от затвора 4, имеет очень малую толщину — порядка 10 нм (туннельно-тонкий диоксид). При программировании на шину Хпрог выбранной строки подают высокое напряжение (20 В). Если на плавающий затвор надо ввести заряд (запрограммировать лог. 1), то на стоке следует установить нулевое напряжение. Тогда происходит туннелирование электронов из стока в слой 5 и их дрейф на плавающий затвор. Если же не надо вводить заряд, то на стоке устанавливают такое же напряжение, как и на управляющем затворе. Для стирания (удаления заряда) на управляющий затвор необходимо подать нулевое напряжение, а на сток — высокое. Тогда электроны совершают обратный переход с плавающего затвора в сток. Таким образом, программирование и стирание идут с одинаковой скоростью. Эти процессы отличаются только знаком напряженности электрического поля в слое 5 и направлением движения электронов.
Достоинством рассмотренного элемента является возможность стирания информации в произвольно выбранном элементе памяти за малое время (менее 1 мс). Максимальное число циклов перепрограммирования достигает 106 — больше, чем для элементов, использующих инжекцию горячих электронов. 0днако площадь элемента памяти в 3...4 раза больше, чем у элементов ПЗУ и составляет 30...40 литографических квадратов. Недостатком также является необходимость получения тонкого высококачественного диоксида, что сложно технологически и ухудшает надежность.
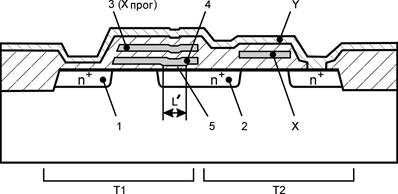
Рисунок 1

Рисунок 2
Толщина диоксида может быть увеличена в несколько раз, если использовать туннелирование с шероховатой поверхности поликремния. Структура элемента памяти содержит три слоя поликремния, взаимное расположение которых показано на рисунок 3 (области истока, стока и шины Х, Y для простоты не показаны). Источником электронов при программировании служит электрод 1 первого слоя поликремния, являющийся общей шиной (он соединяется с областью истока транзистора). Плавающий затвор 2 создают нанесением второго, а затвор управления 8 — третьего слоя поликремния. Толщина диоксида между слоями 1 и 2, 2 и 3 около 0,04 мкм. В такой структуре возможно только одностороннее туннелирование с электрода 1 вверх. Обратное туннелирование вниз невозможно, так как нижняя поверхность плавающего затвора гладкая, а напряженность электрического поля из-за большой толщины диэлектрика мала.
Для удаления электронов с плавающего затвора при стирании используют туннелирование вверх и дрейф электронов на управляющий затвор. В обоих режимах программирования и стирания на управляющий затвор (шину Хпрог )подают высокое напряжение 15...20 В. Чтобы при программировании не было перехода электронов с плавающего затвора на управляющий, а при стирании- с электрода 1 на плавающий затвор, между плавающим затвором и специальной управляющей шиной Упрог создают конденсатор связи Cсв. При программировании (рисунок 3) на Упрог подают положительное напряжение U0, дополнительно повышающее потенциал плавающего затвора. Разность потенциалов между ним и управляющим затвором получается малой, и туннелирование с плавающего затвора вверх отсутствует. При стирании (рисунок 4) на управляющей шине Упрог устанавливают нулевое напряжение, понижающее потенциал плавающего затвора. В результате разность потенциалов между затворами 3 и 2 получается высокой и идет интенсивное туннелирование электронов с затвора 2 вверх. В то же время разность потенциалов между электродами 2 и 1 мала и туннелирование с электрода 1 отсутствует.
Элемент памяти по сравнению с предыдущим характеризуется меньшей площадью (15…20 литографических квадратов), что позволяет создать СБИС с большей информационной емкостью (256 Кбит…1Мбит). Из-за гораздо больших токов туннелирования время программирования получается меньше (0,003 мс/байт).
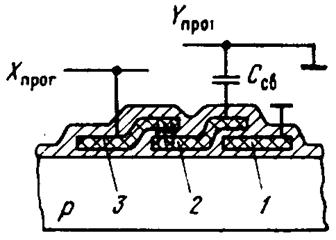
Рисунок 3
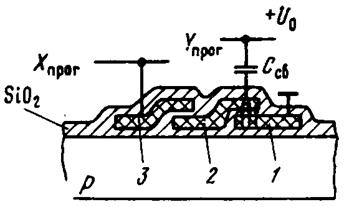
Рисунок 4
3. МОДЕЛИРОВАНИЕ ЯЧЕЙКИ ЭСППЗУ
В данной работе будет рассмотрен теоретический анализ и экспериментальные данные по программированию и стиранию ячейки памяти программируемой туннельным током.
Структура такой ячейки изображена на рисунке 5. Это n-канальный транзистор с плавающим затвором. Тонкий окисел (~100 ангстрем) между плавающим затвором и стоком способен пропускать электроны (туннелирование) инжектируемые и поглощаемые плавающим затвором во время операций записи/стирания согласно эффекту Фаулера-Нордхайма.
Во время записи плавающий затвор заряжается отрицательно электронами, туннелирующими из стоковой области через тонкий оксид. Это достигается за счет приложения положительного потенциала к верхнему (управляющему) затвору, в то время как сток и подложка заземлены. Накопившийся отрицательный заряд на плавающем затворе сдвигает пороговое напряжение транзистора на большую положительную величину. При последующем считывании транзистор будет закрыт.
Операция стирания заключается в снятии отрицательного заряда с плавающего затвора с помощью приложенного к стоку высоковольтного импульса, в то время как исток свободен (не подключен), а оба затвора и подложка заземлены. Величина порогового напряжения смещается в отрицательном направлении, и транзистор открывается при последующем чтении.
Во время считывания прикладывается достаточно низкое напряжение, поэтому туннельный ток незначительный и плавающий затвор практически изолирован. При таких условиях считывания заряд нужной величины (информация) может храниться до 10 лет.
В схемах памяти используется двухтранзисторная ячейка. Дополнительный транзистор вводится для изоляции ячейки от воздействия сигналов соседних ячеек во время циклов записи/стирания.
В данной работе рассматривается анализ и моделирование режимов записи/стирания, учитывая эффекты, которые возникают во время стирания.

Рисунок 5
0 комментариев