Навигация
Технология быстродействующих p-i-n- диодов
1.2 Технология быстродействующих p-i-n- диодов
1.2.1 Структура р-i-n- диода и требования к параметрам
полупроводникового материала [7,9,12,15,16]
Быстродействующие переключательные p-i-n- диоды представляют собой собранные в корпуса или держатели р-i-n структуры с тонкой (от 1 до 10 мкм) высокоомной ( r > 10 Ом*см) базовой i-областью n- или p-типа проводимости. Материалом базовой области обычно являются эпитаксиальные пленки кремния. В качестве низкоомных р- и n-областей используются низкоомные подложки кремния, тонкие эпитаксиальные, диффузионные или ионно-легированные слои. Площадь таких p-i-n- структур обычно составляет от 2*10-7 до 8*10-5 см2
Для минимизации вклада в tпр и tобр сопротивлений n- и p- областей толщину и удельное сопротивление последних стремятся делать минимальными. Кроме того, с уменьшением rn и rp уменьшается сопротивление контактов к этим областям.
При эпитаксии вследствие автолегирования и диффузии примеси из подложки на границе раздела между низкоомной и высокоомной областями пластины образуется переходной слой с переменной концентрацией примеси. Толщина его может быть сравнима с размерами базы диода. Аналогичный слой образуется при создании диффузионного или эпитаксиального переходов в высокоомной пленке.
Неполное обеднение этих слоев при обратном смещении приводит к увеличению обратного сопротивления потерь диодов. При прямом смещении из-за наличия переходных слоев уменьшаются коэффициенты инжекции переходов. Поэтому при создании диодных структур принимаются специальные меры к увеличению резкости переходов.
Для того, чтобы полное обеднение базовой области диода и переходных слоев было получено при небольшом напряжении обратного смещения, удельное сопротивление i -слоя должно быть максимально большим.
1.2.2 Методы создания p-i-n- структур
Эпитаксиальные пленки Si для быстродействующих переключательных диодов выращивают разложением SiCl4 [12], SiH4 [10],а также методом молекулярно-лучевой эпитаксии [16,9]. Выращивание обычно проводят на подложках n- типа проводимости с удельным сопротивлением 0,001- 0,003 Ом *см. При эпитаксии для уменьшения толщины переходного слоя между низкоомной подложкой и высокоомной пленкой принимают меры, снижающие эффект автолегирования. Для этой цели перед эпитаксиальным выращиванием обратную сторону подложки маскируют нелегированным материалом, а процесс эпитаксии проводят в два этапа. На первом этапе при высокой температуре выращивают тонкий (около 0,4 мкм) слой нелегированного Si [10], на втором при более низкой температуре этот слой доращивают до необходимой толщины. При пиролизе SiH4 в качестве маски может быть использован слой SiO2 для SiCl4 предпочтительнее маскирование высокоомным слоем Si. Типичные значения толщины переходных слоев в пиролитических эпитаксиальных структурах, используемых для создания БПД, лежат в пределах 0,4-0,6 мкм.
Молекулярно-лучевая эпитаксия, проводимая в ультравысоком вакууме при сравнительно низкой температуре (950-1050°С), позволяет уменьшить толщину переходного слоя примерно до 0,2 мкм.
Обычно p-i- переход создается низкотемпературной (Т=860-880°С) диффузией бора на глубину 0,15-0,22 мкм. При изготовлении р-i-n- структур по технологии обращенной мезаструктуры подложку стравливают до -толщины примерно 10 мкм. При создании прямой мезаструктуры подложку также утончают.
В качестве контактов к сильнолегированным областям р-i-n- структур используются тонкие слои Cr, Ti и Pd2Si. Контакты формируются в виде многослойных систем Ti-Au [15,16], Cr-Pd-Au [9,10]. Значения среднего удельного сопротивления этих контактов rs=(rsp+rsp)/2 для rp,rn£ 0,005 Ом*см сравнимы и примерно пропорциональны сопротивлению p- и n- областей. При rn=0,0015 Ом*см и rp = 0,001 Ом*см в диапазоне частот 700-1700 МГц для всех типов контактов rs<10-6Ом*см-2.
Адгезия Ti и РdSi4 к Si лучше, чем Cr. Кроме того, для хромового контакта наблюдается аномальная зависимость сопротивления от плотности прямого тока [7]. Недостатком Ti является его взаимодействие с травителем для кремния. Вследствие этого при формировании мезаструктуры качество титанового контакта может существенно ухудшаться.
Типичные варианты р-i-n- мезаструктур для быстродействующих переключательных диодов показаны на pиc.5.

Рис. 5. Варианты исполнения p-i-n- структур для быстродействующих переключательных диодов.
Для получения мезаструктуры, показанной на рис.5,а, после диффузии бора в i -слой подложку сошлифовывают примерно до 10 мкм, создают металлические контакты и с помощью фотолитографии формируют ме-заструктуры по диаметру верхнего контакта (около 70 мкм). До окончательного диаметра (17-20 мкм) дотравливают мезаструктуру после сборки диода. Диодная структура (рис.5,6) получена по стандартной технологии обращенной мезаструктуры с интегральным теплоотводом. На рис.5,д показана p-i-n- структура в виде прямой мезаструктуры с балочными выводами. В такой конструкции металлический контакт расположен в непосредственной близости от мезаструктуры, что позволяет уменьшить вклад сопротивления подложки в полное сопротивление диода.
Технология полностью эпитаксиальных p-i-n- структур [12]. На низкоомной, ориентированной в плоскости (100) n-подложке выращиваются последовательно р- слой толщиной около 5 мкм с rp£ 0,001 Ом*см, нелегированный i- слой (от 1 до 15 мкм) и тонкий (~1 мкм) n- слой rn £ 0,0015 Ом*см. Такая структура эпитаксиальных слоев позволяет, используя селективный травите ль, полностью стравить n- подложку и получить однородные по толщине обращенные мезаструктуры с низким удельным сопротивлением p- и n-областей (рис. 5,г).
Вариант технологии изготовления прямой мезаструктуры для БПД подобен технологии создания p-i-n- структуры ограничительного диода. В этом варианте высокоомный i- слой и низкоомный n- слой последовательно наращиваются на низкоомной подложке p- типа проводимости.
Для получения диодных структур с поверхностью, пассивированной термическим SiO2, на эпитаксиальный i- слой осаждается Si3N4 фотолитографией по Si3N4 формируются прямые мезаструктуры, затем проводится термическое окисление боковой поверхности этих структур, удаляются остатки Si3N4 и в открывшихся, окнах создаются диффузионные р-i - переходы.
Существует технология, которая заключается в создании p-i-n- структуры одновременной мелкой диффузией доноров и акцепторов в высокоомную тонкую пленку Si. Технологическая схема этого метода представлена на рис. 6. Исходные пластины представляют собой эпитаксиальные p-i- (или n-i-) –структуры. Всю подложку толщиной 200-400 мкм стравливают химически в потоке газа либо электрохимически. Эпитаксиальную пленку утончают до 2-6 мкм. Диффузию B и P проводят одновременно из боро- и фосфоросиликатных стекол, нанесенных на противоположные стороны пленки. После кратковременной диффузии (5-15 мин при 1100°С), при которой p-i- и i-n- переходы формируются на глубине от 0,5 до 1,5 мкм от поверхности, остатки стекол стравливают и на обе стороны напыляют металлические контакты типа Ti-Au.
Этот метод позволяет применить элементы планарной технологии, при этом SiO2 используется в качестве диффузионной маски. Общий вид p-i-n-мезаструктуры, выполненной по планарной технологии, показан на рис.5,г.Для получения высокой скорости переключения СВЧ-мощности разработаны [9] плананарные диоды "сотовой" структуры с диаметром р-i- перехода около 5 мкм и толщиной i -области около 1 мкм (рис. 5,е). В таких структурах p-i - переход формируется селективной имплантацией ионов бора в высокоомную эпитаксиальную пленку Si. Маской при имплантации служит слой SiO2.
В некоторых случаях для уменьшения времени жизни носителей заряда p-i-n - структуры легируют золотом.

Рис. 6. Технологическая схема изготовления p-i-n- структур с диффузионными n- и р- областями.
1.2.3 Конструкции р -i -n- диодов
Для высокоскоростной модуляции СВЧ, используются как корпусные, так и бескорпусные конструкции р-i-n- диодов (рис. 7). Монтаж диодов в кварцевый и металлокерамический корпуса обычно применяют для диапазона частот до 55 ГГц. На этих частотах могут быть использованы и металлосапфировые корпуса. Для более высоких частот, где требуются малые значения СК, диоды обычно монтируют на штифте с одной или двумя металлизированными кварцевыми опорами. При сборке "сотовой" структуры чип с рядом малых р-i-n- структур помещается в держатель в виде волноводной вставки уменьшенного сечения, контакт к структуре осуществляется тонкой иглой из золото-никелевого сплава.
Пассивация p-i-n- структур лаками и SiO2 несколько ухудшает параметры диодов на СВЧ. Для избежания этого бескорпусные диоды монтируют в волноводном. модуле, который герметизируется майларовым стеклом и заполняется инертным газом.
Для оптимизации параметров СВЧ-модуляторов в каждом интервале частот требуются вполне определенные величины СК и LS. Емкость СК можно регулировать в широких пределах выбором геометрических размеров корпуса и кварцевых опор. Индуктивность LSтакже можно варьировать изменением длины и количества выводов (монтажные лент) от верхнего контакта мезаструктур.

Рис. 7. Способы сборки быстродействующих переключательных р-i-n- диодов:
а) в кварцевый корпус, б) в металлокерамический корпус, в,г) на штифтах с одной и двумя металлизированными опорами, д) прямая мезаструктура с балочными выводами, е) "сотовая" структура.
Похожие работы
... , то двухполупериодный выпрямитель может быть выполнен на двух диодах (рис. 13). Рисунок 13 7. Стабилитроны, варикапы, светодиоды и фотодиоды Стабилитроны. Стабилитроном называется полупроводниковый диод, предназначенный для стабилизации уровня постоянного напряжения. Стабилизация – поддержание какого-то уровня неизменным. По конструкции стабилитроны всегда плоскостные и кремниевые. ...
... Как и для ЛПД, на относительно низких частотах (в сантиметровом диапазоне длин волн) максимальное значение выходной мощности диодов Ганна определяется тепловыми эффектами. В миллиметровом диапазоне толщина активной области диодов, работающих в доменных режимах, становится малой и преобладают ограничения электрического характера. В непрерывном режиме в трехсантиметровом диапазоне от одного диода ...
... измениться в е раз из-за рекомбинации. Для диода с тонкой базой при низкой частоте постоянная времени равна (1.6) 2. РАСЧЕТ и исследование мощных низкочастотных диодов на основе кремния 2.1 Расчет параметров диода Проведем расчет и исследования статических и динамических характеристик 4H-SiC p+-п0-n+ диодов, рассчитанных на обратное напряжение 6, 10 и 20 кВ и ...
... , к которой под действием поля движутся (дрейфуют) основные носители, - стоком, металлическая или полупроводниковая область, используемая для создания модуляции дрейфового тока, - затвором. Подложка является конструктивной основой МДП-транзистора. Рис.1. Конструкция МДП транзистора Области истока и стока одного типа электропроводности формируют на некотором расстоянии /к друг от друга ...

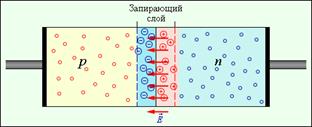
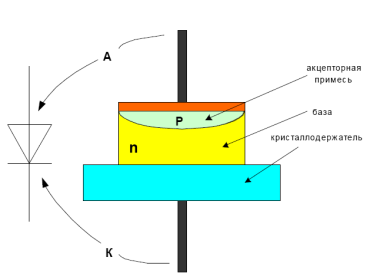
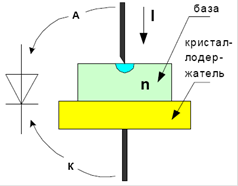
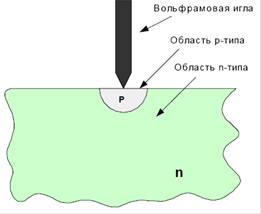
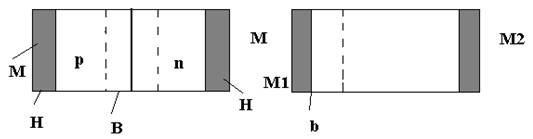


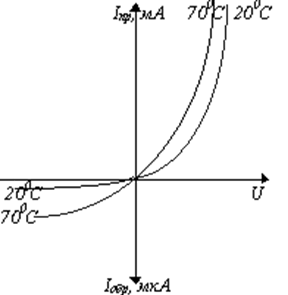
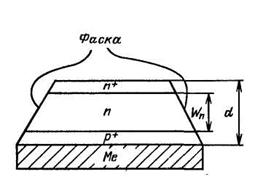
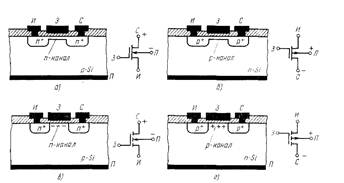
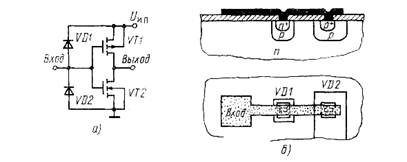
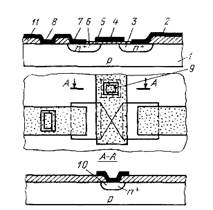

0 комментариев