Навигация
Качество отмывки определяем в темном поле микроскопа Nikon Eclipse L200А при увеличении в 300х по числу светящихся точек
1.1 Качество отмывки определяем в темном поле микроскопа Nikon Eclipse L200А при увеличении в 300х по числу светящихся точек.
2. Нанесение фоторезиста
Наибольшее распространение получило центрифугирование, позволяющее использовать несложные устройства с центрифугой. Толщина плёнки фоторезиста зависит от вязкости, времени нанесения, скорости вращения центрифуги, температуры и влажности среды. Плёнка фоторезиста должна быть равномерна (не хуже ±10%) по толщине и иметь хорошую адгезию к подложке. Последнего добиваются путём предварительного отжига пластин при различных температурах в зависимости от материала покрытия: SiO2 - 900-10000С в атмосфере кислорода, примесносиликатное стекло – 5000С в атмосфере кислорода, Al – отжиг в аргоне при 3000С.
Применение пульверизации для нанесения фоторезиста позволяет автоматизировать процесс, однако связано с большим расходом материала и более сложным контролем за толщиной покрытия. Метод окунания применяют редко, так как, несмотря на простоту и возможность ручного исполнения он не даёт воспроизводимых результатов.
После очистки наносим на пластину слой позитивного фоторезиста фп - 383 толщиной 1.0 мкм. отфильтрованного и разбавленного до степени вязкости (6.0 cCm). Нанесение фоторезиста производим методом центрифугирования в аппарате OSTEC EVG®101, наносим 6-10 капель фоторезиста в центр пластины и распределяем по поверхности при скорости вращения центрифуги 3800 об./мин в течение 30 сек.
3. Первая сушка
Назначение первой сушки фоторезиста состоит в удалении растворителя, уплотнения и уменьшения внутренних напряжений в плёнке, что улучшает адгезию фоторезиста к подложке. Используют три метода сушки: конвективная, ИК-сушка – нагрев от лампы или спирали, и СВЧ - сушка – нагрев за счёт поглощения энергии СВЧ - поля. Последние два метода предпочтительны, так как осуществляют нагрев от подложки и, тем самым, обеспечивают полное удаление растворителя.
После обработки на центрифуге фоторезист сушим: в таре при температуре 20 оС в течение 20 мин; в сушильном шкафу Sawatec HP 150 при температуре 97 оС в течение 30 мин; в таре при температуре 20 оС в течение 35 мин.
4. Совмещение пластины с фотошаблоном.
В процессе изготовления кристалла ИМС фотолитография повторяется многократно, и необходимо каждый раз осуществлять совмещение рисунков топологии кристалла ИМС. Для совмещения используют сложные оптико-механические комплексы, позволяющие осуществлять совмещение визуально, вручную и автоматически. В первом случае сначала проводят совмещение строк и столбцов (так называемое грубо совмещение), а затем точное совмещение по реперным знакам с точностью в пределах 1 мкм. Автоматизированный способ совмещения обеспечивает точность совмещения до 0, 1 мкм. Оптическая система обеспечивает обзор при увеличении 40-80х и точное совмещение при 100-400х
Топологию ранее проведенных процессов с фотомаской совмещаем через микроскоп в аппарате OSTEC EVG620
5. Экспонирование
В качестве источника излучения используют ртутные лампы характеризующиеся высокой интенсивностью излучения, параллельностью светового пучка и его равномерностью. Время экспонирования подбирают экспериментально и обычно в пределах 15-20 с.
Облучение фоторезиста светом с длинной волны 400 нм. производим в том же аппарате что и совмещение OSTEC EVG620
6. Проявление
Характер и условия проявления фоторезиста зависят от его вида и условий предварительной сушки и экспонирования. Проявление позитивных фоторезистов связано с удалением облучённых участков при обработке в водных щелочных растворах 0, 3-0, 5% KOH или 1-2% растворе тринатрийфосфата. Проявление негативных фоторезистов – простое растворение необлучённых участков в органических растворителях (толуол, диоксан и др.). Особенностью проявления позитивных фоторезистов по сравнению с негативными является отсутствие набухания необлучённых участков. Поэтому они имеют большую разрешающую способность и меньшую зависимость её от толщины плёнки фоторезиста.
После экспонирования удаляем не облученные участки фоторезиста проявителем УПФ-1Б, производим удаление в том же аппарате что и нанесение OSTEC EVG®101, в течение 30 секунд при температуре 20 оС и 1000 об./мин.
7. Полимеризация
Для придания устойчивости фоторезиста к последующему воздействию агрессивных сред проводят вторую сушку (так называемое термическое структурирование). При этом температуру увеличивают плавно с выдержкой через 10-20 мин.
Полимеризацию фоторезиста проводим в сушильном шкафу Sawatec HP 150 при температуре 130 оС в течение 30мин.
8. После проявления и полимеризации фоторезиста проводим 100% контроль фотомаски по размерам элементов в 3-4-х точках при увеличении 400х. микроскопом Nikon Eclipse L200А.
9. Травление является завершающей стадией формирования рисунка элементов ИМС. При этом должно быть обеспечено минимальное искажение геометрических размеров, полное удаление материала на участках, не защищённых фоторезистом, высокая селективность воздействия травителя. Составы травителей на характерные слои структур ИМС: SiO2 и примесносиликатные стёкла – HF:NH4F:H2O=1:3:7; Si3N4 – H3PO4 в смеси с P2O5; Al – H3PO4:HNO3:CH3COOH:H2O=15:7:3:1.
Похожие работы
... зондирования, коловорот и др.) КТП-2Г КТП-2БП 1 1 КТП-2П 1 УПТ 1 УПИ 1 1 Комплект устройства для фиксации местоположения соединительных муфт кабельной линии связи УФСМ По согласованию с заказчиком Примечание. Средства измерения 1-5, 10-12, 14-17, 19 и 20 необходимы только в случае исп-я ОК с металл. элементами. 9.1. Электрические проверки основных ...
... технологии) Аналоговая обработка изображений использует, главным образом, фотомеханические, химические и физические средства, а цифровая – электронные. 3. Оценка экономической целесообразности использования программ подготовки отдельных компонентов книжного издания к печати Для каждой программы предназначенной для печати книжных изданий существуют свои системные требования, но для ...
ство используется в системах радиочастотной идентификации на поверхностных акустических волнах. 1.3.2 Возможные принципы построения и функционирования РЧИД-меток на ПАВ До настоящего момента наиболее распространенными были метки с использованием линии задержки. Линия задержки, один из приборов на ПАВ, включает в себя два ВШП, один из которых предназначен для возбуждения, а второй для приема ...
... файлов. В остальных критериях лидером является графический редактор PhotoShop. Таким образом можно сделать вывод, что на сегодняшний день при обработке всего многообразия иллюстраций и подготовке их для печатной продукции оптимальнее всего использовать графический редактор Pyoto Shop. 3. Оценка экономической целесообразности использования современных программ подготовки иллюстрированной ...




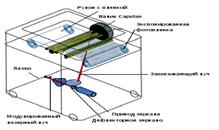

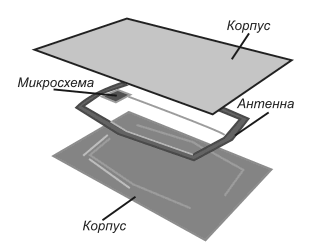



0 комментариев