Навигация
Расчёт и проектирование маломощных биполярных транзисторов
Саратовский Государственный Технический
Университет
Кафедра «Электронные приборы и устройства»
Курсовая работаНа тему:
«Расчёт и проектирование маломощных биполярных транзисторов»
Выполнил: ст. Козачук В. М.
Проверил: доц. Торопчин В. И.
САРАТОВ 1999г.
Оглавление.Оглавление..................................................................................................... 1
1. Введение............................................................................................... 2
2. Цель задания........................................................................................ 2
3. ОБЩАЯ ЧАСТЬ.......................................................................................... 2
3.1 Техническое задание......................................................................... 2
3.2 Параметры, выбранные самостоятельно........................................... 2
3.3 Перечень используемых обозначений............................................... 3
4. Выбор технологии изготовления транзистора...................... 5
4.1 Сплавно-диффузионные транзисторы............................................... 5
4.2 Структура сплавно-диффузионного p-n-p.......................................... 7
5. ОСНОВНАЯ ЧАСТЬ................................................................................... 8
5.1 Расчёт толщины базы и концентраций примесей.............................. 8
5.2 Расчет коэффициента передачи тока............................................... 11
5.3 Расчет емкостей и размеров переходов.......................................... 11
5.4 Расчет сопротивлений ЭС и граничных частот............................... 12
5.5 Расчет обратных токов коллектора.................................................. 14
5.6 Расчет параметров предельного режима и определение толщины элементов кристаллической структуры......................................................................... 15
5.7 Расчёт эксплутационных параметров.............................................. 15
6. Выбор корпуса транзистора............................................................. 16
7. Обсуждение результатов................................................................... 18
8. Выводы:..................................................................................................... 18
9. Список используемой литературы............................................ 20
1. Введение
Используемые физические свойства полупроводника известны и используются с конца 19 века. При изобретении радио А.С. Поповым был применен порошковый когерер, в котором использовались нелинейные свойства зернистых структур. В 1923-1924 гг. Лосев О.В. обнаружил наличие отрицательного дифференциального сопротивления и явление люминесценции в точечных контактных сопротивлениях карбида кремния. В 1940 году был изготовлен первый точечный диод. В 1948 году американский физик Дж. Бардии, а также И.Браштейн разработали и изготовили точечно-контактный транзистор, в 1952 г. впервые были созданы промышленные образцы плоскостных транзисторов. В 1956 г. началось производство транзисторов с базой, полученной методом диффузии. В начале 60-х годов была применена планарная технология изготовления транзисторов. В настоящее время рабочие частоты транзисторов достигают 50 ГГц. По уровню рассеиваемой мощности транзисторы делятся на маломощные, средней и большой мощности.
2. Цель задания
Задачей выполнения курсового проекта является разработка маломощного биполярного транзистора в диапазоне, средних и высоких частот.
Целью работы над проектом является приобретение навыков решения инженерных задач создания дискретных полупроводниковых приборов, углубление знаний процессов и конструктивно технологических особенностей биполярных маломощных транзисторов.
3. ОБЩАЯ ЧАСТЬ 3.1 Техническое задание.
Техническое задание содержит требования к параметрам и условиям эксплуатации практикуемого прибора. В данном случае наиболее существенны следующие параметры:
1. Номинальный ток коллектора Iк ном=9мА.
2. Номинальное напряжение коллектора Uк ном=13В
3. Верхняя граничная частота fa=90МГц
4. Максимальная рассеивающая мощность Рк мах=60мВт
5. Максимальное напряжение коллектора Uк мах=18В
6. Максимальный ток коллектора Iк мах=12мА
7. Максимальная рабочая температура транзистора Тк мах=74°С
8. Коэффициент передачи тока в схеме с ОЭ β=65
3.2 Параметры, выбранные самостоятельно.1. Время жизни ННЗ τср=5мкс
2. Материал кристалла Ge
3. Тип структуры p-n-p
4. Ёмкость коллекторного перехода Ск=2пФ
5. Коофициент запаса по частоте F Х1=1,3
6. Перепад Nб Х2= 500
7. Отношение концентраций NОЭ/ Nб=3
8. Толщина диффузионного слоя hдс= мкм
9. Скорость поверхностной рекомбинации Sрек= слус
3.3 Перечень используемых обозначенийAk - площадь коллектора;
Аэ - площадь эмитера;
a - градиент концентрации примесей;
![]() - отношение подвижностей электронов и дырок;
- отношение подвижностей электронов и дырок;
Сз.к зарядная (барьерная) емкость коллекторного перехода;
Сд.э - диффузионная емкость эмитерного перехода;
Сз.э - зарядная (барьерная) емкость эмитерного перехода;
Дп, Др - коэффициенты диффузии электронов и дырок;
Днб, Доб - коэффициенты диффузии не основных и основных носителей в базе;
Днэ, Доэ - коэффициенты диффузии не основных и основных носителей в эмиттере;
Е — напряженность электрического поля;
De - ширина запрещенной зоны;
¦ - частота;
¦a - граничная частота коэффициента передачи тока в схеме с общей базой;
¦Т » ¦b - граничная частота коэффициента передачи тока в схеме с общим эмитером;
¦max - максимальная частота генерации;
hkp - толщина кристалла;
hэ, hk — глубина вплавления в кристалл эмитера и коллектора;
Ln, Lp - средние диффузионные длины электронов и дырок;
Lнб, Lнэ средние диффузионные длины не основных носителей в базе и эмитере;
Nб, Nk, Nэ — концентрации примесей в базе, коллекторе и эмитере сплавного транзистора;
Nб(х) - концентрация примеси, формирующей проводимость базы дрейфового транзистора;
Nэ(x) - концентрация примеси, формирующей проводимость эмиттера дрейфового транзистора;
ni - равновесная концентрация электронов в собственном полупроводнике;
nn, np - равновесные концентрации электронов в полупроводниках n - типа и p - типа;
Р - мощность, рассеиваемая в коллекторе;
Pk max - предельно допустимая мощность, рассеиваемая в коллекторе;
Рэ - периметр эмитера;
Рn, Рp - равновесные концентрации дырок в полупроводниках n -типа и p - типа;
Rб, Rэ, Rк - радиусы электродов базы, коллектора, эмитера;
Rm, - тепловое сопротивление;
rб - эквивалентное сопротивление базы;
rб’, rб’’ - омическое и диффузное сопротивление базы;
rэ - сопротивление эмитера без учета эффекта Эрле;
rэ’ - сопротивление эмитера с учетом эффекта Эрле;
S — скорость поверхностной рекомбинации;
Т — абсолютная температура;
Тк — температура корпуса транзистора;
Тmax - максимально допустимая температура коллекторного перехода;
W - геометрическая толщина базы;
Wg — действующая толщина базы;
Uэб - напряжение эмитер-база;
Uкб - напряжение коллектор-база;
Ukpn - контактная разность потенциалов;
Uпроб - напряжение пробоя;
Uпрок - напряжение прокола транзистора;
Uк - напряжение коллекторного перехода;
Uk max - максимально допустимое напряжение на коллекторе;
Iэ — ток эмитера;
Iб — ток базы;
Iко — обратный ток коллектора при разомкнутом эмиттере;
Ikmax - максимально допустимый ток коллектора;
Iген - ток термогенерации в области объемного заряда;
Iрек — ток рекомбинации;
a - коэффициент передачи тока в схеме с общей базой;
aо - низкочастотное значение a;
a* — коэффициент усиления тока коллекторного перехода за счет не основных носителей заряда;
b — коэффициент передачи тока в схеме с общим эмитером;
g — коэффициент инжекции эмитера;
бк — толщина коллекторного перехода;
e - относительная диэлектирическая проницаемость;
cо – коэффициент переноса не основных носителей заряда через область базы;
mэ, mб – подвижности электронов и дырок;
mнб, mоб – подвижности не основных и основных носителей заряда в базе;
mнэ, mоэ – подвижности не основных и основных носителей заряда в эмитере;
w - круговая частота;
r - удельное сопротивление полупроводника;
ri - удельное сопротивление собственного полупроводника;
rэ, rб, rк - удельные сопротивления эмитера, базы, коллектора;
tn,p – среднее время жизни электронов и дырок
ttnp – время пролета не основных носителей заряда через базу;
tn – среднее время жизни носителей заряда, обусловленное поверхностной рекомбинацией;
s - удельная теплопроводность;
4. Выбор технологии изготовления транзистораОсновным элементом конструкции транзистора является кристалл, или транзисторная структура кристалла, которая представляет собой полупроводниковую пластину со сформированными на ней эмиттерным (ЭП) и коллекторным (КП) переходами. Другими элементами конструкции являются корпус, кристаллодержатель, выводы.
В зависимости от технических требований предъявляемых к параметрам транзистора, применяются различные методы формирования транзисторной структуры. Низкочастотные транзисторы изготавливаются по сплавной технологии, высокочастотные – с обязательным использованием процесса диффузии примесей. Основными разновидностями технологии изготовления высокочастотных транзисторов являются: диффузионная, планарная. Чисто диффузионная технология используется для изготовления транзисторов с fα не превышающими 50-100 МГц, сплавно- и мезо- диффузионная – для диапазонов 50-100 МГц, соответственно, планарная–для fα=0,5-5ГГц.
Так как граничная частота fα составляет 250 МГц, то для изготовления выберем сплавно-диффузионную технологию.
4.1 Сплавно-диффузионные транзисторы.При диффузионной технологии неоднородность эмиттерной поверхности приводит к неоднородности толщины базовой области, что ухудшает возможные частотные свойства транзистора . В сплавно-диффузионной технологии диффузией формируется лишь базовая область а КП и ЭП формируются вплавлением эмиттерной навески, под которой образуется рекристализационная зона. При этом в эмиттерную навеску вводится примесь, формирующая под эмиттером активный диффузионный слой базы. Коэффициент диффузии этой примеси должен значительно превышать коэффициент диффузии примеси, формирующей эмиттер и ЭП в рекристализационной зоне. Структура сплавно-диффузионного p-n-p транзистора изображена на рис.1.
На рис.2 приведены некоторые этапы получения сплавно-диффузионного транзистора. После получения исходной р- пластины Ge, протравливают в ней лунку, углубляясь в исходную р- пластину (рис.2.1). травление лунок осуществляется методом фотолитографии. На окислённую пластину наносят фоторезистивную плёнку, её освещают через маску ультрофиолетовым светом. Экспонированные места фоторезиста поляризуются. Незаполимеризованные части фоторезиста смывают так, что он остаётся только на облучённых местах. Затем производят травление. После получения лунки проводят щдиффузию донарной примеси (рис.2.2) затем необходимо отшлифовать поверхность исходной пластины, т.о., чтобы диффузионный слой остался лишь в лунке. Диффузия донорной примеси приводит к образованию базового n- слоя (рис.2.3). С помощью электрохимического метода через маску вводят навески вплавляемого материала 1 и 4 (рис.2.4). Навеска 1 является эмиттерной, содержащая спал Ni + Al + In, а навеска 2- базовой.
Затем пластину помещают в печь и нагревают до температуры, близкой к температуре плавления германия (около 900˚С). При такой темпиратуре сплавы не только переходят в жидкое состояние, но имеет место диффузия примесей из жидкой фазы в прилежащую твёрдую фазу. При этом комплексный характер сплава, находится в лунках, обеспечивает одновременное образование двух слоёв: базового и эмиттерного, благодаря резко коэффициентам диффузии донарной и акцепторной примесей в германии: донарная примесь «обгоняет» акцепторную. Под эмиттерной навеской образуется р- область, которая является эмиттером (рис.2.5). Затем получеснную структуру припаивают к кристаллодержателю. Он является выводом коллектора (рис.2.6).
4.2 Структура сплавно-диффузионного p-n-pтранзистора
 Рис. 2. Структура сплавно-диффузионного p-n-p транзистора.
Рис. 2. Структура сплавно-диффузионного p-n-p транзистора.
1,3 – выводы базы;
2 – рекристаллизационная область – эмиттер;
n – размеры кристалла;
c, d – размеры лунки;
hкр – толщина кристалла;
Rэ, Rб – радиусы выводов эмиттера и базы;
5. ОСНОВНАЯ ЧАСТЬРасчёт сплавно-диффузионного транзистора.
Задачи расчёта
В результате расчёта должны быть определены электрофизические и геометрические параметры транзисторной структуры, параметры эквивалентной Т-образной схемы транзистора по переменному току, его эксплуатационные параметры. Часть электрофизических и геометрических параметров при расчёте задаётся исходя из соображений номенклатурного порядка. В конце расчёта выбирается тип корпуса транзистора.
В итоге должны иметься все геометрические и электрофизические параметры, необходимые для исполнения конструкторской и основной части технологической документации. Особенно это касается состава диффузантов, навесок и припоев.
5.1 Расчёт толщины базы и концентраций примесей.Действующая толщина базы определяется соотношением (1).
 , (1)
, (1)
где tпр-время пролёта базы
tпр=![]() , (2)
, (2)
где ![]() - коэффициент запаса по частоте f,
- коэффициент запаса по частоте f, ![]() =1,3
=1,3
![]() сек.
сек.
Задавшись величиной перепада концентраций примеси на границах базы х=200, выразим среднее значение концентрации примеси на границах базы по формуле (3).
![]() , (3)
, (3)
Так как ![]() , (4) необходимо определить концентрацию примеси, формирующей коллекторную область
, (4) необходимо определить концентрацию примеси, формирующей коллекторную область
![]()
Для нахождения концентрации базы NБ используем связь напряжения пробоя Uпроб с удельным сопротивлением коллектора ρк:
![]() ,
(5)
,
(5)
где ![]() - низкочастотное значение коэффициента передачи тока в схеме ОБ
- низкочастотное значение коэффициента передачи тока в схеме ОБ ![]() , (6)
, (6)
![]()
Удельное сопротивление коллектора рассчитывается по формуле (7)
 , (7)
, (7)
Для выбранного нами типа структуры транзистора (Ge, p-n-p)
B=5.2, n=0.61, l=1/6 /1/
x=0.8 (для дрейфовых транзисторов). Подставим численные значения в выражение (7), а затем в (5).

= 0,9903 Ом*см
![]()
=12,748 В
По графику изображенному на рис3.3.1 найдём величину концентрации No
![]()
Определим среднее значение концентрации примеси NБ, формирующий проводимость базы с помощью соотношений (3) и (4)
![]()
![]()
По графику, на рис 3.4.1, найдём среднее значение подвижности не основных носителей заряда в базе ![]()
![]()
Определим среднее значение коэффициента диффузии в базе, воспользовавшись соотношением (8)
![]() , (8)
, (8)
где ![]() - тепловой потенциал, мВ
- тепловой потенциал, мВ
![]() (9)
(9)
![]()
![]()
Подставив вышеопределённые значения в формулу (1), найдём действующую толщину базы.

Величина концентрации примеси, формирующей проводимость базы, на поверхности кристалла NБ(0) определится из соотношения (10)
![]() , (10)
, (10)
где х1Б=0,2 мкм
αБ - коэффициент передачи тока с общей базой ![]() , (11)
, (11)
![]() 1,217*10-4
1,217*10-4
Подставим численные значения в выражение (10)
![]()
Задавшись величиной отношения Nоэ/Nб(0), найдём концентрацию эмиттерной примеси. Nоэ/Nб(0)=3.
Из соотношения (12) выразим концентрацию основных носителей эмиттера. Nоэ=3*Nб(0)
Nоэ=3* ![]() =3,826421*1018 см-3
=3,826421*1018 см-3
Проверим не превышает ли расчётное значение напряжения пробоя коллекторного перехода Uпр величину напряжения прокола транзистора Uпрок, которое рассчитывается по формуле (13)
![]() , (13)
, (13)
где
где: ![]() , (14)
, (14)
Подставляя численные значения в формулы (14) и (13), найдём величину напряжения прокола транзистора.
![]()
![]()
![]()
Значение напряжения пробоя коллекторного перехода (Uпр=12.748) не превышает величину напряжения прокола транзистора Uпрок=240,0092 В
(Uпрок>> Uпр)
Вычислим среднее значение удельного сопротивления области базы по формуле (15)
![]() , (15)
, (15)
По графику приведённому на рис. , определим среднее значение подвижности основных носителей заряда в базе ![]()
![]() =1800
=1800![]()
![]() Ом*см
Ом*см
Задача: для рассчитанного Wq определить коэффициент передачи тока a0 и сравнить его с требуемым.
Коэффициент передачи тока можно записать как:
a0=g0 c0 a* (16).
Далее, рассчитываем коэффициент инжекции g0:
g0=1![]() (17).
(17).
Для его определения необходимо найти:
Lнб=
Похожие работы
... снизить вероятность возникновения пожаров на данном объекте. ЗАКЛЮЧЕНИЕ С целью обеспечения безопасности движения речного транспорта в камере шлюза Усть-Каменогорской гидроэлектростанции в данном дипломном проекте была разработана радиолокационная станция обнаружения надводных целей, она гораздо эффективнее, чем, например система видео наблюдения. Были рассчитаны основные тактико- ...
... – это законченный элемент ИМС, который можно использовать при проектировании аналоговых микросхем. 1 Общие принципы построения топологии биполярных Имс Общего подхода к проектированию биполярных интегральных микросхем нет и быть не может, каждый тип характеризуется своими особенностями в зависимости от требований и исходных данных ИМС. Исходными данными при конструировании микросхем являются: ...
... г. Москва и МО) 3.6 Расчёт тракта формирования несущей частоты Переноса сигнала с промежуточной частоты в 465кГц на радиочастоту из рабочего диапазона f = 6525… 6685 кГц в конкретном передатчике будет осуществляться гетеродинированием сигнала ПЧ с гармоническим сигналом с изменяющейся частотой, полученного с использованием синтезатора частот. В качестве смесителя будем использовать те же ...
... В соответствии с таблицей №4, я выбираю промежуточную частоту равную 465±2кГц. 1.2.5 Определение ширины полосы пропускания Ширина полосы пропускания высокочастотного тракта супергетеродинного приемника определяется необходимой шириной полосы частот излучения передатчика корреспондента, а также нестабильностью частоты передатчика корреспондента и гетеродина приемника. Необходимая ширина полосы ...


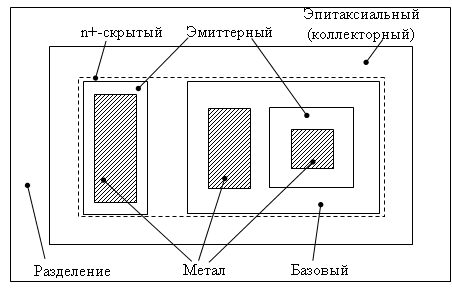


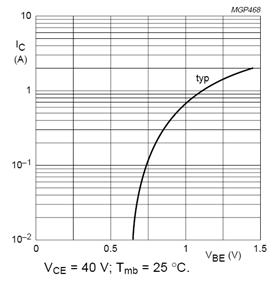
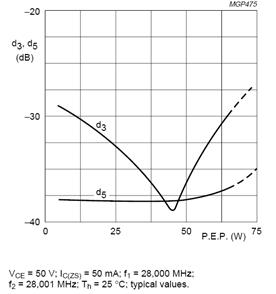
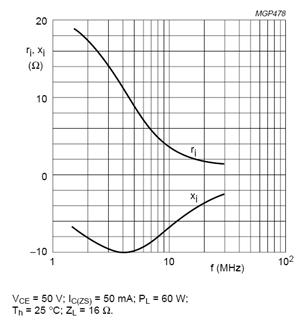

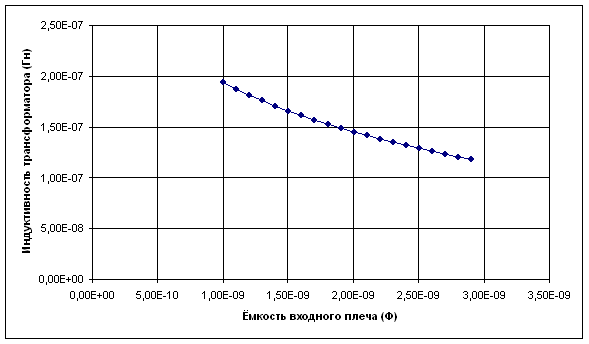
0 комментариев