Навигация
Разработка конструкции, топологии и технологического процесса изготовления интегральной микросхемы усиления тока индикации кассового аппарата
Министерство образования Российской Федерации
РАСЧЁТНО-ПОЯСНИТЕЛЬНАЯ ЗАПИСКА
к курсовой работе по курсу:
Технология ИМС
тема: “ Разработка конструкции, топологии и технологического процесса изготовления ИМС усиления тока индикации кассового аппарата“
Базовое предприятие ФГУП «КЗТА»
Калуга 2009 г.
Содержание
Техническое задание
Топологический расчет транзистора
Расчет геометрических размеров резисторов
Расчет геометрических размеров конденсаторов
Расчет топологии полупроводникового кристалла
Технологические процесс изготовления ИМС
Биполярные микросхемы с изоляцией р-п переходом
Заключение
Список литературы
Введение
Основополагающая идея микроэлектроники – конструктивная интеграция элементов схемы – приводит к интеграции конструкторских и технологических решений, при этом главной является задача обеспечения высокой надежности ИМС.
Важнейшей задачей проектирования является разработка быстродействующих и надежных схем, устойчиво работающих при низких уровнях мощности, в условиях сильных паразитных связей (при высоко плотности упаковки) и при ограничениях по точности и стабильности параметров элементов.
При технологическом проектировании синтезируется оптимальная структура технологического процесса обработки и сборки ИМС, позволяющая максимально использовать типовые процессы и обеспечивать минимальные трудоемкость изготовления и себестоимость микросхем.
Техническое задание
Разработка конструкции, топологии и технологического процесса ИМС по заданной электрической схеме.
Схема электрическая принципиальная приведена на рис. 1.
Описание работы схемы.
Схема электрическая принципиальная приведена на рис. 1.
Данная схема обеспечивает обработку сигналов, поступающих на вход схемы, и выдачи сигнала на выход. Транзисторы VT1-VT4 обеспечивают усиление по току.

Таблица 1. Номинальные значения элементов
| R1 | 6,8 кОм±5% | R6 | 6,8 кОм±5% | VT1…VT3= =BC817-25 | VT4= =BC807-25 | VD1…VD5= =LL4148 |
| R2 | 6,8 кОм±5% | R7 | 120 Ом±5% | |||
| R3 | 6,8 кОм±5% | R8 | 120 Ом±5% | Uкб=50 В | Uкб=50 В | Uкб=40 В |
| R4 | 2 кОм±5% | R9 | 120 Ом±5% | P=1 Вт | P=1 Вт | P=1 Вт |
| R5 | 6,8 кОм±5% | C1 | 270 пФ±20% | I=20 мА | I=25 мА | I=25 мА |
Таблица 2. Назначение выводов
| Обозначение | 1 | 2 | 3 | 4 | 5 | 6 | 7 |
| Назначение | RX_BC | GND | -12_IN | TX_X | TX | ---- | RAS_LAP |
| Обозначение | 8 | 9 | 10 | 11 | 12 | 13 | 14 |
| Назначение | +5V | RTS_BC | RX_X | RX | CTS_BC | GTO_BC | BC |
| Контр. параметры | |
| I5=15 мА | U5=4±0,5 B |
| I13=10 мА | U13=15±0,5 B |
Рис.1 Схема электрическая принципиальная
Расчет режимов изготовления эпитаксиально-планарного транзистора
Расчет концентраций примеси в отдельных областях транзистора
Расчет концентраций примеси в отдельных областях транзистора с учетом заданного пробивного напряжения.
Определяется из соотношения:
![]()
![]() - напряжение пробоя перехода.
- напряжение пробоя перехода.
![]() В/см – критическое значение напряженности поля для кремния.
В/см – критическое значение напряженности поля для кремния.
![]() Кл – заряд электрона.
Кл – заряд электрона.
![]() - относительная диэлектрическая проницаемость (для кремния 12).
- относительная диэлектрическая проницаемость (для кремния 12).
![]() Ф/см – абсолютная диэлектрическая проницаемость.
Ф/см – абсолютная диэлектрическая проницаемость.
N – концентрация примеси на слаболегированной стороне перехода, которую надо отнести к наиболее опасному сечению, т.е. к поверхности.
Усредненная ![]() , если
, если ![]() , а
, а ![]() .
.
а) Концентрация примеси на поверхности подложки:
| Uк-п | Uк-б | Uб-э | |
| VT1…VT3 | 60 | 50 | 5 |
![]() , при Uпр к-п = 60 В
, при Uпр к-п = 60 В
б) Поверхностная концентрация примеси в коллекторе:
![]() , при Uпр к-б = 50 В.
, при Uпр к-б = 50 В.
в) Поверхностная концентрация примеси в базе:
![]() , при Uпр б-э = 5 В.
, при Uпр б-э = 5 В.
Окончательно:
|
|
|
| |
| VT1…VT3 |
|
|
|
Для дальнейших расчетов выберем транзистор VT5 и примем его за базовый элемент нашей ИМС.
Расчет режимов диффузии базовой области.
При двухстадийной диффузии распределение примеси подсчитывается по закону Гаусса:
![]() ,
,
где N – концентрация примеси, ![]() .
.
Q – поверхностная концентрация примеси, ![]() .
.
![]() - диффузионная длина.
- диффузионная длина.
Учитывая, что коллектор легирован равномерно и зная концентрацию примеси на поверхности базы и под переходом Б-К (на глубине ![]() ), можно записать:
), можно записать:
1) при Х = 0: ![]()
![]() (1)
(1)
2) при ![]() :
:  (2)
(2)
![]() ,
,
где ![]() – коэффициент диффузии на этапе разгонки базы
– коэффициент диффузии на этапе разгонки базы ![]() .
.
![]() – время процесса разгонки базы.
– время процесса разгонки базы.
![]() – доза легирования базы
– доза легирования базы ![]() .
.
Из (1) и (2) получим:  ;
;
![]()
Задаемся температурой разгонки базы: ![]()

Рис. 2. Температурная зависимость коэффициента диффузии: ![]() и
и ![]() - исходная и поверхностная концентрация примеси,
- исходная и поверхностная концентрация примеси, ![]()
Из графика ![]() находим
находим ![]() , а
, а ![]() .
.
Из (1) ![]()
Для этапа загонки примеси в базу можно записать:
![]()
![]() , тогда
, тогда ![]()
Примем температуру загонки базы ![]() и из графика
и из графика ![]() .
. ![]()
![]() мин.
мин.
Окончательно: ![]() ,
, ![]() ,
, ![]() ,
, ![]() ,
, ![]() ,
, ![]() мин,
мин, ![]() мин.
мин.
Расчет режимов диффузии эмиттерной области.
Определим концентрацию примеси на уровне перехода Э-Б ![]() .
.
 ;
;
 ; где
; где  ;
;  .
.
Полагая для высоколегированного эмиттера, что  , а
, а ![]() , то
, то ![]() ,т.к.
,т.к. ![]() .
.
Для определения ![]() воспользуемся требованием высокой проводимости эмиттера, которая должна иметь удельное поверхностное сопротивление
воспользуемся требованием высокой проводимости эмиттера, которая должна иметь удельное поверхностное сопротивление ![]() Ом. Примем
Ом. Примем ![]() . Тогда
. Тогда ![]() .
.

Рис. 3. Зависимость удельного сопротивления Si от концентрации примеси при температуре ![]()
Из графика ![]() приближенно определим концентрацию примеси в эмиттере
приближенно определим концентрацию примеси в эмиттере ![]()

Рис. 4. Зависимость подвижности электронов от концентрации доноров в кремнии
Из графика ![]()
![]() .
.
Тогда ![]()
Поделим ![]() на
на ![]() ,
, ![]() .
.

Рис. 5. Графики для определения параметра Dt в эмиттерной области (этап разгонки)
Из графика  получим
получим ![]()
Концентрация примеси доноров в эмиттере 
![]() . Пусть
. Пусть ![]() ,
, ![]()
Из графиков ![]() ,
, ![]()
Отсюда ![]() Доза легирования в процессе загонки определяется по формуле
Доза легирования в процессе загонки определяется по формуле ![]() Отсюда для процесса загонки примеси в эмиттер
Отсюда для процесса загонки примеси в эмиттер ![]() (5)
(5)
Полагая ![]()
![]() (6).
(6).
При ![]()
![]() по графику
по графику ![]() ,
, ![]() . Из (6)
. Из (6) ![]()
Окончательно: ![]()
![]() ;
; ![]()
![]() ;
; ![]()
![]() ;
;
![]()
![]() ;
; ![]() .
.
Расчет поверхностного сопротивления областей транзисторов
Для контроля и проектирования диффузионных резисторов необходимо знать величины поверхностных сопротивлений областей транзистора, которые определяются по формуле: ![]() .
.
1) Определим поверхностное сопротивление коллектора: ![]() по графику
по графику ![]() , при
, при ![]()
Для равномерно легированного кремния ![]() .
.
2) Определим поверхностное сопротивление базовой области: ![]() где
где ![]() - средняя концентрация введенной примеси;
- средняя концентрация введенной примеси; 
![]() при равномерно легированном коллекторе
при равномерно легированном коллекторе ![]() ,
, ![]() – подвижность дырок в области базы,
– подвижность дырок в области базы, ![]() – суммарная концентрация примеси на глубине
– суммарная концентрация примеси на глубине ![]()
![]() .
.

Рис. 6. Зависимость подвижности электронов от концентрации доноров в кремнии при ![]()

Рис. 7. Зависимость подвижности дырок от концентрации акцепторов в кремнии при ![]()
Из графика ![]()
![]() , тогда
, тогда ![]() ,
, 
3) Определим поверхностное сопротивление эмиттерной области:
![]() ;
;
Для диффузионных областей, где распределение примеси неравномерно по глубине, разность концентраций должна иметь смысл средней концентрации, нескомпенсированной примеси ![]() , найденной в пределах
, найденной в пределах ![]() .
. ![]() , где
, где ![]() – полная концентрация веденной примеси.
– полная концентрация веденной примеси. 
![]()
![]() – средняя концентрация р - примеси до
– средняя концентрация р - примеси до ![]() .
.
Находим ![]() также как и
также как и ![]() , только берем
, только берем ![]() ,
, ![]() ,
, ![]() и
и ![]() .
.

Получим, что
![]()
![]()
![]() .
.
По графику ![]() при
при ![]()
![]() , тогда
, тогда ![]()
![]() .
.
Окончательно: ![]() ;
; ![]()
![]()
Топологический расчет транзистора
Цель топологического расчета – получение в плане минимально возможных размеров областей транзистора, которые зависят от мощности рассчитываемой транзистором и следующими топологическими ограничениями.
а) Минимальный размер элемента топологического рисунка аmin обусловленный разрешающей способностью процесса фотографии (4мкм).
б) Максимальное отклонение размера элемента рисунка ±∆1 = 0,5 мкм обусловлены погрешностями размеров элементов рисунков фотошаблона и погрешностями размеров на операциях экспонирования и травления.
в) Погрешностями смещения ±∆2 = ±2 мкм.
г) Боковая диффузия примеси под маскирующий окисел.
При высоких уровнях тока резко проявляется эффект оттеснения эмиттерного тока. Поэтому токонесущая способность транзистора определяется не площадью эмиттера, а периметром. Отсюда при проектировании эмиттера необходимо обеспечить максимальное отношение периметра к площади.
Рассчет эмиттерной области
Размер окна под эмиттерный контакт lЭКмин =аmin = 4мкм.
Примем lЭК = 10мкм
Размер проводника над эммитером:

Рис.8
lЭП ³ lЭК + 2 ∆2+2 ∆1 = 15 мкм.
При дальнейшем расчете необходимо учесть следующие требования:
а) Расчет вести на наиболее неблагодарное сочетание погрешностей;
б) Отсутствие перекрытия перехода кромкой проводника (уменьшение паразитной емкости);
в) Полное заполнение металлом окна под контакт;
г) Расстояние между боковыми переходами смежных областей равно диффузионной длине не основных носителей.
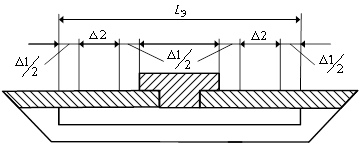
Рис.9
Учитывая условие б) имеем:
lЭ = lЭП +2∙∆l + 2 ∙∆2=15 + 1 + 4 = 20 мкм
Размер окна под диффузию эммитерной области:
lОЭ = lЭ – 2 ∙ Хпер(Э-Б)= 20 – 4 = 16 мкм.
Периметр эмиттерной области можно определить по формуле:
П = 6 ∙ JЭ1 = 2 ∙ l Э1 + 2 ∙ l Э2 (в мкм) (*)
Jэ – максимальный ток эмиттерной области, мА.
l Э1, l Э2 – длина и ширина эмиттерной области, мкм.
l Э1min =amin=2Xпер Э-Б=4+4=8 мкм
Примем l Э1 = 25 мкм;
Из формулы (*): ![]() мкм; при JЭ =20 мА.
мкм; при JЭ =20 мА.
Окончательно: l ЭП =15 мкм; lЭК = 10 мкм;
lОЭ = 16 мкм; lЭ=20 мкм;
Расчет размеров базовой области
Топологический расчет базовой области сводится к определению расстояния между переходами в месте расположения базового контакта dБ1
и расстояния dБ2 на участках, где нет контакта.
Размер окна под базовый контакт lБК≥ 2аmin.
Размер базового проводника
lБПмин = lБК + 2∙∆1 + 2∙∆2=8 +1 + 4 = 13 мкм.
Примем lБП=17,5
Учитывая требования б), размер между переходами Э-Б и Б-К, где есть базовый контакт:
dБ1= lБП+2∙∆1+2∙∆2+аmin= 17,5 + 1 + 4 + 4 = 26,5 мкм.
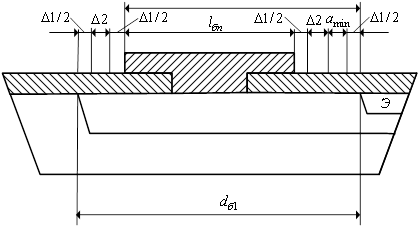
Рис.10
Размер между переходами Э-Б и Б-К со стороны, где нет базового контакта

Рис.11
При соблюдении требования г) {lПБ = 4 мкм.}
dБ2 = lПБ + ∆1 + ∆2 = 6.5 мкм. Примем dБ2 = 7 мкм.
Определим большую сторону базовой области:
lБ1 = lЭ + dБ1 + dБ2 = 25 + 26,5 + 7 = 58,5 мкм.
Определим размер меньшей стороны базовой области:
lБ2 = lЭ + 2 ∙ dб2= 25 + 14 = 39 мкм.
Размеры окна под диффузию базы:
lБО1 = lБ1 – 2∙Хпер.(Б-К) = 52,5 мкм.
lБО2 = lБ2 – 2∙Хпер.(Б-К) = 33 мкм.
Окончательно: lБК = 8 мкм; lБ2= 39 мкм. lБО1= 52,5 мкм.
lБП= 17,5 мкм. lБ1= 58,5 мкм. lБО2= 33 мкм.
Расчет размеров коллекторной области
Размер окна под коллекторный контакт примем:
lon+ = lКК = 2аmin = 8 мкм.
Тогда размер коллекторного проводника:
lКП = lКК + 2 ∙ ∆1 + 2 ∙ ∆2 = 13 мкм.
а размер между переходами К-П и Б-К в стороне контакта:
dК1 = lКП + 2 ∙ ∆1 + 2 ∙ ∆2 + аmin = 22 мкм.
Размер между переходами К-П и К-Б в стороне, где нет контакта, но есть n+-область:
ln+ = lоn+ +2 ∙ Хпер.(Б-Э)= 8 + 4 = 12 мкм.
dK2 = ln+ + 2 ∙ ∆1 + 2 ∙ ∆2= 12+ 1 + 4 = 17 мкм.

Рис.12
Размер большой стороны коллекторной области:
lK1 = lБ1 + dК2 + dК1=58,5 + 39 = 97,5 мкм.
lК2 = lБ2 + 2∙dК2= 67+ 39 = 106 мкм.
Размер окна под разделительную диффузию примем lор = аmin = 4 мкм.
Тогда размер между коллекторными областями в плане (ширина изолирующего канала):
B = lOP + 2∙Хпер(К-П)=4 + 2 ∙ 2 = 8 мкм.
Окончательно: lКК = 8 мкм lК2 = 97,5 мкм ln+ = 12 мкм lOP = 4 мкм
lКП= 13 мкм lК1= 106 мкм в = 8 мкм
Расчет геометрических размеров резисторов
Расчет геометрических размеров интегрального полупроводникового резистора начинают с определения его ширины. За расчетную ширину b резистора принимают значение, которое не меньше наибольшего значения одной из трех величин: bтехн, bточн, bр, т.е. ![]() , где bтехн - минимальная ширина резистора, определяемая разрешающей способностью технологических процессов (4 мкм); bточн - минимальная ширина резистора, при которой обеспечивается заданная погрешность геометрических размеров; bр - минимальная ширина резистора, определяемая из максимально допустимой мощности рассеяния.
, где bтехн - минимальная ширина резистора, определяемая разрешающей способностью технологических процессов (4 мкм); bточн - минимальная ширина резистора, при которой обеспечивается заданная погрешность геометрических размеров; bр - минимальная ширина резистора, определяемая из максимально допустимой мощности рассеяния.
Расчет геометрических размеров резистора R1-R3, R5, R6 (Б.О.):
|
|
|
Расчет геометрических размеров резистора R4(Б.О.):
|
|
|
Расчет геометрических размеров резистора R7-9(Б.О.):
|
|
|
Расчет геометрических размеров конденсаторов
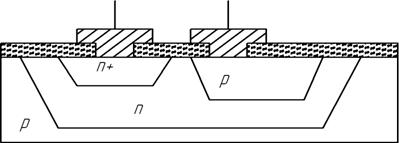
Рис.13
Тип конденсаторов выберем на основе базово-коллекторного перехода, т.к. он обладает высокой добротностью, достаточным пробивным напряжением и средней удельной емкостью
![]()
![]()
![]()
Расчет топологии полупроводникового кристалла
1. Определим площадь, занимаемую элементами на кристалле. Площадь, занимаемая активными элементами:
![]() ,
,
где ![]() - площадь одного транзистора;
- площадь одного транзистора; ![]() n – число активных элементов.
n – число активных элементов.
2. Определим площадь под диоды:
![]()
где ![]() - площадь одного диода;
- площадь одного диода;
3. Определим площадь под резисторы:
![]()
где m – число резисторов.
3. Определим площадь под конденсаторы:
![]()
4. Площадь активной зоны: К – коэффициент запаса, зависит от плотности разводки металлизации.
![]()
![]()
Процесс сборки упрощается при квадратной форме кристалла:
![]()
Интегральная схема 13 выводов (контактных площадок). При термокомпрессии проводом 28 мкм ширина площадки будет равна ![]() , где D – диаметр проволоки; K – коэффициент, равный
, где D – диаметр проволоки; K – коэффициент, равный ![]() отсюда
отсюда ![]() с запасом 100 мкм. Расстояние между центрами контактных площадок не менее 200 мкм. Линия скрайбирования для уменьшения вероятности скола взята шириной 100 мкм.
с запасом 100 мкм. Расстояние между центрами контактных площадок не менее 200 мкм. Линия скрайбирования для уменьшения вероятности скола взята шириной 100 мкм.
Примечания:
1. Проводники металлизации алюминием выполняются толщиной 1 мкм. Ширина проводника определяется из соотношения ![]() (находится в пределах 10:20 мкм).
(находится в пределах 10:20 мкм).






0 комментариев