Навигация
Метод открытой трубы
1.2.2. Метод открытой трубы
Метод диффузии в открытой трубе лишен указанных выше недостатков метода диффузии в запаянной ампуле. В этом методе в высокотемпературную печь помещается кварцевая труба с пластинами кремния, выходной конец которой открыт в атмосферу. Через входной конец трубы подается газ (необязательно инертный), в который из первичного источника диффузии поступают соединения примеси. Источник примеси может быть твердым, жидким или газообразным. В первых двух случаях необходимое давление паров получают, подогревая первичный источник. Наиболее широко используются такие источники диффузии, как H3BO3, BBr3, BCl3, B2H6, P2O5, (NH4)3PO4, POCl3, PBr3, PH3 [3].
Рассмотрим схему установки для проведения диффузии методом открытой трубы. Схема современной установки представлена на рис. 1.6.
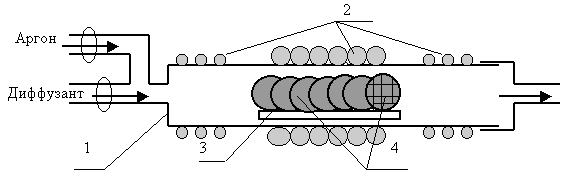
Рис. 1.6. Схема рабочей камеры диффузионной печи.
Собственно камера представляет собой кварцевую (или керамическую) трубу 1, снабженную резистивными нагревателями 2 (3 секции с независимым регулированием температуры). Крайние секции поддерживают малый градиент температуры, обеспечивающий средней секции рабочую температуру до 1250°С с высокой точностью (до ± 0,25°С). Именно в этой части камеры на кварцевом (или керамическом) держателе 3 располагаются обрабатываемые пластины 4, имеющие на рабочей поверхности оксидную маску. При выполнении загонки примеси или одностадийного процесса диффузии в камеру из внешнего источника непрерывно подается диффузант, представляющий смесь легирующей примеси (акцептор бор или донор фосфор) с транспортирующим газом (аргон). Такая установка используется при диффузии из жидких и газообразных источников.
В случае применения жидкого источника если газ насыщен примесью, то его концентрация в кремнии зависит только от температуры жидкого источника и рабочей температуры диффузии, но не от потока. Если в качестве жидких источников применяются галогены, то это способствует уменьшению загрязнения реактора ионами металлов и формированию бездефектных областей, содержащих активные элементы. Однако при этом возможно локальное растворение полупроводника и появление матовости на поверхности кремниевых пластин [3].
Однородность поверхностной концентрации примеси в кремнии при постоянной температуре диффузии определяется распределением давления паров образующегося окисла примеси в рабочей зоне диффузионной печи.
При работе с газообразным источником диффузанта используют баллон, содержащий смесь PH3 (или B2H6) и инертного газа, например аргона. Газом-носителем может служить азот в смеси с кислородом.
При диффузии методом открытой трубы с использованием твердого источника тигель с источником в виде порошка находится в реакторе со стороны подачи газа-носителя перед лодочкой с пластинами кремния (или даже под ней). Однородность легирования в сильной степени зависит от давления паров источника, поэтому для его регулирования температура последнего устанавливается ниже температуры диффузии путем использования печи с двумя нагревательными камерами (см. рис. 1.3). Состав несущего газа должен быть таким, чтобы не происходило окисления пластин полупроводника. Пленка окиси, если она образуется, может препятствовать проникновению примеси внутрь образцов кремния.
Наблюдаются случаи, когда в трубчатой двухзонной печи при использовании в качестве газов-носителей аргона или азота происходит эрозия поверхности кремния. Это явление может быть устранено, если добавить в газ-носитель небольшое количество кислорода. Для этого на входе в кварцевую трубу имеются два подводящих газ патрубка. По одному из них может подаваться основной инертный газ-носитель, по другому – кислород (или пары воды). При входе в трубу эти газы перемешиваются и затем поступают в зоны печи, где находятся диффузант и кремниевые образцы.
Обычно расход газа-носителя регулируют в пределах 0,5 – 1,5 л/мин с помощью ротаметров, установленных на входе печи [16]. Изменение расхода в указанных пределах не оказывает заметного влияния на результаты диффузии. При очень больших расходах газа появляется эрозия кремния. Скорость потока газов-реагентов (газообразных источников диффузии) определяет концентрацию легирующих примесей в кремнии; скорость потока газов-носителей влияет на стабильность температуры в трубе и на однородность концентрации газов-реагентов в той части диффузионной трубы, где помещаются пластины кремния.
Из-за вредности многих элементов, применяемых для диффузии в кремний, следует обратить особое внимание на необходимость удаления в вытяжную систему выходящих из печи газов, содержащих пары диффузанта.
Основной причиной неоднородности и невоспроизводимости результатов диффузии служит то обстоятельство, что поток в диффузионной трубу весьма неравномерен, он образует спиральные завихрения, которые при низких скоростях потока более ярко выражены [9]. Тем не менее диффузия в потоке газа-носителя широко используется в производстве полупроводниковых приборов. За последнее время диаметр пластин кремния увеличился до 10 см и более, в связи с чем было уделено особое внимание усовершенствованию аппаратуры для диффузии в потоке газа, увеличению точности поддержания таких параметров, как температура процесса, скорости потоков газов-реагентов и газов-носителей. В целях контроля и регулирования всего процесса используется ЭВМ.
Похожие работы
... к ним вызван экологическими соображениями, с одной стороны, и ограниченностью традиционных земных ресурсов — с другой. Особое место среди альтернативных и возобновляемых источников энергии занимают фотоэлектрические преобразователи солнечной энергии, изучение которых превратилось в отдельное научное направление – фотовольтаику. Однако высокая стоимость солнечных элементов до недавнего времени ...
... голоса, слушают пение птиц, плеск волн и шум ветра, дышат свежим воздухом. Воспользоваться таким транспортом захочет каждый, кто любит совершать водные путешествия. 6. РОССИЯ, УКРАИНА И СОЛНЕЧНАЯ ЭНЕРГЕТИКА В России в настоящее время имеется восемь предприятий, имеющих технологии и производственные мощности для изготовления 2 МВт солнечных элементов и модулей в год. В 1992 году на ...
... подавляет в кремнии генерацию термодоноров, вводимых в кремний в температурном интервале 400-500 оС. Выводы Сплавы Si1-xGex в настоящее время являются тем материалом, который желательно возможно быстрее освоить в производстве. Их достаточно предсказуемые свойства позволяют получать монокристаллы с заданными параметрами путём аппроксимации зависимости свойств от состава (зависимости ...
... . ПРИМЕНЕНИЕ ИОННОГО ЛЕГИРОВАНИЯ В ТЕХНОЛОГИИ СБИС Создание мелких переходов Требование формирования n+ слоев, залегающих на небольшой глубине, для СБИС можно легко удовлетворить с помощью процесса ионной имплантации Аs. Мышьяк имеет очень малую длину проецированного пробега (30 нм) при проведении обычной имплантации с энергией ионов 50 кэВ. Одной из прогрессивных тенденций развитии ...

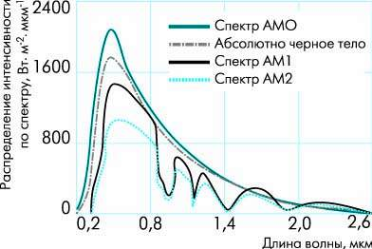



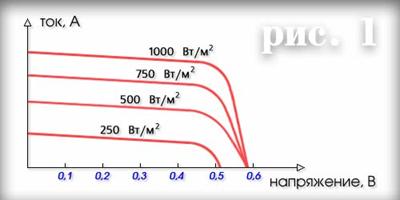
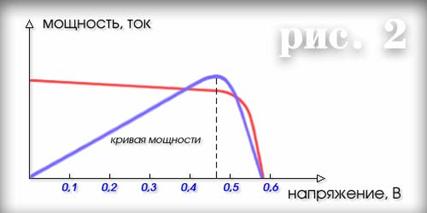

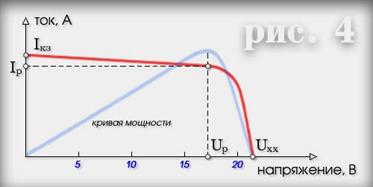

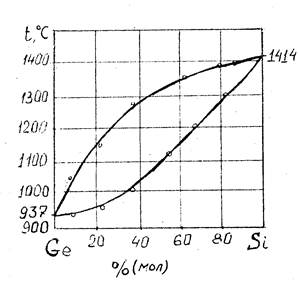




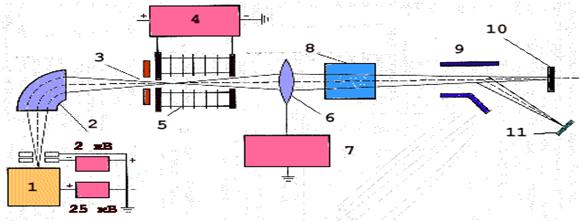




0 комментариев