Навигация
Фізико-технологічні основи фотолітографії
МІНІСТЕРСТВО ОСВІТИ І НАУКИ УКРАЇНИ
УЖГОРОДСЬКИЙ НАЦІОНАЛЬНИЙ УНІВЕРСИТЕТ
ФІЗИЧНИЙ ФАКУЛЬТЕТ
Кафедра твердотільної електроніки
ФІЗИКО-ТЕХНОЛОГІЧНІ ОСНОВИ ФОТОЛІТОГРАФІЇ
Курсова робота
студента 3 курсу , 4-ої групи
фізичного факультету
Біланича Р.М.
Науковий керівник:
проф.,д.ф.-м.н. Міца В.М.
Ужгород-2005
ВСТУП3
Розділ 1. ОСНОВИ ФОТОЛІТОГРАФІЧНИХ ПРОЦЕСІВ
1.1.Фоторезисти і фотошаблони в фотолітографії
1.2. Методи виготовлення і характеристики фотошаблонів
1.3.Технологія фотолітографії13
Розділ 2. ЗАБЕЗПЕЧЕННЯ ЯКОСТІ ФОТОЛІТОГРАФІЇ
2.1.Порушення якості фотолітографії
2.2.Методи боротьби з причинами порушення якості фотолітографії
Розділ 3.МЕТОДИ ФОТОЛІТОГРАФІЇ
3.1.«Подвійна» фотолітографія
3.2.«Подвійні» фотошаблони
3.3. Фотолітографія з підшаром
3.4.«Вибухова» фотолітографія
3.5.Негативно-позитивна фотолітографія
ВИСНОВОК
СПИСОК ВИКОРИСТАНИХ ДЖЕРЕЛ
ВСТУП
Найважливішим процесом планарної технології є фотолітографія. Сучасний стан і тенденції розвитку мікроелектроніки ставлять перед фотолітографією нові й усе більш складні задачі, обумовлені насамперед подальшою мініатюризацією елементів схем і різким підвищенням вимог до точності процесів фотолітографії. Крім того, при масовому виробництві інтегральних мікросхем особливу гостроту здобуває проблема відтворюваності фотолітографічного процесу, його технологічної стійкості. Без рішення цієї проблеми неможлива ефективна автоматизація виробництва інтегральних мікросхем і керування якістю продукції.
Найбільш розповсюдженим способом формування малюнка є контактна фотолітографія. Стандартний фотолітографічний процес проводять у двох стадіях: а) формування фоторезистивної маски і б) створення рельєфу в металевих, напівпровідникових і діелектричних шарах через сформовану маску. Сучасне устаткування дозволяє виготовляти фотошаблони-трафарети з мікронними і субмікронними елементами, роздільна здатність фоторезистів знаходиться на рівні сотих часток мікрона, розробка нових методів прецизійного фрезерування малюнка в металевих, напівпровідникових і діелектричних шарах дозволяє реалізувати на робочих пластинах структури, розміри елементів яких складають десяті частки мікрона. Таким чином, перераховані фактори не перешкоджають досягненню в контактній фотолітографії роздільної здатності, близької по величині до довжини хвилі випромінювання, рівної 0,2-0,4 мкм (актинічне випромінювання). Тим не менш досвід показує, що вже при відтворенні елементів розмірами 2-5 мкм дуже часто виникає брак, зв'язаний з неточністю передачі розмірів і спотворенням форми.
Метою даної курсової роботи є огляд основної літератури по фізико-технологічним основам фотолітографії.
1.ОСНОВИ ФОТОЛІТОГРАФІЧНИХ ПРОЦЕСІВ
1.1 Фоторезисти і фотошаблони в фотолітографії
1.2
Фотолітографія - це сукупність фотохімічних процесів, серед яких можна виділити три основні етапи: формування на поверхні матеріалу шару фоторезисту, передавання зображення з шаблону на цей шар, формування конфігурації елементів пристроїв за допомогою маски з фоторезисту [1].
Фоторезисти - складні полімерно-мономерні системи, у яких під дією випромінювання визначеного спектрального складу протікають фотохімічні процеси [2]. Корисним результатом цих процесів є локальна зміна розчинності полімерної системи. Фоторезисти, у яких розчинність експонованої ділянки зменшується, називають негативними, а фоторезисти, розчинність яких після опромінювання зростає - позитивними. Після обробки експонованого фоторезисту в суміші, яка усуває розчинні ділянки, утворюється рельєфне зображення (рельєф), яке повинно бути стійким до впливу агресивних факторів: кислот, лугів і т.д. Полімерні системи, здатні до утворення захисних рельєфів, можуть бути чутливі не тільки до видимого світла, але і до інших видів випромінювання - рентгенівського або до потоку електронів [2,3].
На рис.1.1 показано, як утворюється рельєф при використанні негативного і позитивного фоторезистів. Не зупиняючись на численних світлочутливих системах, покажемо, що процеси, які лежать в основі утворення рельєфного зображення поділяються на три групи:
- фотополімеризація й утворення нерозчинних ділянок; найбільш типовими для системи, у якій використовується цей процес, є негативні фоторезисти - ефіри коричної кислоти і полівінілового спирту;
- зшивання лінійних полімерів радикалами, що утворяться при фотолізі світлочутливих сполук. Використання каучуку з добавками світлочутливих речовин, таких, наприклад, як бісазиди, дає можливість одержати винятково кислотостійкі негативні фоторезисти;
- фотоліз світлочутливих сполук з утворенням розчинних речовин. Прикладом служать більшість позитивних фоторезистів, у яких фотоліз сполук, які називаються нафтохінондіазидами (НХД), приводить до того, що опромінені ділянки стають розчинними в лужних середовищах.
Ефіри коричної кислоти і полівінілового спирту, які називаються полівінілциннаматами (ПВЦ), мають структуру, показану на рис.1.2. Ланцюжок ПВЦ нараховує тисячі атомів і скручений у довгу спіраль, від вуглецевої основи якого відходять циннамоільні групи.
При поглинанні випромінювання з достатньою енергією рветься подвійний зв'язок С = С в циннамоільній групі. Чому рветься саме цей зв'язок, видно з порівняння енергії зв'язків різних груп атомів, що входять до складу ПВЦ. Для ізольованих груп С = С, що знаходяться поза бензольним кільцем, ця енергія дорівнює 2,5·105Дж/моль, для груп С = О вона складає вже 3,0·10 5 Дж/моль і для груп С = Н досягає 4,0·105 Дж/моль. Виникаючі при розриві вільні зв'язки приводять до утворення містків, що зшивають молекулу полімеру в хімічно стійку тривимірну сітку [3].
Сухі плівкові фоторезисти. Розширення областей застосування фотолітографії в електронній і радіоелектронній промисловості викликає розширення вимог, пропонованих до фоторезистів. У ряді випадків від фоторезистів не потрібно високої роздільної здатності, однак виникають вимоги поліпшення їхніх захисних властивостей, автоматизації процесів, удосконалення методів нанесення фоторезистів. Особливо це стосується виробництва друкованих плат, тонко- і товстоплівкових схем з розводкою по обидві сторони підкладок із з'єднанням через отвори. У цих випадках формування суцільних фоторезистивних плівок викликає труднощі. Вихід був знайдений ще у 1968 р. із застосуванням так званих сухих плівкових фоторезистів [1]. Структура сухих плівкових фоторезистів показана на рис.1.3.
Для їхнього одержання на установках ламінарного нанесення покриття на несучій основі типу майлара наноситься світлочутлива композиція, висушується і потім зверху накладається плівка іншого полімеру типу поліетилену або поліпропілену. При застосуванні фоторезистів з них знімається захисна поліолефінова плівка і фоторезист накладається за допомогою валкової системи з невеликим підігрівом і при визначеному тиску на підкладку. Плівка майлара залишається на фоторезисті аж до проявлення.

Рис.1.3.Структура сухих плівкових фоторезистів: 1 – поліолефінова плівка; 2 плівковий фоторезист; 3 - майлар.
Після накладання плівка видержується протягом близько 1800 с при кімнатній температурі для проходження в ній релаксаційних процесів. Рекомендується також короткочасне нагрівання при 353 - 373 К (180-300 с). Після експонування плівка майлара видаляється і проводиться проявлення проявниками. З метою збільшення стійкості покриття (особливо у гальванічних процесах) рекомендується додаткова термообробка при температурі 393-423 К протягом 1200-1800 с.
Роздільна здатність таких фоторезистів невелика (50-100 мкм) у зв’язку з тим, що товщина їхніх плівок складає десятки мікрометрів. В даний час випускається широкий спектр плівкових фоторезистів.
Негативні фоторезисти. Історично негативні фоторезисти виникли значно раніше ніж позитивні у вигляді аравійських асфальтів, біхроматних складів, альбуміна, полівінілового спирту. На зміну їм прийшли синтетичні композиції, що володіють більшою стабільністю, більш високими захисними властивостями. До них відносяться склади на основі світлочутливих полімерів, що містять групи СО - СH = СН - R, наприклад полівінілциннамат і його похідні, склади на основі циклокаучуків і їх похідних і світлочутливих добавок типу бісазидів.
Одним з основних питань при порівняльній оцінці фоторезистів є питання - коли і де можна застосовувати негативні склади? Однозначно відповісти на це питання часом досить складно, тому що в ряді випадків їхнє застосування обумовлюється чисто історичними причинами. Наприклад, одні з перших зразків інтегральних мікросхем на кремнії були створені із застосуванням фоторезистів на основі полівінілциннамата, однак потім у технологію для проведення цих же операцій були введені позитивні матеріали. Застосування негативних фоторезистів стає необхідним, коли це потрібно по умовам суміщення або коли позитивні фоторезисти не витримують впливу лужних травників, або не допускається дія лужних проявників на підкладку. Фоторезисти володіють хорошою адгезією практично до всіх до металів, напівпровідників і окислів, і рекомендуються для проведення електрохімічних процесів осадження. Обмеження по застосуванню негативних фоторезистів пов’язано в основному з їх обмеженою порівняно з позитивними складами роздільною здатністю із-за ефектів набухання при проявленні. Другим фактором, який обмежує застосування цих фоторезистів є відсутність у них достатньої фотографічної широти виготовлення елементів зображення при умові формування плівок після проявлення необхідної товщини.
Ще складнішим є вибір фоторезиста серед існуючих негативних матеріалів, так як їх основні параметри досить близькі один до одного. Можна відмітити, що склади на основі циклокаучуку краще проявляють свої властивості на підкладках, які не містять мідь, а фоторезисти на основі полівінілциннамата володіють не достатньою адгезією до поверхні SiO2 з великим вмістом води, в той час, як склади на основі циклокаучуку мало чутливі до сіланольних груп.
Позитивні фоторезисти. Відрізняючись своєю високою роздільною здатністю і точністю виготовлення елементів інтегральних мікросхем в достатньо широкому технологічному діапазоні, позитивні фоторезисти займають у даний час домінуюче положення в мікроелектронній технології.
До складу усіх фоторезистів входять світлочутливі компоненти хінондіазидного типу, полімерні складові, система розчинників і різні добавки, що регулюють властивості матеріалу.
О-хінондіазиди використовуються, як правило, у виді різних сульфо- або амідоефірів, що дозволяє значно поліпшити їхню розчинність і сумісність з полімерами. Так, о-хінондіазиди можуть використовуватися у виді сульфоефірів з різними фенолформальдегідними смолами .
Однією з особливостей позитивних фоторезистів порівняно з негативними є те, що їх складові являються жорстколанцюговими смолами з невеликою молекулярною масою і низькомолекулярними світлочутливими компонентами. Їх плівкоутворення у великій степені залежить від системи розчинників, їх енергетичних властивостей, співвідношення швидкостей випаровування і часу центрифугування [1].
В техніці експонування і проявлення позитивних фоторезистів порівняно з негативними є дві основні відмінності: режими проявлення можуть в значній мірі коректувати режими експонування; плівки позитивних фоторезистів практично не чутливі до впливу кисню.
Фоторезисти мають сенсометричні характеристики, до яких відносять світлочутливість і контрастність [9]. Вони визначаються із характеристичної кривої фоторезиста. Характеристична крива представляє собою залежність товщини шару на експонованих областях після проявлення від експозиції Н. Експозиція Н - це енергія випромінювання , що припадає на одиницю шару фоторезиста:
Н = Е/t.
Тут Е - енергетична освітленість поверхні шару; t - час експонування.
Похожие работы
... фоторезиста, тому крім підтримки чистоти треба домагатись того, щоб сила контактування була мінімальною. Радикальним рішенням є перехід на безконтактну фотолітографію - проекційну і фотолітографію із зазором. 3.Зниженню дефектів значною мірою сприяє автоматизація технологічних операцій і особливо процесів завантаження, транспортування і вивантаження пластин; маніпулювання пінцетами у виробництві ...
... напилення резистивної плівки, а також контактних майданчиків і провідників через маску; фотолітографія резистивного шару; нанесення захисного шару. [1] РОЗДІЛ 3. МЕТОДИ МЕТАЛІЗАЦІЇ ІНТЕГРАЛЬНИХ СХЕМ 3.1 Термічне (вакуумне) напилення Схема цього методу показана на рис 3.1. Металевий або скляний ковпак 1 розташований на опорній плиті 2. Між ними знаходиться прокладка 3, що забезпечує пі ...
... 350 - 2000 ppm AS-MLC /AppliedSensor Inc. CO 0.5 - 500 ppm AS-MLK /AppliedSensor Inc. CH4 Від 0.01 до 4% 2. Сучасні датчики газів, та методи їх отримання 2.1 Нові матеріали та наноструктури – перспективна база елементів для датчиків газів В зв’язку з інтенсивним розвитком виробництва поверхневих датчиків газів, досліджуються придатні для їх побудови сучасні напівпрові ...
... і габарити і споживана потужність. І тут, можливо, відкриваються широкі перспективи для органічних електролюмінісцентних індикаторів. Не випадково великий інтерес до них проявляють японські фірми — провідні світові постачальники плоских пристроїв відображення інформації. На фірмі Sanyo Electric на основі матеріалу з нерегулярною молекулярною структурою, випромінюючого в широкому спектральному ді ...


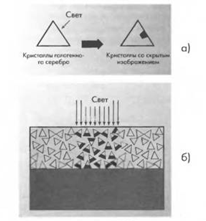
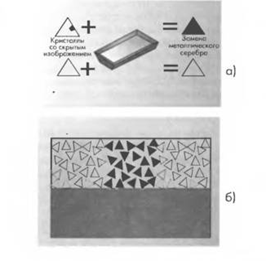


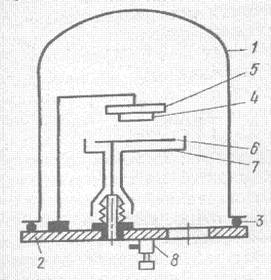
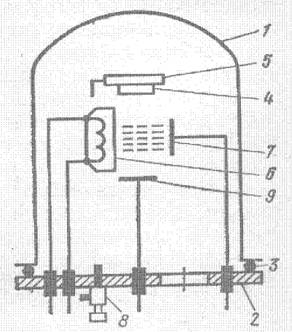
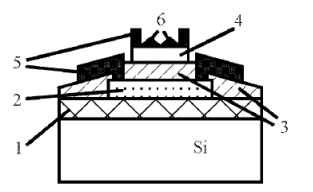



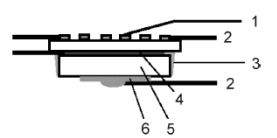
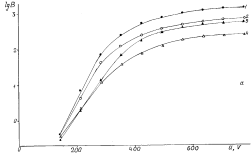
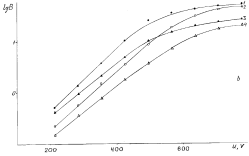


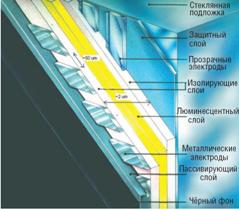
0 комментариев