Навигация
Выбор физической структуры разрабатываемой ИМС
1.1 Выбор физической структуры разрабатываемой ИМС
Основной структурой, определяющей электрические параметры и характеристики микросхемы, является транзистор. Поэтому, исходя из требований, предъявляемых к транзистору, производят выбор физической структуры различных областей [1], т.е. задаются определенными электрофизическими параметрами, к числу которых относятся: концентрация легирующих примесей, подвижность носителей заряда, время жизни и скорость поверхностной рекомбинации неосновных носителей заряда, удельное сопротивление материала, диэлектрическая проницаемость материала. Для расчета остальных элементов используется выбранная физическая структура основного транзистора.
В настоящее время существуют два основных вида физической структуры ИМС: микросхемы на основе биполярных транзисторов и микросхемы на основе МОП - структуры. Наибольшее количество слоев имеют микросхемы на основе биполярных транзисторов (рис. 1.2). Это скрытый n+-слой, эпитаксиальный, p+ - разделительный, базовый, эмиттерный, специальный резистивный, и т.д.. Для изготовления микросхем на основе МОП – транзисторов необходим лишь один диффузионный слой.
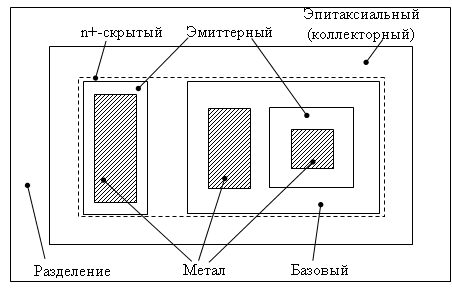
Рисунок 1.2 - Физическая структура биполярного n-p-n транзистора со скрытым n+-слоем.
Удельное сопротивление подложки выбирается исходя из требований к рабочему напряжению коллекторного перехода транзистора. При этом напряжение пробоя перехода коллектор-подложка должно быть больше, чем пробивное напряжение перехода коллектор-база. Удельное сопротивление подложки должно быть как можно большим. Это обеспечивает одновременно малую паразитную емкость перехода коллектор-подложка, но и надо иметь в виду, что одновременно будет увеличиваться сопротивление тела подложки, а это есть паразитный параметр, который сказывается на частотных свойствах. Удельное сопротивление подложки ρ - должно выбираться компромиссным путем из диапазона 1...10 Ом∙см. Толщина подложки должна обеспечивать механическую прочность микросхемы и она выбирается из диапазона hр =250...500 мкм.
Уровень легирования эпитаксиального слоя выбирается исходя из нескольких противоречивых требований:
-для высокого пробивного напряжения изолирующего перехода и для малой удельной емкости переходов необходимо, чтобы уровень легирования эпитаксиального слоя был как можно меньше (но чуть больше уровня легирования подложки);
-для уменьшения последовательного сопротивления тела коллектора, которое влияет на частотные свойства, уровень легирования должен быть как можно выше.
Эти противоречивые требования приводят к следующему компромиссу: сопротивление эпитаксиальной пленки выбирается таким, чтобы оно обеспечивало заданное высоковольтное напряжение самого высоковольтного транзистора с учетом способа его изготовления. Это приводит к выбору значения удельного сопротивления из диапазона ρк = 0,15…5 Ом∙см. Но при всех реальных параметрах транзисторов такие значения удельного сопротивления приводят к завышенному значению сопротивления тела коллектора. Во избежании этого вводят высоколегированный n+-слой. Т.к. напряжение коллектор – база транзисторов составляет Uкб = 12 В, то есть в несколько раз меньше пробивного напряжения перехода коллектор – база, следовательно не необходимости в применении дополнительных мерах защиты от пробоя.
Толщина эпитаксиальной пленки должна по возможности быть как можно меньше, но существует следующее ограничение:
![]() ,(1.1)
,(1.1)
где
hэп-глубина залегания коллекторного перехода;
![]() -глубина проникновения n+-области в эпитаксиальный слой при всех температурных режимах формирования структуры;
-глубина проникновения n+-области в эпитаксиальный слой при всех температурных режимах формирования структуры;
![]() -ширина области пространственного заряда перехода коллектор-база при рабочем напряжении;
-ширина области пространственного заряда перехода коллектор-база при рабочем напряжении;
![]() -все технологические погрешности.
-все технологические погрешности.
Скрытый n+-слой изготавливается для того, чтобы обеспечить минимальное сопротивление тела коллектора. Исходя из этой задачи скрытый слой должен быть максимально легирован, но должна быть обеспечена невозможность смыкания этого слоя с базой при подаче на этот переход коллектор-база рабочего напряжения. При этом расползание слоя при дальнейших технологических операциях должно быть строго контролировано. Поверхностное сопротивление скрытого слоя обычно составляет RSСС = 6...8 Ом/квадрат, толщина hсс = 3...8 мкм, поверхностная концентрация легирующих примесей (часто это сурьма из-за невысокого коэффициента диффузии при высоких температурах) RSСС = 1018…1019 см-3.
Базовая область изготавливается методом диффузии, поэтому является неоднородно легированной. Степень легирования выбирается из следующих требований:
-для увеличения напряжения пробоя перехода эмиттер-база и эффективности эмиттера следует легировать базу как можно меньше;
-снижение уровня легирования увеличивает паразитное сопротивление базы и ухудшает частотные характеристики транзистора;
-если базу слабо легировать, так что поверхностная концентрация будет составлять NSб ≤ 5∙1016 см-3, то это может привести к инверсии проводимости поверхностного слоя базы и выходу транзистора из строя.
Поверхностная концентрация примесей составляют примерно NSб = 1016…1019 см-3. Толщина металлургической базы ω0 = 0,5…1,0 мкм, среднее удельное сопротивление базовой области ρб = 0,1…1,0 Ом∙см, поверхностное сопротивление пассивной базы RSбП = 100…200 Ом/квадрат, поверхностное сопротивление активной базы RSба = 5…20 кОм/квадрат.
Уровень легирования эмиттерной области долже быть как можно выше. Но если уровень легирования достигает NSЭ ≈ 1021 см -3, тогда уменьшается время жизни носителей заряда, что приводит к уменьшению эффективности эмиттера. Поэтому уровень легирования выбирается из диапазона NSЭ = 1019…5∙1020 см-3, поверхностное сопротивление составляет RSэ = 5…7 Ом/квадрат. Глубина залегания перехода эмиттер-база определяется, как:
![]() ,(1.2)
,(1.2)
Глубина разделительной диффузии должна быть чуть больше толщины эпитаксиальной пленки, так чтобы обеспечивалось слитие этой области с подложкой. Уровень легирования этой области должен быть достаточно высок для эффективной изоляции p-n перехода на кристалле повышенной площади.
В полупроводниковых микросхемах в качестве межэлементных соединений применяются проводники из пленки алюминия. Для исключения пересечений проводников используется 3 основных метода: многослойная металлизация, прокладка шин металлизации над каналами резисторов, защищенными слоем SiO2 и проводящие диффузионные перемычки под слоем двуокиси кремния.
Минимальная ширина металлизированной дорожки (при заданной ее толщине) определяется допустимой плотностью тока. Толщина слоя Al шин металлизации составляет порядка 1,5 мкм и шина имеет удельное сопротивление слоя RS ≈ 0,05 Ом/квадрат Значение RS для пленки приблизительно в 2,5…3 раза превышает значение, получаемое из удельного сопротивления алюминия. Это связано с миграцией Al от коллекторных контактов выходных транзисторов, что повышает сопротивление тела коллектора, рост нитей Al, приводит к закорачиванию эмиттерных p-n переходов и другое.
Геометрические размеры контактных площадок определяются базовой технологией изготовления микросхем и составляют часто 100 × 100 мкм. Площадь контактных площадок должна обеспечивать хорошее соединение. Их целесообразно размещать под отдельными изолированными областями для уменьшения результирующей паразитной емкости и исключение опасности коротких замыканий при дефекте в окисле.
Похожие работы
... коэффициенты линейного расширения материалов подложек, корпусов и вспомогательных материалов должны быть согласованы для обеспечения работы микросхем при повышенных уровнях мощности. Конструирование СВЧ микросхем включает расчет и проектирование изделия по заданным электрическим параметрам с учетом процессов сборки и регулировки. При этом определяют вариант схемы узла, материал и геометрические ...
... кафедру для утверждения. После утверждения куратор проекта от кафедры проставляет оценку студенту. ЛИТЕРАТУРА Основная литература 1. Павлов В.Н., Ногин В.Н. Схемотехника аналоговых электронных устройств. М.: Радио и связь, 1997. 2. Ногин В.Н. Аналоговые электронные устройства. М.: Радио и связь, 1992. 304 с. 3. Остапенко Г.С. Усилительные устройства. М.: Радио и связь, 1989. 400 с. ...
... простой в применении методики расчета МКЦ необходимой при проектировании сверхширокополосных усилителей. Целью данного дипломного проекта является разработка методики расчета МКЦ сверхширокополосного усилителя на мощных полевых транзисторах, обеспечивающий максимальный коэффициент передачи при заданных неравномерности АЧХ и полосе пропускания. Данная методика необходима для создания интегральных ...
... на типы осуществляют по назначению усилителя, характеру входного сигнала, полосе и абсолютному значению усиливаемых частот, виду используемых активных элементов. По своему назначению усилители условно делятся на усилители напряжения, усилители тока и усилители мощности. Если основное требование – усиление входного напряжения до необходимого значения, то такой усилитель относится к усилителям ...






0 комментариев